Тенденция развития технологии ИМСП/п ИМС по сравнению с платами с печатным монтажом имеют лучшие технико-экономические показатели: размеры, массу, надежность, быстродействие и стоимость. С повышением функциональной сложности ИМС показатели улучшаются, т.к. увеличивается число интегральных элементов, т.е. возрастанием степени интеграции, показатель которой К= lg N, где N-число элементов ИМС, определяет ИМС малой, средней степени интеграции, БИС и СБИС. Технологические возможности ограничивают К, т.к. плотность дефектов в пластине определяется качеством ТП и, а первую очередь, процессом фотолитографии. При наличии в слое окисной маски микроотверстий («проколов») примеси проникают через них, образуя в полупроводнике незапланированные легированные микрообласти, которые (в зависимости от их расположения) могут вывести соответствующий элемент ИМС из строя, т. е. и всю ИМС. Причинами образования проколов могут быть неоднородности в светочувствительном слое (частицы пыли, пузырьки и т.д.), а также дефекты рисунка ФШ. Повышение К сопровождается уменьшением площади элементов и совершенствование процесса формирования защитных фотомасок. При изготовлении ФШ также используют фотомаски, к которым предъявляются ещё более жесткие требования. Для повышения качества фотографических процессов в производственных помещениях создают обеспыленную атмосферу, а для производственного персонала устанавливают определенные правила производственной гигиены и сокращают число циклов фотолиторафии. Для выбранной структуры ИМС (МДП, И2Л и т.д.) минимальные размеры элементов ИМС зависят от фотолитографического процесса, который характеризуется 3мя основными параметрами: Высокий процент выхода годных БИС может быть достигнут за счет элементной избыточности. Дублируют составные функциональные части (ячейки) несколько раз в пределах кристалла БИС. После формирования структур создают первый уровень межсоединений и периферийных контактов в пределах каждой ячейки. После контроля определяют дефектные ячейки. Второй, а при необходимости и третий уровень межсоединений объединяет ячейки в общую систему, а дефектные отключают путем разрыва проводников с помощью лазера или фотолитографии. Уменьшение размеров элементов ИМС снижает потребляемую мощность, но снижает быстродействие, помехоустойчивость, надежность и воспроизводимость параметров ИМС даже в пределах одного кристалла из-за флуктуации электрофизических свойств полупроводникового материала. Функциональная микроэлектроника заменяет традиционную совокупностью R, C, VT, VD и обладает более широкими функциональными возможностями. В ней носителем информации является многомерный сигнал, параметрами которого управляют динамические неоднородности среды, возникающие под действием управляющего сигнала. В оптоэлектронных ИМС носителем информации является оптический сигнал, который может быть промодулирован по интенсивности (амплитуде), фазе, поляризации или частоте. Поскольку в качестве управляющих и выходных удобно иметь электрические сигналы, то функциональные ИМС может включать в себя несколько звеньев «фотоэлектронного и электро-фотонного» преобразования. Развитие направлений функциональной микроэлектроники базируется на исследованиях новых полупроводниковых материалов и новых методов их обработки. Поэтому здесь используется весь арсенал технологических методов и средств современной микроэлектроники. Кроме оптоэлектронных ИМС существуют: Лекция 7 Технология полупроводниковых ИМС В зависимости от структуры ИМС и конструкции корпуса общее количество операций ТП её изготовление составляет около 200. Т.е. процесс производства ИМС представляет собой систему, оптимальная организация которой имеет главное значение для ее эффективного функционирования. По своему назначению и месту, занимаемому в общем процессе производства ИМС, все операции объединяются в самостоятельные (частные) технологические процессы, которые разделяют на три группы: 1. Заготовительные процессы: получение монокристаллических полупроводниковых слитков определенного типа электропроводности и заданного удельного сопротивления, резка слитков на пластины, обработка их поверхностей с заданной микро и макрогеометрией, а также качеством поверхности, изготовление отдельных деталей и узлов корпуса ИМС. 2. Обрабатывающая – объединяет все операции, необходимые для формирования структур ИМС в групповых пластинах и их контроля на функционирование. Сюда входят процессы окисления, диффузии примесей, эпитаксии, ионной инплантации, вакуумного напыления, фотолитографии, технохимической обработки. 3. Сборочно–контрольная - разделение групповой пластины на отдельные кристаллы, монтаж кристаллов в корпусах, разварка выводов, герметизация, контроль и классификация, механические и климатические испытания, окраска, маркировка, упаковка. Первая группа процессов является обеспечивающей для 2 и 3, чаще выполняется специализированными предприятиями. Целесообразной формой организации процессов третьей группы является создание специальных цехов или участков на одном предприятии. Вторая группа – интегральная технология также организуется на отдельных участках одного предприятия. Характер и последовательность операций второй группы полностью определяется типом структуры ИМС. Режим обработки на отдельных операциях зависит от толщины и электрофизических свойств слоев и областей структуры. В зависимости от типа и способа формирования транзисторных структур в кристалле различают биполярную и МДП- технологию. Для изготовления п/п ИМС на биполярных транзисторах применяют планарную и планарно-эпитаксиальную технологии, построенные на основе ТП создания транзисторных структур: окислении поверхности кремния, литография, эпитаксиальное наращивание слоев кремния, локальная диффузия легирующих примесей. Планарная технология использует ионное легирование, нитридирование, электронную и рентгеновскую литографию. Разнообразие ТП изготовления биполярных ИМС определяется способом формирования транзисторной структуры и методами изоляции элементов: обратно смешенные р-n-переходы, диэлектрические области, их комбинация. Технология изготовленияМДП-ИМС проще и во многом схожа с технологией биполярных ИМС. Отличие состоит в конструктивно-технологических особенностях самих МДП-ИМС. Обладают высокой надежностью, большой функциональной сложностью, меньшие размеры и наиболее распространены в микроэлектронике. В биполярной технологии, в зависимости от способа формирования изолирующей области, распространение получили следующие типовые ТП: 1. Стандартная планарно-эпитаксиальная технология с использованием разделительной диффузии. 2. КИД-технология, основанная на коллекторной изолирующей диффузии. 3. БИД-технология, основанная на базовой изолирующей диффузии. 4. Технология на основе трех фотошаблонов. 5. Технология на основе двойной диффузии и т.д.
Стандартная технология п/п ИМС
В отечественной промышленности используют пластины кремния диаметром 60-120мм, толщиной 0,2-0,4мм и удельным сопротивлением 1-10 Ом/см. Операции:
 1. Очистка пластины р – типа проводимости (партия 10-20шт) путем химической обработки с последующим травлением и промывкой в деионнизированной или дисцилированной воде (эта промывка перед каждой последующей операцией). 1. Очистка пластины р – типа проводимости (партия 10-20шт) путем химической обработки с последующим травлением и промывкой в деионнизированной или дисцилированной воде (эта промывка перед каждой последующей операцией).
 2. Термическое окисление (создание маскирующего оксида кремния). 2. Термическое окисление (создание маскирующего оксида кремния).
  3. Первая фотолитография для вскрытия окон в слое 3. Первая фотолитография для вскрытия окон в слое  SiO2. SiO2.
1-фоторезист, 2 – фотошаблон, 3 – пробельные места, 4 – окна
4. Диффузия сурьмы или мышьяка на 5. глубину 1-2 мкм для формирования хорошо проводящей n-области под коллектором будущего транзистора 5. Удаление SiO2.
7. Термическое окисление SiO2.
9. Разделительная диффузия бора для изоляции n-областей. 10. Удаление SiO2. 11. Термическое окисление. 12. Фотолитография. 13. Диффузия бора для создания базовых областей транзисторов р-типа, резисторов, диодов в изолированных n-облостях.
15. Oчистка поверхности от окиси. 16. Нанесение защитного оксида толщиной 1 мм. 17. Фотолитография. 18. Металлизация алюминием для создания топологии ИМС. 19. Оксидирование и фотолитография 20. Контроль на функционирования с помощью зондовых установок, метят брак краской. 21. Деление на кристаллы, из которых годные идут на сборку. По этой технологии изготавливают различные типы биполярных ИМС (ТТЛ, ТТЛШ, ЭЛС, И2Л и др.). Технология МДП и КМДП-ИМС имеет особенности по сравнению с биполярной: 1. Отсутствуют операции по изоляции элементов структур, т.к. в МДП происходит самоизоляция. 2. Внутрисхемные соединения выполняют не только с помощью алюминиевых металлических слоев, но и высоколегированных диффузионных слоев кремния и материала затвора (молибдена, поликристаллического кремния), т.е. значительно проще задача многослойной разводки. 3. Возможно легко создать в одном кристалле МДП транзисторы с n и p типом электропроводности канала, что позволяет изготовлять МДП-ИМС с большими функциональными возможностями на комплементарных структурах (КМДП-ИМС). 4. Совмещение фотошаблонов при фотолитографии, диффузия, окисление и др. операции требуют прецизионного проведения, т.к. размеры МДП- транзисторов значительно меньше. 5. количество операций на 30% меньше 6. Меньше число высокотемпературных процессов, что увеличивает процент выхода годных ИМС. ИМС на МДП-транзисторах изготавливают по планарной технологии: окисление поверхности кремния, фотолитография слоя оксида и диффузии примесей во вскрытые окна. Возможны три метода технологии ИМС, содержащей МДП-транзисторы с каналами n и p-типов: 1. создание «карманов» p-типа в кремнии n-типа с помощью селективной диффузии. 2. создание «карманов» p-типа в кремнии n-типа с помощью эпитаксии. 3. соединение между собой МДП-транзисторов, изготовленных на пластинах различного типа электропроводности.
Технология МДП-ИМС с каналом p-типа(p-канальная технология): 1. Очистка поверхности пластины n-типа. 2. Термическое окисление (маскирующий слой SiO2) 3. Фотолитография окон под области истока и стока -(а). 4. Диффузия 1-2 мкм бора для создания высоколегированных p+ областей стока и истока -(б). 5. Фотолитография окон под тонкий слой диэлектрика под затвором. 6. Термическое окисление в сухом кислороде для создания SiO2 под затвором. 7. Фотолитография окон под контакты со стоком и истоком -(в, г). 8. Металлизация алюминием для создания ИМС с топологией -(д).
На базе технологии ИМС первой и второй степени интеграции базируется технология БИС и СБИС путем уменьшения геометрических размеров элементов и сокращения площади изолирующих областей.
Отличительной особенностью технологии БИС и СБИС является усовершенствование существующих и использование новых ТП и материалов: 1. Применение новых методов фотолитографии (оптических и неоптических), позволяющих экспонировать элементы с размерами единицы и доли микрометра. 2. замена жидкостного травления сухим травлением, обеспечивающим формирование структур с более высокой точностью. 3. применение многослойных резистов с целью компенсации неровностей поверхности пластины, приводящих к нарушению точной литографии. 4. использование лазерной и электронно-лучевой обработки с цель очистки материалов, уменьшения в них дефектов и формирования структурных элементов БИС. 5. применение многослойных внутренних соединений (многоуровневой разводки) металлических пленок, легированных слоев монокристаллического и поликристаллического кремния, низкоомного силицидов и тугоплавких металлов. 6. Применения пластин большого диаметра до 152мм.
Технология ГИС. Общая характеристика. Для высокой воспроизводимости параметров пленочных элементов необходима чистота исходных материалов и отсутствие загрязнений пленок при осаждении, заданиая шероховатость поверхности подложки, технологический метод испарения напыляемого материала д.б. универсальным. В производстве тонкопленочных ГИС как и полупроводниковых ИМС используют фотолитографию, но с более низкими требованиями к разрешающей способности, точности размеров элементов и совмещения, дефектности ФШ. Производство подложек, деталей и узлов корпуса, компонентов ГИС осуществляют на специализированных предприятиях. Технология тонкопленочных ГИС сводится к двум процессам: осаждению пленок в вакууме и фотолитографической обработке. К производственным участкам цеха тонкопленочных ГИС относятся: 1. Участки очистки и контроля подложек, подготовки испарителей, навесок-мишеней. 2. Изготовления ФШ и масок -трафаретов 3. Вакуумного напыления. 4. Фотолитографии. 5. Сборки и монтажа. 6. Герметизации. 7. Контроля электрических параметров. 8. Маркирования, лакирования, упаковки. При толстопленочной технологии ГИС используют дешевый и высокопроизводительный метод сеткографической печати элементов пассивной части. Здесь не требуется сложного оборудования, высокой квалификации персонала, стоимость операции низкая и трудоемкость мала, мала и длительность производственного цикла, степень автоматизации процесса высокая, возможно и просто создавать многоуровневые схемы, малы капитальные затраты на подготовку производства и невелик срок их окупаемости. При организации на предприятии единого производства тонко и толсто пленочных ГИС появляется возможность создавать общие производственные участки: очистки подложек, изготовления ФШ и сетчатых трафаретов, измерения и подгонки элементов, резки подложек, сборки и монтажа, функционального контроля, герметизации, маркирования и лакирования. Специальными являются участки подготовки паст, а также изготовления пассивной части (сеткографии и термообработки).
Основы термического вакуумного напыления
Рисунок 27 Вещество подлежащее напылению помещают в устройство нагрева (испаритель). В вакууме (10-4 Па) молекулы свободно и быстро распространяются в пространстве, достигая подложки. Если температура подложки меньше критической, то происходит конденсация вещества, т.е. рост пленки. На начальном этапе заслонкой перекрывают поток на подложку во избежание загрязнения I стадия Испарение вещества имеет место при любой температуре. Наибольшую вероятность покинуть поверхность имеют наиболее “нагретые” молекулы, т. е. обладающие большей энергией. С повышением tº; средняя энергия молекул возрастает и на поверхности увеличивается число молекул, энергия которых превышает энергию связи с другими молекулами, т. к. на поверхности она меньше, чем в объеме. Для некоторых веществ tº; испарения меньше tº; плавления. Если допустить, что процесс испарения протекает в камере с сильно нагретыми стенками, не конденсирующими пар (отражают молекулы вещества), то процесс испарения становится равновесным, т. е. число покидающих и возвращающихся молекул равно. Давление пара Ps, соответствующее равновесному состоянию системы называется давлением насыщенного пара или его упругостью. Практика показала, что процессы осаждения происходят с приемлемой скоростью при Ps=1.3 Па, при этом tº вещества называют условной tº; испарения. Испарители должны обеспечивать: 1. Стабильность и равномерность потока вещества во времени 2. Нагрев материала с наименьшими потерями энергии (кондуктивными и излучательными) и материальных затрат 3. Независимость от формы испаряемого образца (проволока, гранулы, порошок) 4. Необходимую емкость для проведения цикла многопозиционной обработки или непрерывности процесса напыления 5. Регулировку режимов испарения 6. tº; плавления материала испарителя намного большую испаряемого и невзаимодействие с ним Материал нагревают прямым и косвенным путем. Прямой: осуществляют резистивным нагревом пропущенным током, индукционным способом или электронной бомбардировкой. Косвенный: за счет теплопередачи от испарителя, который нагревают током, индукционным методом или электронной бомбардировкой. Прямой токовый (резистивный) нагрев для металлов, у которых tº; испарения < tº; плавления. Испаряют хром, титан, кадмий, цинк, марганец.
Рисунок 28 Индукционный нагрев: быстро выводит испаритель на режим при больших количествах испаряемого материала за счет вихревых токов. Но высокая стоимость, сложность эксплуатации, мал КПД, необходимо соблюдать меры безопасности от ВЧ излучения.
Рисунок 29 Наиболее экономичны электронно-лучевые испарители (ЭЛИ). Нагрев за счет торможения потока электронов с энергией до 10 КэВ. Фокусировка концентрирует большую мощность на малой площади, что позволяет испарять тугоплавкие материалы (тантал, вольфрам, молибден, окись алюминия и др.) Локализация зоны испарения позволяет использовать массивные образцы в виде проволоки. Основная часть образца – холодная, что исключает загрязнение материала при контакте с держателем.
Рисунок 30 1- катушки, 2- полюса электромагнитов, 3- поток электронов, 4- корпус- анод, 5- формирующие пластины, 6- катод – вольфрамовая нить, 7- управляющий вывод.
Анод относительно катода имеет потенциал несколько киловольт. Формируется ленточный пучок электронов. Система катушек с полюсами отклоняет пучок. В зависимости от направления полюсов можно поочередно (меняя Uпитания катушек) испарять вещество в 2-х точках А и Б. Применяют для испарения материалов с высокой теплопроводимостью (медь, золото, серебро, аллюминий) Испарители с резистивным косвенным нагревом бывают проволочные и ленточные. Проволочные (из Та, Мо) используют для испарения небольших количеств вещества. Ленточные – для навесок до нескольких граммов вещества и испарения порошкообразных материалов методом микродозирования вибропитателем путем последовательного сбрасывания доз на испаритель с определенной частотой. Испарители в виде тиглей применяют для загрузки больших количеств материала (несколько граммов и более) из Та, Мо, Nb, керамики, графита, кварцевого стекла и др. Нагревают тигль вольфрамовой проволокой, которая охватывает его или армирована. II стадия Перенос вещества к подложке. Движение молекул испаряемого вещества к подложке должно быть, как можно прямолинейнее, чтобы обеспечить высокий коэффициент использования материала, особенно драгоценного. Это повышает и скорость роста пленки на подложке. Для этого необходим глубокий вакуум, чтобы исключить столкновение молекул вещества с молекулами остаточного газа на пути движения и его химическое взаимодействие, и адсорбцию на пленке для повышения чистоты пленки. Производительность и стоимость средств откачки до самых низких давлений снижает экономичность процесса напыления. Экономичным для производственных условий является вакуум Форма молекулярного пучка (диаграмма направленности испарителя) влияет на коэффициент использования материала и равномерность толщины пленки. Следовательно, плотность потока молекул должна быть одинаковой в плоскости подложки. Важную роль в деформировании молекулярных потоков играют отражатели, поверхность которых нагрета до температуры близкой к tº; испарителя, т. е. они становятся как бы вторичными испарителями путем отражения молекул. Этот метод используется при последовательной обработке неподвижных подложек. По мере испарения вещества интенсивность потока и диаграмма направленности для большинства испарителей меняется. В результате при последовательной обработке неподвижных подложек происходит разброс параметров пленки в пределах партии одного вакуумного цикла. Для повышения воспроизводимости подложки устанавливают на вращающийся диск – карусель.

Рисунок 31 При вращении подложки поочередно многократно проходят над испарителем и уменьшается влияние нестабильности диаграммы. Из-за пространственной неоднородности потока на карусели выравнивается только в направлении движения подложки. Поэтому используют диафрагму, установленную между испарителем и каруселью (диск или барабан). В зависимости от принятого метода формирования элементов (фотолитографического или масочного), а также характера вакуумного цикла при масочном методе (послойный или полный цикл напыления слоев) возможны три варианта компоновки подложек и масок – трафаретов: 1. При напылении сплошного слоя (с последующей фотолитографией) подложки фиксируют в подложкодержателях, которые в свою очередь установлены на вращающемся диске или барабане. 2. При избирательном напылении через трафарет одного слоя за вакуумный цикл подложки и трафареты монтируют в общих держателях – кассетах, которые обеспечивают их взаимное совмещение и установку на вращающемся диске или барабане. 3. При избирательном напылении через трафареты всех слоев за один вакуумный цикл подложки фиксируют в подложкодержателях, которые устанавливают на поворотном фиксирующем диске (над испарителями). С очередным трафаретом подложку совмещают за счет поворота диска с подложками на одну позицию и опускания его на диск с трафаретами.
Маски – трафареты, формирующие элементы пассивной части микросхем, должны иметь высокую точность размеров прорезей (до III стадия Конденсация вещества на подложке состоит из двух этапов: начального – с момента адсорбции первых атомов (молекул) вещества подложкой до момента образования сплошного покрытия и завершающего – на котором происходит рост пленки до заданной толщины. Условия, в которых протекает начальный этап, имеют определяющее значение для структуры получаемой пленки, прочности ее сцепления с подложкой, времени формирования пленки. Современные технические средства не позволяют наблюдать эту стадию и носят гипотетический характер, а математическое описание, естественно, приближенный и неполный характер: атомы вещества, покинувшие поверхность испарителя движутся к подложке со скоростью порядка сотен – тысяч метров в секунду. При столкновении с подложкой атом передает ей часть энергии. Причем доля этой энергии тем меньше, чем выше tº;подложки. Обладая избытком энергии, атом некоторое время перемещается (мигрирует) по поверхности подложки, теряя постепенно энергию и стремясь к тепловому равновесию с подложкой, т. е. переходит в адсорбированное состояние. В зависимости от характера электрического поля потенциального рельефа адсорбированный атом может, потеряв значительную часть избыточной энергии, закрепиться (сконденсироваться) на подложке, хотя вероятность этого процесса для одного атома мала. Конденсация вещества начинается при перенасыщении пара на подложке, т. к. если плотность потока высокая и (или) tº; подложки низкая, то вероятность испарения с подложки понижается, а вероятность встречи атомов на подложке возрастает. При этом образуются атомные группы, более устойчивые к повторному испарению, т. к. их кинетическая энергия частично еще и переходит в потенциальную энергию связи. Зародышем будущей пленки такой группы может стать, если ее размер превышает некоторый критический, при котором вероятность конденсации (окончательного закрепления на подложке) превышает вероятность распада группы на атомы. Минимальная степень перенасыщения пара, необходимая для образования зародышей от температуры, химической природы, структуры и чистоты поверхности подложки и устанавливается экспериментально при отладке техпроцесса. Разрастаясь, отдельные островки – зародыши сливаются и образуют сплошную пленку. От поверхности пленки атомы почти не отражаются. Факторы, по которым оценивают качество и надежность пленки, является прочность ее сцепления с подложкой (адгезия). Необходимым условием хорошей адгезии является очистка подложки от органических и неорганических загрязнений. Адгезия пленки с подложкой заметно возрастает, если на начальном этапе осаждения имеет место хемосорбция, т. е. адсорбция с образованием химических связей атомов вещества с подложкой. Хемосорбция на подложке (ситал, керамика, стекло) происходит при осаждении окислов, а также металлов, легко вступающих во взаимодействие с кислородом(Al, Gr, Mn, Ti, W). Эти металлы при осаждении создают своеобразный “клеящий ” подслой для будущей пленки. Чистота пленки характеризуется пористостью, которая возникает за счет поглощения пленкой остаточных газов и материала испарителя. В процессе эксплуатации микросхем эти включения десорбируют и возникает нестабильность параметров ГИС (старение). Для повышения чистоты пленки удаляют адсорбированные молекулы воздуха путем нагрева подложки и очистку бомбардировкой поверхности ионами инертного газа. Десорбция газа с подложки может происходить за счет энергии атомов осаждаемого вещества, если она превышает энергию связей молекул газа с подложкой. Такие возможности заложены в ионно – термическом методе осаждения, где дополнительную энергию атомы вещества приобретают в результате ионизации и ускорения в электрическом поле. Более перспективным является ионно – кластерный метод осаждения, при котором ионизации подвергаются не отдельные атомы, а многоатомные частицы (кластеры). Основные этапы процесса подготовки подложки к осаждению: 1. Установка подложек в подложкодержателе и загрузка испарителя материалом. 2. Герметизация камеры и откачка воздуха. 3. Нагрев подложки до заданной tº; и испарителя до tº; испарения при закрытой заслонке. 4. Ионная очистка поверхности подложки. 5. Открытие заслонки и контролируемое осаждение.
|


 6. Эпитаксиальное наращивание слоя кремния n-типа хлоридным методом в эпитаксиальных реакторах при температуре 12000С.
6. Эпитаксиальное наращивание слоя кремния n-типа хлоридным методом в эпитаксиальных реакторах при температуре 12000С. 8. Фотолитография.
8. Фотолитография. 14. Получение диффузией фосфора n-областей (базовых), которые служат эмиттерными контактами к коллекторным облостям, а иногда и внутрисхемными соединениями.
14. Получение диффузией фосфора n-областей (базовых), которые служат эмиттерными контактами к коллекторным облостям, а иногда и внутрисхемными соединениями.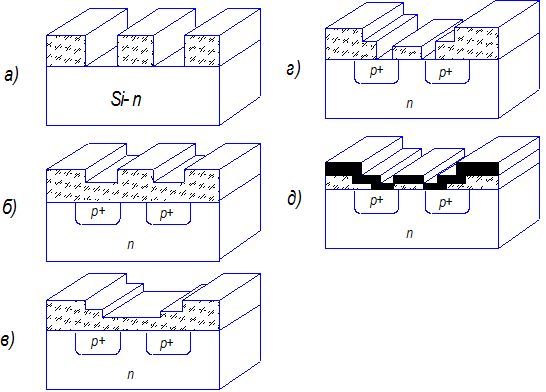




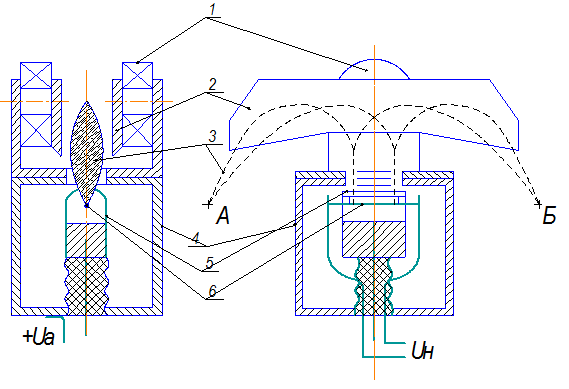

 Па,создаваемый с помощью форвакуумного насоса, включенного последовательно с диффузионным паромасляным насосом. Поскольку время откачки достигает 1-2 часа, процесс напыления эффективен при обработке большого количества подложек (последовательно или одновременно) за один вакуумный цикл. Поэтому производственные вакуумные установки всегда выполняют многопозиционными.
Па,создаваемый с помощью форвакуумного насоса, включенного последовательно с диффузионным паромасляным насосом. Поскольку время откачки достигает 1-2 часа, процесс напыления эффективен при обработке большого количества подложек (последовательно или одновременно) за один вакуумный цикл. Поэтому производственные вакуумные установки всегда выполняют многопозиционными.
 5 мкм) при ширине прорези до 100 мкм, быть достаточно прочными и упругими при толщине до 100 мкм, обладать высокой чистотой поверхности и плоскостностью, обеспечивающими плотное прилегание к подложке, нагревостойкостью в условиях вакуума (не деформироваться, не допускать газовыделения и не испаряться). Используют медные сплавы, нержавеющую сталь, молибден и другие материалы. Для изготовления прорезей используют фотохимический метод, электроэрозионную обработку, обработку электронным лучом. Сквозное травление прорезей ~ 0.1 мм приводит к значительному боковому растравливанию. Поэтому для повышения точности применяют биметаллические трафареты, в которых основной рисунок формируют в тонком слое никеля (10 мкм), а основание из БрБ-2 выполняет лишь конструктивные функции.
5 мкм) при ширине прорези до 100 мкм, быть достаточно прочными и упругими при толщине до 100 мкм, обладать высокой чистотой поверхности и плоскостностью, обеспечивающими плотное прилегание к подложке, нагревостойкостью в условиях вакуума (не деформироваться, не допускать газовыделения и не испаряться). Используют медные сплавы, нержавеющую сталь, молибден и другие материалы. Для изготовления прорезей используют фотохимический метод, электроэрозионную обработку, обработку электронным лучом. Сквозное травление прорезей ~ 0.1 мм приводит к значительному боковому растравливанию. Поэтому для повышения точности применяют биметаллические трафареты, в которых основной рисунок формируют в тонком слое никеля (10 мкм), а основание из БрБ-2 выполняет лишь конструктивные функции.


