Предложите,обоснуйте и опишите технологию нанесения покрытия толщиной 500 мкм на основе Cu, упрочненного частицами Al2O3Для нанесения покрытия данной толщины возможно прменение метода называемого плазменным напылением. разработана технология формообразования деталей уплотнительных колец сораспылением порошков с разными теплофизическими свойствами (например, Al2O3+Cu и т. п.); Для улучшения свойств используют нанесение покрытий с добавкой пластичных Ме (например, Cu или смеси оксидов разных фракций). Этим методом можно наносить слои толщиной в несколько миллиметров. Установка состоит из плазменной грелки, системы подачи напыляемого материала, системы водяного охлаждения, источника постоянного напряжения, системы охлаждения источника напряжения, системы подачи газа, пульта управления, системы блокировок, устройства для перемещения изделия или горелки, вытяжной вентиляции. Плазма зажигается между анодом и катодом. Транспортирующий газ (аргон, гелий, азот) используют при подаче порошка. Оптимальный результат – оплавление частиц. При использовании порошка в качестве материала основными преимуществами является низкая себестоимость и широкая номенклатура. 26.Каким образом можно интенсифицировать процессы термического испарения, катодно-дугового испарения и магнетронного распыления? Обоснуйте ответ. Заметная трудность в процессе вакуумно-дугового испарения заключается в том, что если катодное пятно остаётся в точке испарения слишком долго, оно эмитирует большое количество макрочастиц или капельной фазы. Эти макровключения снижают характеристики покрытий, так как они имеют плохое сцепление с подложкой и могут по размерам превосходить толщину покрытия (проступать сквозь покрытие). Ещё хуже, если материал катода-мишени имеет низкую температуру плавления (например, алюминий): в этом случае мишень под катодным пятном может проплавиться насквозь, в результате чего или начнёт испаряться материал опорного держателя катода, или охлаждающая катод вода начнёт поступать в вакуумную камеру, приводя к возникновению аварийной ситуации. Для решения данной проблемы производят тем или иным способом непрерывное перемещение катодного пятна по большому и массивному катоду, имеющему достаточно большие линейные размеры. В основном, как уже упоминалось выше, для управляемого перемещения катодных пятен по поверхности катода используются магнитные поля. С этой же целью, при применении цилиндрических катодов, во время работы (испарения) им можно сообщать вращательное движение. Не позволяя катодному пятну оставаться на одном месте слишком долго, можно использовать катоды из легкоплавких металлов, и при этом уменьшить количество нежелательной капельной фазы. Следовательно, чтобы уменьшить потери и интенсифицировать процесс необходимо обеспечить равномерное перемещение катодного пятна по катоду. Высокий коэф-т ионизации (доля ионов в потоке)=20-90%, скорость роста покрытий до 1-3 мкм/мин. Скорость роста покрытия можно определить по формуле:
ji-плотность тока ионов осаждаемого материала; x-коэффициент конденсации ионов на поверхности; S-коэффициент распыления; n0-концентрация атомов в поверхностном слое покрытия; ξ- средний заряд ионов в потоке плазмы.
Реальная скорость роста покрытия может оказаться больше, т к в формуле не учитывается вклад конденсации атомов. Специфической особенностью процесса является повышенное выделение мощности на изделии. Испарение вещества происходит при его нагревании. При нагревании вещества кинетическая энергия его атомов и молекул возрастает и становится достаточной для того, чтобы они оторвались от поверхности и распространились в окружающем пространстве. С повышением температуры энергия увеличивается и количество молекул, отрывающихся от поверхности, возрастает. Процесс интенсифицируется. Методы термического напыления. Метод заключается в нагреве исходного материала (материалов) до Тисп или сублимации. Остаточное давление 10-4-10-8Па. Р паров материала 1-100 Па. Энергия испаренных атомов 0,1-0,3эВ. Степень ионизации < 0,05-0,1%. Покрытия могут быть из Ме, сплавов, диэлектриков, п/п и т.д. Для подвода энергии к испаряемому материалу, который помещен в испаритель, используется резистивный нагрев, нагрев эл. лучом, нагрев лазерным лучом, индукционный нагрев. Метод обеспечивает получение особо чистых покрытий, т.к. загрязнение обусловлено лишь исходным материалом. Из рабочей среды поступает min загрязнений из-за высокого вакуума.
λ – средняя длина свободного пробега молекулы; Р – давление газа при Т=const; Q – эффективный диаметр молекулы. При остаточном Р: Р=10-3Па. На воздухе λ=500см(н.у) Т=273К. При Р↓ - испарение в виде прямолинейных молекулярных потоков. Если λ > размеров камеры и столкновениями атомов можно пренебречь, скорость испарения определяется ур-нием Лангмюра:
m – масса в-ва, испаряющегося с единицы поверхности в единицу времени; М – молекулярная ↑масса испаряемого в-ва; Р – давление насыщенных паров. При тех же условиях справедливы законы Ламберта, когда нет столкновений.
1ый закон говорит о том, что интенсивность потока пара в направлении, которое отклонено от нормали к пов-ти испаряемого материала на угол α, пропорционален cosα. 2ой закон: количество осаждаемого в-ва обратно пропорционально квадрату расстояния от распыляемого материала к подложке. Т.о. для обеспечения равномерности покрытий необходимо: 1)стремиться к увеличению расстояния от испарителя до подложки; 2)применять больше поверхности испарения; 3)обеспечить перемещение подложек (вращ.) в процессе нанесения покрытий. Движущей силой переноса частиц является различие в Р над поверхностью испарения материала и вблизи подложки:
С ↑Т, нагрев испарения ↑. Это уравнение Клапейрона-Клаузиуса. Справедливо для однокомпонентной системы. dР – изменение равновесного давления паров Ме вследствие изменения Т на величину dT. ΔН – испарение, теплота испаряемого в-ва. Vп, Vж – молярные объемы пара и ж. Для расчета используется:
Зависимость Р от Т.
При ↑Т происходит ↑Р паров материала. При ↑Р до >1 Па приводит к образованию вблизи поверхности пограничного слоя и атом должен продиффундировать => осложнения материала, испарение ↓. Пограничный слой – с высокой концентрацией молекул. Испарение ↓ также при наличии примесей и оксидных пленок в испаряемом материале. При одной и той же Т различные материалы хар-ся различными Р (напр, Ni-W), что усложняет контроль за процессами испарения сплава. В сплаве сначала испаряется компонент, имеющий ↑Р пара, затем происходит испарение компонента с ↓Р пара за счет ↑ его концентрации в расплаве. Образуется неоднородное покрытие с сильным grad концентраций элементов в расплаве. Это можно устранить раздельным испарением. Парциальное давление пара компонентов для реального сплава определяется формулами:
где f – коэффициент активности; Роi – давление паров чистого компонента; Xi – мольная концентрация компонента в сплаве. Недостатки метода испарения: - нерегулируемая скорость осаждения; - низкая и нерегулируемая энергия осаждения частиц (= >↓ адгезия); - взаимодействие в ряде конструкций испаряемого материала с материалом тигля. Скорость конденсации при магнетронном распылении зависит от силы тока разряда или мощности и от давления рабочего газа, что определяет жесткие требования к источникам питания. Увеличиваем силу тока. Метод магнетронного распыления с постоянной силой тока не позволяет получать плёнки оксидов при высокой скорости распыления из за резкого окисления катода–мишени. В этих случаях целесообразнее применять высокочастотное магнетронное распыление, реализующее возможность распыление диэлектрических материалов в магнитном поле без изменения стехиометрического состава при увеличенной скорости испарения. Интенсивность распыления увеличивается при увеличении энергии ионов. Коэффициент распыления характеризуется числом атомов, выбитых с поверхности мишени одним ионом:
Δm - изменение массы материала (потеря);
τ - время; K - коэффициент, зависящий от выбора единицы измерения; A- массовое число атомов; Si- 0,5÷20 Скорость распыления, [мкг/мкА]
Скорость распыления зависит от энергии бомбардировки ионов. При достижении пороговой энергии (Eп=100кэВ) происходит скачок Si → рост → затухание. Процесс затухания связан с тем, что большую часть своей энергии ионы рассеивают внутри материала. Чем легче бомбардирующие ионы, тем меньшую энергию им требуется сообщить при проникновении в мишень. Наибольший Si имеют материалы, заполненные d-оболочками, такие как Ag, Au, Cu. Наибольший Si достигается ионами при использовании заполненных p-оболочек (инертные газы). Si сильно зависит от ориентиров монокристаллов и текстурированности материала. Коэффициент Si увеличивается при уменьшении угла падения ионов. Температура мишени не оказывает влияния на распыление, т.к. чтобы активировать ионы им не нужен дополнительный нагрев. При увеличении давления Si уменьшается, т.к. меньшая доля ионов попадает на мишень, т.к. увеличивается число столкновений и рассеивающихся ионов на атомы газа. Также происходит обратная диффузия выбитых атомов с поверхности мишени с повышением давления.
|


 , где ni-концентрация ионов; Vпл- скорость плазменного потока.
, где ni-концентрация ионов; Vпл- скорость плазменного потока.

 Законы Ламберта:
Законы Ламберта:
 , где A,B,C,D = const.
, где A,B,C,D = const.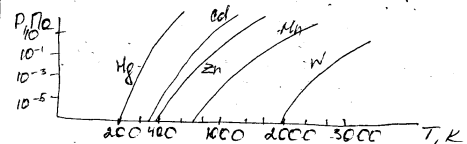



 j- ионный ток;
j- ионный ток;