Теоретические сведения. Биполярным транзистором называют трёхслойную полупроводниковую структуру с чередующимися типом проводимости областейБиполярным транзистором называют трёхслойную полупроводниковую структуру с чередующимися типом проводимости областей, созданную в едином кристалле и образующую два встречно включённых взаимодействующих р –n переходов (рис.1). Взаимодействие переходов обеспечивается тем, что они расположены достаточно близко друг от друга – на расстоянии, меньшем диффузионной длины носителей зарядов. Транзистор – электропреобразовательный полупроводниковый прибор, усилительные свойства которого обусловлены явлениями переноса зарядов в твёрдом теле (явления инжекции и экстракции неосновных носителей) усиления, генерирования и преобразования сигналов.
n-p-n p-n-p
Рис. 1. Структура биполярного транзистора и их условно – графическое изображение (УГО) Термин «транзистор» происходит от комбинации английских слов transfer of resistor, что в переводе означает «преобразователь сопротивления». Термин «биполярный» означает, что в этом транзисторе используются подвижные носители обоих знаков – электроны и дырки (в отличие от полевых транзисторов, в которых используется только один тип носителей). Таким образом, транзистор представляет собой полупроводниковый кристалл, в котором две крайние области с однотипной электропроводностью разделены областью противоположной электропроводности. В зависимости от электропроводности этих трёх областей различают транзисторы n-p-n и p-n-p типов, УГО которых проиллюстрированы на рис.1. Принцип действия обоих типов транзисторов одинаков.
2.1. Структура транзистора
В реальных транзисторах площади p-n переходов существенно различаются. Переход n1+-p имеет гораздо меньшую площадь, чем n2-p. Кроме того, в транзисторах наблюдается и асимметрия в концентрации примесей. Один из крайних слоёв (на рисунке слой n1+) легирован (имеет концентрацию примесей) значительно сильнее, чем слой n2. Средний слой транзистора называют базой, крайний сильно легированный слой меньшей площади (n1+) называют эмиттером, а слой с большей площадью, но легированный меньше эмиттера (n2)- коллектором. Нужно сказать, что слой базы легирован ещё меньше, чем слой коллектора. Таким образом, транзистор является асимметричным прибором. Рабочей (активной) областью транзистора является область, расположенная под донной частью эмиттерного перехода (на рис.1 эта область не заштрихована). Остальные (заштрихованные) участки структуры являются пассивными, т.е. в известной мере паразитными. Пассивные области можно в первом приближении моделировать резисторами, подключёнными к рабочим слоям базы и коллектора (рис.2).
Рис. 2. Структура транзистора
Взаимодействие между эмиттерным и коллекторным переходами обеспечивается малой шириной базы. У современных транзисторов она обычно не превышает 1 мкм, тогда как диффузионная длина пробега L лежит в пределах 5-10 мкм. Основные свойства транзистора определяются процессами в базе. Если база однородная, то движение носителей в ней чисто диффузионное. Если же база неоднородная, то в ней, как известно, есть внутреннее электрическое поле, и тогда движение носителей будет комбинированным: диффузия сочетается с дрейфом. Транзистор с однородной базой называют бездрейфовым (или диффузионным), а с неоднородной – дрейфовым. Последние имеют в настоящее время наибольшее распространение в интегральных схемах. По электрическим характеристикам и областям применения транзисторы делят на маломощные малошумящие (мощностью до 0,3 Вт), применяемые во входных цепях усилительных устройств, импульсные, мощные генераторные (мощностью свыше 3 Вт) - для радио передающих устройств, переключательные - для систем автоматического регулирования в качестве электронных ключей, фототранзисторы – для устройств, преобразующих световые сигналы в электрические с одновременным их усилением. По максимальной рабочей частоте транзисторы подразделяют на низкочастотные для работы в звуковом и ультразвуковом диапазоне частот (до 30 МГц), высокочастотные (до 300МГц) и сверхвысокочастотные (свыше 300 МГц). По конструктивным особенностям различают точечные транзисторы, содержащие один или два точечных перехода, размеры которых меньше характеристической длины, определяющей физические процессы в переходе и в прилегающих областях (за характеристическую длину может быть принята толщина области пространственного заряда (ОПЗ), диффузионная длина и пр.), и плоскостные, электрические переходы которых имеют линейные размеры, значительно большие толщины ОПЗ. По технологии изготовления переходов плоскостные транзисторы делят на сплавные, диффузионные, конверсионные, сплавные, диффузионные, конверсионные, сплавно-диффузионные, мезатранзисторы, эпитаксиальные, планарные, планарно-эпитаксиальные, ионно-имплантационные. В настоящее время большинство транзисторов, в том числе транзисторы интегральных микросхем, изготавливаются на основе кремния. Выпуск германиевых транзисторов ограничен.
2.2. Основные физические процессы в плоскостном транзисторе При отсутствии внешних напряжений на переходах в области каждого p-n перехода имеется двойной электрический слой пространственного заряда (рис.2), образованный в результате диффузии основных носителей через переход. Напомним, что электронно - дырочный p-n переход можно создать внутри полупроводника, если ввести в одну его область донорную примесь, а в другую – акцепторную. При этом уже при комнатной температуре атомы примесей полностью ионизированы, т.е. концентрацию основных носителей заряда вдали от границы перехода можно считать равной концентрации соответствующей примеси. На границе между областями с различными типами электропроводности возникают большие градиенты концентрации подвижных носителей зарядов. Это приводит к тому, что через границу проходят диффузионные токи (скажем, в p-области дырок много и они перемещаются туда, где их мало, т.е. в n- область, а электроны наоборот перемещаются из n- области в p -область): Iдиф=Ipдиф+Inдиф. Направление этого тока совпадает с направлением диффузии дырок. При своём движении, какдырки, так и электроны «оставляют» в соответствующих областях ионизированные атомы акцепторов и доноров, которые не могут принять участия в проводимости, т.к. они жёстко связаны с кристаллической решёткой полупроводника и обладают большой массой. В результате слева от границы раздела (рис.3) появляются нескомпенсированные отрицательные заряды ионизированных акцепторов, а справа - нескомпенсированные положительные заряды ионизированных доноров. Подвижные дырки и электроны при встречном движении усиленно рекомбинируют в приконтактных областях и «исчезают». Уход этих основных носителей и их рекомбинация приводит к образованию около границы слоя, обедненного подвижными носителями. Этой слой обладает относительно малой удельной проводимостью и поэтому называется запорным слоем. Образующаяся при этом разность потенциалов вызывает появление внутреннего электрического поля в переходе В равновесном состоянии при постоянной температуре произведение nnpn=ppnp=ni2=const, где nn- электроны в электронном полупроводнике; pp - дырки в дырочном полупроводнике; pn (дырки в электронном полупроводнике); np – электроны в дырочном полупроводнике. nn и pp – являются основными носителями, а np и pn – неосновными. Например, при комнатной температуре для германия ni2 =6,25*1026 см-6, а для а) p-n- переход без внешнего смещения; б)p-n- переход, смещенный в обратном направлении; в) p-n-переход, смещенный в прямом направлении. Рис. 3 Модель p-n-перехода и потенциальный барьер;
Концентрация основных носителей по обе стороны от перехода однозначно определяют величину равновесной разности потенциалов, которая может быть подсчитана по формуле, следующей из распределения Гиббса
где φт=kT/e – тепловой потенциал; k – постоянная Больцмана (1,38*10-23 Кл*в/град); e – заряд электрона (1,6*10-19 Кл); T – абсолютная температура (T=273+t˚С). При комнатной температуре T=300 К, φт =25 мВ; pp Наличие внутреннего электрического поля приводит к тому, что в узкой области δ0 полупроводник обеднен подвижными носителями (дырками и электронами), т.к. электрическое поле «расталкивает» их по обе стороны от барьера. Поэтому в отличие от однородных областей p и n сопротивление обедненного слоя шириной δ0 оказывается даже больше, чем у химически чистого полупроводника, у которого при комнатной температуре всегда имеется вполне определенная концентрация собственных дырок и электронов. Таким образом, обедненный слой имеет большое сопротивление, и его называют запорным слоем, препятствующим диффузии основных носителей. Одновременно с этим возникшее электрическое поле (поле неподвижных ионов) создаёт благоприятные условия для перехода из одной области в другую неосновных носителей, концентрация которых мала (и зависит от температуры). Так, некоторые электроны проводимости, являющиеся в р- области неосновными носителями, совершая, тепловое движение, подходят к приконтактному слою, где их захватывает электрическое поле и, совершая дрейф под действием сил этого поля, они переходят в n -область. Аналогичный процесс происходит с некоторыми дырками n- области, которые в этой области являются неосновными носителями. Следовательно, через границу двух сред существуют встречные потоки одноимённо заряженных частиц: диффузионный поток дырок из р -области и дрейфовый поток дырок из n- области и аналогично диффузионный поток электронов из n -области и дрейфовый поток электронов из р -области. Электрическое поле (потенциальный барьер) в переходе растёт до такого значения, при котором встречные потоки дырок (и аналогично встречные потоки электронов) становятся одинаковыми. Наступает состояние равновесия перехода. Для кремния φ0 =0,6-0,8 В, для германия φ0 =0,2-0,4 В. Дрейфовый ток через границу двух сред, создаваемый неосновными носителями, называется тепловым током IT. Он имеет электронную и дырочную составляющие :IT=IpT+InT. Так как концентрация неосновных носителей относительно мала, то и ток, образуемый ими, не может быть большим. Кроме того, он практически не зависит от величины поля в p-n переходе, т.е. является током насыщения неосновных носителей. Все неосновные носители, которые подходят к переходу, совершают переход через него под действием сил поля, независимо от его величины. Концентрация неосновных носителей, а следовательно, и тепловой ток очень сильно зависит от температуры. По своему направлению тепловой ток противоположен току диффузии и поэтому называется также обратным током (IT
При состоянии равновесия эти токи взаимно компенсируются. При этом
Ip-n=Iдиф-Iдр=0. Основные носители при встречной диффузии усиленно рекомбинируют в приконтактных областях. Средняя глубина проникновения диффундирующих дырок в n- область тем меньше, чем больше там концентрация электронов проводимости. Это объясняется зависимостью времени жизни дырок в этой области от nn. То же самое утверждение справедливо для средней глубины проникновения диффундирующих электронов в p -область. Следовательно, при Na
где dp и dn- толщина слоя, принадлежащая p и n – областям; ε0 =8,85*10-12 Ф/м – электрическая постоянная, ε – относительная диэлектрическая проницаемость кристалла (для германия 16, для кремния 12); φ – потенциальный барьер в р-n переходе (при отсутствии внешних равен φ0 – равновесной контактной разности потенциалов). Если концентрация примеси в одной из областей оказывается на 2-3 порядка больше, чем в другой, то в этом случае запирающий слой практически сосредотачивается в области с малой концентрацией примеси, а его граница в сильнолегированной области практически совпадает с металлургической границей p-n перехода. Например, при Na»Nd членом 1/Na можно пренебречь, поэтому
где
2.3. Вольт-амперная характеристика p-n перехода Если к p-n переходу подвести внешнее напряжение так, чтобы направление внешнего электрического поля совпало с направлением внутреннего электрического поля перехода, т.е. подключиться минусом к р -области и плюсом к n- области, то это приведёт к увеличению напряжённости электрического поля в p-n переходе и к увеличению высоты потенциального барьера до величины φ0+Е (рис.3б). При увеличении потенциального барьера диффузия основных носителей затрудняется настолько, что ток диффузии уже при незначительном внешнем напряжении практически обращается в нуль и результирующий ток перехода согласно формуле (1) Ip-n=Iдиф-I0= -I0 оказывается примерно равным обратному дрейфовому току насыщения неосновных носителей, который очень мал (единицы микроампер) из-за малой концентрации неосновных носителей. Кроме того, под действием возросшего поля основные носители будут возвращаться (отражаться) назад, что приведёт к уменьшению их концентрации на границах исходного запирающего слоя, т.е. в конечном счёте, приведёт к смещению этих границ и к увеличению толщины запирающего слоя. Напряжения указанной на рис.3б полярности, приводящее к росту потенциального барьера, называются обратными, а сам p-n переход – обратно включённым. Если к p-n переходу подвести прямое напряжение так, чтобы электрические поля, создаваемые контактной разностью потенциалов и внешним источником, оказались противоположными, то это приведёт к уменьшению высоты потенциального барьера до значения φ0-Е (рис.3в). Снижение потенциального барьера в прямо включённом p-n переходе облегчает диффузию основных носителей, поэтому ток диффузии увеличивается. Кроме того, происходит сужение запорного слоя. При прямом включении происходит преимущественное введение носителей зарядов в те области кристалла, где они являются неосновными, поэтому этот режим работы p-n перехода называют режимом инжекции (впрыскивания) неосновных носителей. Таким образом, p-n переход обладает несимметричной вольт-амперной характеристикой (рис.4). При прямом включении через переход проходит большой прямой ток, а при обратном - незначительный обратный ток, который практически определяется собственной электропроводностью полупроводника, сильно зависящей от температуры среды. Установлено, что ток диффузии, как при прямом, так и при обратном напряжении изменяется по экспоненциальному закону: Iдиф=I0exp[eU/kT],
где U- внешнее напряжение. Используя соотношение (1), получаем выражение для тока p-n перехода:
Рис.4. ВАХ p-n- перехода
Из рис. 4. видно, что p-n переход обладает резко выраженной односторонней проводимостью.
2.4. Принцип действия транзисторов На каждый p-n переход транзистора может быть подано как прямое, так и обратное напряжение. Соответственно различают четыре режима работы транзистора: - режим отсечки–на оба перехода подано обратное напряжение; - режим насыщения - на оба перехода подано прямое напряжение; - активный режим – на эмиттерный переход подано прямое напряжение, а на коллекторный - обратное; - инверсный режим - на эмиттерный переход подано обратное напряжение, а на коллекторный – прямое. При работе транзистора в качестве усилителя эмиттерный переход включают в прямом направлении, т. е. он открыт (p-n переход узкий), а коллекторный включают в обратном направлении, т.е. он закрыт (p-n переход широкий). Работа p-n-p транзистора в активном режиме и включённого в схеме с общей базой показана на рис.5.
Источник питания Ебэ подключён к эмиттерному переходу в прямом напряжении (плюсом к эмиттеру) и через эмиттерный переход проходит прямой ток. При этом из эмиттера в базу инжектируются дырки, а из базы в эмиттер – электроны. То есть ток эмиттера состоит из двух составляющих: электронной и дырочной: IЭ=IЭ диф=IЭр+IЭn=IЭБо[exp(EЭБ/φТ)-1} (6)
Так как pэ»nδ (эмиттер легирован значительно сильнее базы), то дырочная составляющая тока эмиттера оказывается много больше электронной составляющей IЭp»IЭn, которая замыкается через цепь базы и не может участвовать в создании тока коллектора. Поэтому её и стремятся сделать по возможности малой. Отношение
γ=IЭр /IЭ=IЭр /(IЭр+IЭn)=1/(1+IЭn /IЭр) (7)
называется коэффициентом инжекции (или эффективностью эмиттера). Коэффициент инжекции близок к единице: γ; =0,98-0,995. Инжектированные из эмиттера дырки в базе оказываются неосновными носителями, и они двигаются главным образом за счёт диффузии, стремясь равномерно распределиться по всему объёму базы. Так как толщина базы мала, большинство дырок не успевает рекомбинировать в ней и достигает коллекторного перехода. Но некоторое количество дырок всё же успевает рекомбинировать с электронами проводимости в базе, тем самым, вызывая дополнительный приток электронов в базу из внешней цепи. Это обусловливает разделение дырочной составляющей тока эмиттера: IЭp=IКу+IЭpeк, IКу – управляемая часть тока эмиттера, замыкающаяся через коллекторную цепь (рис.5) и определяемая дырками, дошедшими до коллекторного перехода; IЭрек – рекомбинационная составляющая тока эмиттера,которая замыкается через цепь базы и характеризует потери инжектированных дырок. Отношение
ξ=IКу/IЭр=IКу/(IКу+IЭрек) (8)
называется коэффициентом переноса. В основном рекомбинация происходит в пассивной области базы, но у правильно сконструированного кристалла IЭр» IЭрек и поэтому коэффициент переноса близок к единице: ξ;=0,988-0,995. Итак, у бездрейфового транзистора при обычном его режиме работы значения γ; и ξ; близки к единице. Поэтому и отношение h21Б=IКу/IЭ=(IКу/IЭр)(IЭр/IЭ)=ξγ;, (9)
называемое интегральным коэффициентом передачи тока эмиттера также оказывается близким к единице: h21Б =0,95-0,99. Этот коэффициент показывает, какая часть тока эмиттера замыкается через коллекторную цепь, а также характеризует управляющие свойства транзистора. Вблизи коллекторного перехода поток дырок попадает под действие электрического поля этого обратносмещённого перехода, что вызывает быстрый дрейф дырок через коллекторный переход в область коллектора (их экстракцию). В коллекторе электроны становятся основными носителями зарядов, они легко доходят до коллекторного вывода, создавая ток во внешней цепи транзистора. Нужно сказать, что при подключении обратного коллекторного напряжения происходит увеличение потенциального барьера и толщины коллекторного перехода, который увеличивается за счёт области базы. В коллекторной цепи (при отсутствии тока эмиттера, т.е. IЭ =0) появляется слабый ток обратно включённого p-n перехода. Этот ток называют обратным током коллектора и обозначают IКБо. Он в основном определяется концентрацией неосновных носителей (дырок) в базе, т.к. при рК»рБ, концентрация неосновных носителей в коллекторе оказывается пренебрежимо малой. Сопротивление обратносмещённого коллекторного перехода очень велико – несколько МегаОм и более. Поэтому в цепь коллектора можно включать весьма большие сопротивления нагрузки, не изменяя величину коллекторного тока. Соответственно в цепи нагрузки может выделяться значительная мощность. Сопротивление прямосмещённого эмиттерного перехода, напротив весьма мало (при токе 1 мA оно составляет около 25 Ом). Поэтому при почти одинаковых токах мощность, потребляемая в цепи эмиттера, оказывается несравненно меньше, чем мощность, выделяемая в цепи нагрузки. Следовательно, транзистор способен усиливать мощность, т.е. является усилительным прибором.
|


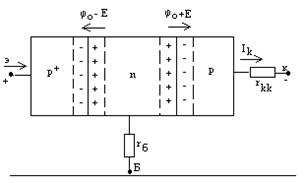
 На рис.2 активная область транзистора показана в горизонтальном положении. Здесь же показаны места подключения резисторов rб и rкк, характеризующих пассивные участки. Эмиттерному – высоколегированному - слою присвоен верхний индекс «+». Структура, показанная на этом рисунке, служит основой при анализе работы транзисторов.
На рис.2 активная область транзистора показана в горизонтальном положении. Здесь же показаны места подключения резисторов rб и rкк, характеризующих пассивные участки. Эмиттерному – высоколегированному - слою присвоен верхний индекс «+». Структура, показанная на этом рисунке, служит основой при анализе работы транзисторов. , где
, где  - ширина области перехода, в которой располагаются ионизированные примеси. Это внутреннее поле в переходе в дальнейшем будет препятствовать «перемешиванию» дырок и электронов. Когда разность потенциалов в переходе достигнет значения φ0, а поле φ0 /δ0, то ток прекратится. Такое состояние p-n перехода называется равновесным, а внутренняя разность потенциалов φ0 является равновесной разностью потенциалов.
- ширина области перехода, в которой располагаются ионизированные примеси. Это внутреннее поле в переходе в дальнейшем будет препятствовать «перемешиванию» дырок и электронов. Когда разность потенциалов в переходе достигнет значения φ0, а поле φ0 /δ0, то ток прекратится. Такое состояние p-n перехода называется равновесным, а внутренняя разность потенциалов φ0 является равновесной разностью потенциалов.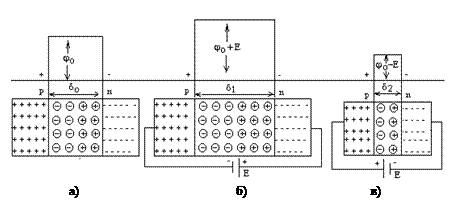 кремния ni2 =5*1020 см-6.
кремния ni2 =5*1020 см-6. ,(1)
,(1) Na,a nn
Na,a nn  (2)
(2) Nd запирающий слой оказывается смещённым (относительно металлургической границы) в сторону полупроводниковой области с меньшей концентрацией примеси. В общем случае толщина запирающего слоя определяется примерным равенством (при допущении равновесия и квазинейтральности):
Nd запирающий слой оказывается смещённым (относительно металлургической границы) в сторону полупроводниковой области с меньшей концентрацией примеси. В общем случае толщина запирающего слоя определяется примерным равенством (при допущении равновесия и квазинейтральности): ,(3)
,(3) , (4)
, (4) – некоторый коэффициент, характеризующий слаболегированный полупроводник n – типа. Толщина запирающего слоя обычно составляет десятые доли микрона.
– некоторый коэффициент, характеризующий слаболегированный полупроводник n – типа. Толщина запирающего слоя обычно составляет десятые доли микрона. (5)
(5)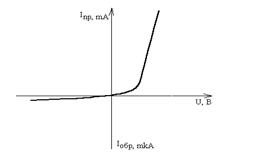
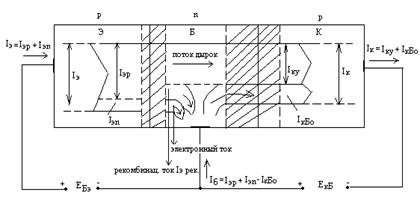 Рис.5. Распределение токов в p-n –p транзисторе.
Рис.5. Распределение токов в p-n –p транзисторе.


