Глава 6. Элементы интегральных схемЭлементами ИС называют неделимые составные части, которые нельзя отдельно специфицировать и поставить как отдельные изделия. Особенность элементов ИС в том, что они имеют электрическую связь с общей подложкой и иногда друг с другом. Поскольку элементы одной ИС получаются в одном технологическом процессе, имеется меньше «степеней свободы, чем при изготовлении дискретных аналогов (можно варьировать их длиной и шириной), параметры элементов ИС в значительной мере коррелированны и ограничены. Компонентами ИС называют те составные части ГИС, которые можно специфицировать отдельно и поставлять в виде отдельных изделий. Они представляют собой навесные детали, отличающиеся конструктивным оформлением. Главными элементами биполярных ИС являются п−р−п -транзисторы, на них ориентируются при разработке новых технологий, поэтому технология других элементов должна приспособиться к технологии п−р−п -транзисторов. В области МДП-тразисторных схем разработана технология комплементарных КМДП схем, которая по существу заняла главное место в технологии ИС. 6.1. Изоляция элементов. Элементы биполярных полупроводниковых ИС нужно изолировать друг от друга для исключения их электрической взаимосвязи через общую подложку. В случае МДП-транзисторов смежные истоки и стоки оказываются разделёнными встречно-включёнными р−п -переходами, что резко снижает их взаимосвязь. Все способы изоляции можно разделить на два главных типа: изоляцию обратносмещённым р−п -переходом и изоляцию диэлектриком (рис. 6.1). Обеднённый слой р−п - перехода имеет высокое удельное сопротивление, близкое к
Рис. 6.1
удельному сопротивлению диэлектрика. Из рис.6.1 ясно, что изоляция р−п-переходом сводится к реализации двух встречно-включённых диодов между изолируемыми элементами. Чтобы оба диода находились под обратным смещением, на подложку задают максимальный отрицательный потенциал ьот источника питания ИС. В случае наличия на подложке эпитаксиального п -слоя проблема изоляции существенно упрощается: диффузия для образования коллекторного «островка» (её называют разделительной или изолирующей) проводится через верхнюю поверхность пластины на глубину толщины эпитаксиального слоя (порядка 5 − 10 мкм). При такой малой глубине время диффузии составляет 2 − 3 ч, а боковая диффузия весьма незначительна (рис. 6.2).
Рис.6.2
Островки п -типа, оставшиеся в эпитаксиальном слое после разделительной диффузии,называют карманами. В них реализуются необходимые элементы ИС, в первую очередь − транзисторы. Транзисторы, изготовленные в карманах по рис.6.2, имеют большое горизонтальное сопротивление rкк коллекторного слоя (100 Ом более). Уменьшения значения rкк достигается использованием скрытого п+ -слоя, расположенного на дне кармана (рис.6.3). Скрытые слои получают диффузией, проводимой до наращивания эпитаксиального слоя. Создание скрытого п+ -слоя обеспечивает и больший инверсный коэффициент усиления, и меньший избыточный заряд в коллекторном слое в режиме двойной инжекции. Разделительная диффузия в эпитаксиальный слой является в настоящее время наиболее
Рис. 6.3 простым и распространённым вариантом изоляции р − п -переходом. Изоляция диэлектриком. Этапы исторически первого способа изоляции диэлектриком таковы: исходная пластина кремния п -типа покрывается эпитаксиальным слоем п+- типа (2 – 3 мкм); через маску вытравливают канавки глубиной 10 -15 мкм; всю рельефную поверхность окисляют; напыляют толстый слой поликристаллического кремния (200 – 300 мкм); исходную пластину п -типа сошлифовывают на всю толщину до дна канавок, так что получаютса карманы п- типа со скрытым п+- слоем в поликристаллической подложке. Изоляция - за счёт окисного слоя SiO2.
Рис. 6.4 На рис.6.4 показана суть технологии кремний на сапфире (SoS). Сапфир имеет одинаковую с кремнием структуру кристаллической решётки, поэтому на сапфире (подложке) можно нарастить эпитаксиальный слой кремния и затем протравить этот слой до сапфира для образования кремниевых карманов. Карманы снизу изолированы друг от друга сапфиром (диэлектриком), а с боковых сторон – воздухом. Изопланарная технология. В результатесквозного локального прокисления эпитаксиального слоя кремния п -слой оказывается разделённым на отдельные карманы п -типа. В этом случае боковые изолирующие слои диэлектрические (окисные), а донные части разделены встречно-включёнными р-п − переходами. Поэтому изопланар относится к комбинированным методам. 6.2. Транзисторы п-р-п. На рис. 6.5 показано распределение примесей в слоях интегрального транзистора со скрытым п +-слоем. Видно, что распределение акцепторов в
Рис. 6.5
базовом слое не монотонно, поэтому СП рава от точки максимума градиент концентрации дырок отрицательный и внутреннее поле для инжектированных электронов ускоряющее, а слева от точки максимума − наоборот. Наличие участка с тормозящим полем приводит к некоторому увеличению времени пролёта носителей через базу. Так как это увеличение составляет около 20−30 ℅, для приближённых оценок его можно не учитывать. Ниже приведены типичные параметры слоёв интегрального п-р-п −транзистора:
подложка р-типа: N = 1,5∙1015; d = 300; ρ= 10; Rs= −; cкрытый п+- слой: d = 5 – 10;; ρ= −; Rs= 8-20; коллектор: N = 1016; d = 10 - 15; ρ=0,5; Rs= 500; база р -типа: N = 5∙1018; d = 2,5; ρ= −; Rs= 200; эмиттер п -типа: N = 1021; d =2; ρ= −; Rs= 5 - 1;
Примечание: N – концентрация примеси (для диффузных базового и эмиттерного слоёв – поверхностная концентрация) см -3, d – глубина слоя мкм, ρ - удельное сопротивление материала Ом∙см, Rs – удельное сопротивление слоя Ом/□. Отметим, что пробивное напряжение эмиттерного перехода в 5-7 раз меньше, чем коллекторного. Это связано с тем, что эмиттерный переход образован более низкоомными слоями. При включении транзистора с общим эмиттером напряжение коллекторного перехода уменьшается. Если база тоньше 1 мкм, то пробой обычно связан с эффектом смыкания. Паразитные параметры. На рис. 6.6 дана упрощённая структура интегрального р-п-р − транзистора, особенность которого в наличии четырёхслойной структуры: наряду с рабочими переходами эмиттерным и коллекторным возникает третий (паразитный) переход между коллекторным п- слоем и подложкой р -типа. Подложку р -типа присоединяют к самому отрицательному потенциалу, поэтому напряжение на переходе К-П всегда обратное или близко к нулю и этот переход можно заменить барьерной ёмкостью Скп. Тогда эквивалентная схема п-р-п – транзистора имеет вид по рис. 6.6,б. Цепочка rкк-Скп есть главная особенность интегрального п-р-п – транзистора. Она шунтирует коллектор и ухудшает быстродействие, снижает предельную частоту и увеличивает время переключения прибора.
А б в Рис. 6.6
Пассивную область базы с лежащими под ней боластями коллектора и подложки можно представить как некий паразитный р-п-р – транзистор (рис.6.6,в). В случае диэлектрической изоляции паразитный транзистор отсутствует, но ёмкость Скп сохраняется. 6.3.Разновидности п-р-п – транзисторов. Нарис.6.7 представлена структура многоэмиттерного транзистора. Такие транзисторы составляют основу весьма распространённого класса цифровых ИС – так называемых схем ТТЛ. Приближённо МЭТ можно рассматривать как совокупность нескольких транзисторов с объединёнными базами и коллекторами. Каждая пара смежных эмиттеров с разделяющим их р -слоем образует горизонтальный (продольный) транзистор типа п+-р-п+. Если на эти эмиттеры поданы противоположные напряжения, то один из них будет инжектировать электроны, а второй собирать часть из них. Такой транзисторный эффект является паразитным, во избежание чего расстояние между эмиттерами должно превышать диффузную длину носителей в базовом слое. Если транзистор легирован золотом, то диффузионная длина не превышает 2-3 мкм, поэтому оказывается достаточным расстояние 10-15 мкм.
Рис. 6.7
Важно, чтобы МЭТ имел как можно меньший инверсный коэффициент передачи тока. В этом случае существенно уменьшается паразитный ток от коллектора к эмиттеру. Для дополнительного уменьшения инверсного коэффициента αI в МЭТ искусственно увеличивают сопротивление пассивной базы удалением базового контакта от активной области транзистора (рис. 6.7): сопротивление перешейка составляет 200-3000 Ом и падение напряжения на нём равно 0,1 – 0,15 В. На столько же уменьшится прямое напряжение на коллекторном переходе, а вместе с ним и инжекция электронов из коллектора в активную область базы в инверсном режиме. Структура многоколлекторного транзистора (МКТ) показана на рис. 6.8. Она не отличается от структуры МЭТ, разница лишь в использовании: МКТ – это МЭТ в инверсном режиме. Общий эмиттер – эпитаксиальный п -слой, коллекторы – высоколегированные п+- слои малых размеров. Главная проблема в разработке МКТ – увеличение нормального коэффициента передачи тока от эмиттера каждому коллектору. Для этого желательно, чтобы скрытый п +-слой лежал как можно ближе к базовому, тогда этот п+- слой обеспечит высокий коэффициент инжекции. Чтобы повысить коэффициент передачи, следует п+- коллекторы располжить как можно ближе друг к другу. В результате можно получить коэффициенты передачи на всю совокупность коллекторов α = 0,8 – 0,9, что соответствует В = 4 – 10.
А б Рис.6.8
Отметим, что предельная частота для МКТ составляет не более 20-50 МГц, то есть значительно меньше, чем у одиночных транзисторов (200 – 500 МГЦ). Транзистор с барьером Шоттки (ТШ). Структура интегрального ТШ представлена на рис.6.9. Видно, что алюминиевая металлизация омического контакта с р -слоем базы продлена в сторону коллекторного п -слоя. При этом алюминиевая полоска образует с р -слоем базы омический невыпрямляющийконтакт, а с п -слоем коллектора – контакт Шоттки (выпрямляющий). Показанное на рис.6.9 структурное решение можно использовать и в МЭТ. В обоих случаях отсутствуют накопление и рассасывание избыточных зарядов и получается существенный выигрыш (в 1,5-2 раза) во времени переключения транзистора из полностью открытого в запертое состояния
Рис.6.9
Супербета транзистор. Это название имеет транзистор со сверхтонкой базой w = 0,2 -0,3 мкм. При такой ширине базы коэффициент усиления базового тока равен В = 3000 – 5000 и более, что и объясняет название. Изготовление такой базы требует допуска ±0.02 мкм на эмиттерную диффузию, что приближается к пределу технологических возможностей. Когда при диффузии эмиттерного слоя его металлургическая граница приближается к такой же границе коллекторного слоя на расстояние 0,4 мкм, возникает эффект оттеснения коллекторного перехода: эмиттерный слой продавливает металлургическую границу ранее полученного базового слоя. Большой коэффициент усиления у супербета транзисторов покупается ценой очень малого пробивного напряжения (1,5 – 2) В. Это – результат смыкания переходов при очень тонких базах. Поэтому супербета транзисторы являются не универсальными, а специализированными элементами ИС с главным применением во входных каскадах операционных усилителей. 6.4. Транзисторы р-п-р. В настоящее время основным структурным вариантом р-п-р – транзистора является прибор горизонтального типа, представленный на рис. 6.10. Он изолирован от других элементов, имеет удовлетворительные параметры, а его технология полностью вписывается в цикл технологии с разделительной диффузией
Рис.6.10
Эмиттерный и коллекторный слои получают на этапе базовой диффузии и коллекторный слой охватывает эмиттер со всех сторон. Это позволяет собирать инжектированные дырки со всех сторон эмиттерного слоя. Ширину базы можно сделать около 3 -4 мкм, так что предельная частота может составить 20 – 40 МГц, а коэффициент усиления до 50.
Рис.6.11 Транзистор по рис. 6.10 − бездрейфовый, т.к. его база однородная (эпитаксиальный п -слой), поэтому его частотные и переходные характеристики примерно на порядок хуже таковых р-п-р – транзистора с учётом меньшей подвижности дырок. Большие возможности для повышения качества р-п-р – транзисторов открывает технология SoS (рис.6.11). В этом варианте р-п-р – транзистор реализуется по существу отдельно от п-р-п – транзисторов, начиная с эпитаксии р- слоя. Поэтому и ширина базы, и степень легирования эмиттерного слоя могут быть оптимизированы. 6.5. Интегральные диоды. По существу интегральный диод есть диодное включение интегрального транзистора. На рис.6.12 показаны пять возможных вариантов диодного включения транзисторов, которые различаются и по статическим, и по динамическим параметрам.
Рис. 6.12
Пробивные напряжения U пр меньше у тех вариантоа, в которых используется эмиттерный переход. Обратные токи Iобр − это токи термогенерации в переходах и меньше у вариантов, где используется только эмиттерный переход, имеющий наименьшую площадь. Ёмкость дилда Сд( между анодом и катодом ) максимальна при параллельном соединении переходов (вариант Б-ЭК). Паразитная ёмкость на подложку С0 шунтирует анод или катод диода.; у варианта Б-Э эта ёмкость минимальна. Время восстановления обратного тока (время переключения) минимально у варианта БК-Э − заряд накапливается только в базовом слое. Сравнивая варианты, можно заключить, что оптимальными вариантами являются БК-Э и Б-Э. Чаще всего используется вариант БК-Э. 6.6. Полевой транзистор. Типичные структуры полевых транзисторов в изолированных карманах показаны на рис. 6.13.
с п -каналом с р -каналом Рис. 6.13
Как видим, р-слой затвора окружает сток со всех сторон, так что ток между истоком и стоком может протекать только через управляемый канал. а. На подложку, а значит,. и на р +-слой задают постоянный (максимально отрицательный) потенциал; поэтому они не выполняют управляющих функций. В п -карманах вместо скрытого п +-слоя осуществляется скрытый р+- слой для уменьшения начальной толщины канала. Чтобы скрытый р+- слой проник в эпитаксиальный слой достаточно глубоко, в качестве диффузанта применяют бор или галлий (с большим коэффициентом диффузии). Структура по рис. 6.13,б совпадает со структурой п-р-п -транзистора. Роль канала играет участок базового р -слоя между п +- и п -слоями. Чтобы области истока и стока соединялись только через канал, п+- слой делают более широким (в плане), чем п -слой, так что п+- слой контактирует с эпитаксиальнымп-слоем и вместе образуют «верхний» и «нижний» затворы. На рис.6.13,б контакт между этими затворами показан штриховой линией. Подложка соединяется с наибольшим отрицательным потенциалом. 6.7. МДП – транзисторы. Главную роль в современной электронике играют МДП-транзисторы, диэлектриком в них является SiO2. Это МОП-транзисторы. Простейший МОП-транзистор. На рис.6.14 приведена структура МОП-транзистора с индуцированным п -каналом. Очевидна технологическая простота МОП-транзистора при сравнении с биполярным, что обеспечивает меньший брак и меньшую стоимость при изготовлении. Отсутствие
Рис. 6.14
изолирующих карманов способствует лучшему использованию площади кристалла. Главным лимитирующим быстродействие МДП- транзисторов фактором являются паразитные ёмкости. Барьерные ёмкости переходов истока Спи и Спс при размерах п+- слоёв 20Х40 мкм лежат в пределах 0,04 – 0,10 пФ. Ёмкости перекрытия Сзи и Сзс точному расчёту не поддаются, но порядок величин можно оценить при ширине истока и стока и перекрытии 2 мкм так Сзи = Сзс ≈ 0.03 пФ. Однако ёмкость Сзс (ёмкость обратной связи) проявляется во многих случаях в виде гораздо большей ёмкости КСзс, из-за так называемого эффекта Миллера (К – коэффициент усиления схемы). В комплементарных МОП ИС (КМОП) один из типов транзисторов надо размещать в специальном кармане. Так, если подложка р -кремний, то п- канальный прибор можно реализовать прямо в подложке, а для р -канального прибора потребуется карман с п -проводимостью, что связано с ростом технологических операций. Другой способ изготовления КМОП ИС – технология SoS. Что касается сочетания МОП-транзисторов с биполярными, то п -канальные транзисторы
Рис. 6.15
реализуются непосредственно в р -подложке на этапе эмитттерной диффузии, а р -канальные – в изолирующих карманах на этапе базовой диффузии.(рис. 6.15). В процессе развития МЭ совершенствование МОП-транзисторов проходило по двум главным направлениям: повышение быстродействия и снижение порогового напряжения. Способы повышения быстродействия. Повышение быстродействия требует уменьшения емкостей перекрытия. Последнее достигается использованием технологии совмещённых затворов − слои истока и стока реализуются после создания затвора. При этом затвор используется как маска при получении слоёв истока и стока, так что края затвора и этих слоёв совпадут, а перекрытие исчезнет. Один вариант МОП-транзистора с самосовмещённым затвором показан на рис. 6.16. начала проводится диффузия п+- слоёв так, что расстояние между ними больше желаемой длины канала. Затем участок между п +-слоями и частично над ними тонко окисляется, на тонкий окисел напыляется алюминиевый затвор шириной меньшей расстояния между п +-слоями. Наконец, проводится ионное легирование через маску, образованную затвором и толстым защитным слоем. Атомы фосфора входят в кремний через тонкий слой и продлевают п +-слои до края алюминиевой полоски.
Рис. 6.16
Уменьшение паразитных емкостей МОП-транзисторов выдвигает задачу уменьшения постоянной времени крутизны τs. Пр и малых емкостях она становится главным ограничивающим быстродействие фактором. Переход к транзисторам с п -каналом позволил уменьшить τs почти в 3 раза. Дальнейшее уменьшение τs требует уменьшения длины канала L. Этот путь наиболее успешно реализуется методом двойной диффузии, с помощью которого можно достичь значения длины L не более 1 мкм. При этом значение τs может быть не более 0,005 нс, а граничная частота fs более30 ГГц. МНОП-транзистор. Диэлектрик у такого транзистора имеет структуру сэндвича, состоящего из слоёв нитрида и окиси кремния (рис. 6.17). Слой окисла толщиной 2 5 нм получают термическим окислением, а слой нитрида – реактивным напылением толщиной 0,05 – 1 мкм (чтобы пробивное напряжение превышало 50 -70 В
Рис. 6,17
Главная особенность МНОП-транзистора – возможность менять пороговое напряжение подачей на затвор коротких (100 мкс) импульсов напряжения разной полярности с большой амплитудой (30-50 В): при подаче импульса +30 В пороговое напряжение устанавливается U0 = -4 B и сохраняется в дальнейшем (рис. 6.17,б) при работе транзистора в режиме малых сигналов (Uз ≤ ±10 В). Если затем подать импульс -30 В, то пороговое напряжение сделается равным U0 = -20 B и сигналы Uз ≤ ±10 В не смогут вывести транзистор из запертого состояния. Поэтому благодаря гистерезисной зависимости U0(U3) МНОП-транзистор можно переводить из рабочего состояния в запертое и обратно. Это свойство используется в запоминающих устройствах. В основе работы МНОП-транзистора лежит накопление заряда на границе нитридного и оксидного слоёв. При большом −напряжении U3 на границе накапливается заряд +, что равносильно введению доноров в диэлектрик и приводит к увеличению отрицательного U0. При большом +напряжении U3 на границе накапливается −заряд, что приводит к снижению отрицательного U0. При малых U3 накопленный заряд может сохраняться в течение тысяч часов.
|

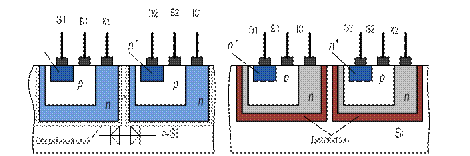

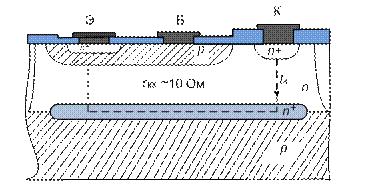


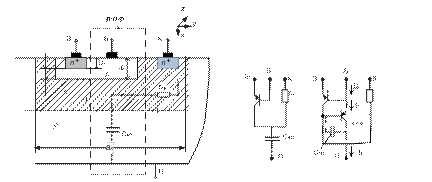


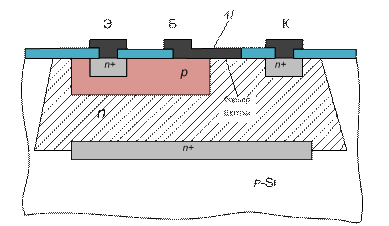
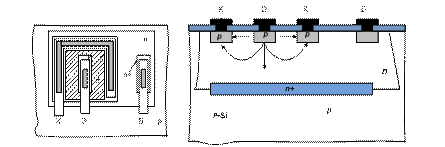 а б
а б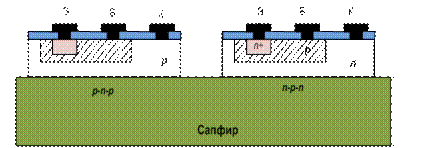

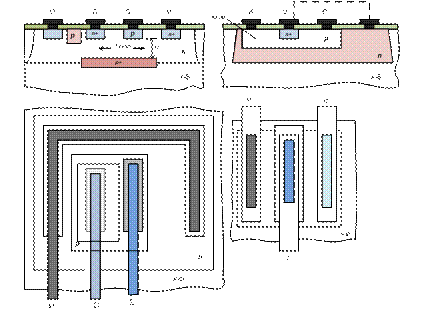 а б
а б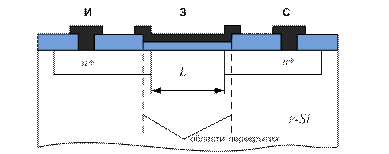
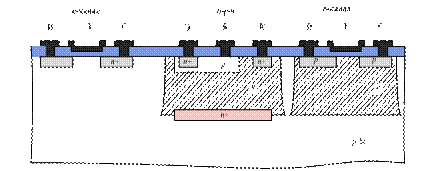

 а б
а б


