Электронная микроскопияОсновная задача любой микроскопии – дать наблюдателю увеличенное изображение объектов с необходимым числом деталей (разрешением), используя различия тех или иных физических характеристик этих деталей (необязательно оптических). Пространственное и временное разрешение. Под разрешающей силой прибора понимают способность регистрировать раздельно два события или объекта, близких друг к другу во времени или пространстве. Существуют различные количественные меры оценки разрешающей способности и способы ее определения (рис. 3.1).
Рис. 3.1. Три способа определения величины разрешения d: а – по размытию ступеньки, измеряемом расстоянии между уровнями сигнала 0,1 и 0,9; б – по ширине колоколообразного сигнала на полувысоте для бесконечно узкого пика; в – по критерию Рэлея (когда провал между двумя максимумами в сигнале, возникающим от двух бесконечно узких пиков, составляет 26 %). В верхнем ряду показана идеализированная ситуация, в нижнем – реальная
Так, в электронике распространен способ тестирования быстродействия (разрешения во времени) «прямоугольным» скачком напряжения (рис. 3.1, а). Реально любой тестирующий фронт, разумеется, имеет конечное время нарастания, но его длительность должна быть гораздо меньше, чем время отклика системы на внезапное возмущение. Тогда за временное разрешение прибора принимают время установления сигнала на выходе между уровнями 0,1 и 0,9 от его амплитудного значения. Аналогичным образом можно охарактеризовать и пространственное разрешение оптического, электронного или зондового микроскопа при определении геометрических параметров шероховатой поверхности, имея тестовую пластинку с прямоугольными выступами или канавками. Рис. 3.1, б иллюстрирует способ определения по величине уширения на полувысоте бесконечно узкого пика. Такой способ чаще всего используют в спектральном и дифракционном анализе. В соответствии с критерием Дж.У. Рэлея две точки можно видеть раздельно, если центр светлого дифракционного пятна на изображении каждой из них пересекается с краем темного кольца от другой точки. Для некогерентных точечных излучателей это соответствует провалу освещенности в центре между двумя максимумами на 26 % относительно освещенности в центре светлых пятен (рис. 3.1, в). Данный подход можно применить и к неоптическим задачам. Оптические микроскопы используют световой пучок и отличия в коэффициентах поглощения, отражения или преломления между отдельными областями объекта, их топологические особенности и др. Принципиально их разрешающая способность ограничивается дифракционным пределом d» 0,5l/ n, гдеl – длина волны света (0,4...0,8 мкм для видимого диапазона электромагнитных волн); n – коэффициент преломления прозрачной среды, в которой находится образец (для воздуха n = 1, для иммерсионных жидкостей n» 1,5). В результате в видимой части спектра можно получить разрешение не лучше 0,2 мкм (с учетом технических погрешностей и других мешающих эффектов обычно оно составляет 0,3...0,5 мкм). С целью увеличения разрешения в 20-е годы прошлого века было предложено заменить световой луч пучком ускоренных электронов, В 30-е годы были построены первые электронные микроскопы с использованием магнитных принципов фокусировки пучка, которые применяются и в современных приборах. Принцип корпускулярно-волнового дуализма позволяет приписать потоку электронов волновые свойства и соответствующую длину волны де Бройля, нм:
где h – постоянная Планка; р, т и е – импульс, масса и заряд электрона соответственно; U – ускоряющее напряжение, кВ. Заметим, что формула (3.1) дана без учета релятивистских поправок Существует множество других разновидностей электронной микроскопии. Рассмотрим самые распространенные из них. Просвечивающая электронная микроскопия (ПЭМ), или Transmission Electronic Microscopy (ТЕМ) в английском написании. Исторически первым был создан именно просвечивающий электронный микроскоп (М. Кнолль и Э. Руска, 1931 г.). С тех пор, несмотря на множество технических усовершенствований, улучшающих разрешение, облегчающих работу и анализ полученных изображений, его принципиальная схема (рис. 3.2) не претерпела существенных изменений. Электронно-лучевая пушка с термоэмиссионным или электрополевым катодом испускает поток электронов, который формируется в упорядоченный пучок необходимой геометрии с помощью магнитных линз, играющих роль конденсоров в оптической системе. Фокусировка пучка осуществляется изменением тока в магнитных катушках, а не положением линз, как в оптическом микроскопе. Она основана на отклонении электронов магнитным полем (силами Лоренца) в направлении, перпендикулярном как к вектору скорости движения, таки к вектору индукции поля. Пучок проходит через образец, собирается магнитной объективной линзой, а затем с помощью проекционных линз подается на люминесцентный экран, который визуализирует информацию об образце, Получаемое изображение может быть увеличено дополнительно посредством оптического микроскопа. Все устройство размещают в колонне, откачиваемой до высокого вакуума, чтобы избежать рассеяния и потерь энергии электронов от столкновения с молекулами воздуха (рис. 3.3). Для регистрации изображения сначала применяли фоточувствительные материалы (фотопленку, фотопластинки), однако в последнее время они вытесняются цифровыми матрицами (как в цифровых фотокамерах). Это позволяет сразу же получать оцифрованную информацию об образце, обрабатывать ее, используя современные компьютерные программы анализа изображений и сохранять в долговременной памяти. Для повышения разрешения, увеличения числа рабочих мод (доступных методов исследования), расширения сервисных возможностей современные электронные микроскопы могут быть дополнительно оснащены электрополевыми катодами (на основе диода Шоттки), специальными энергетическими фильтрами (монохроматизаторами) для падающего пучка электронов и спектрометрами – для прошедшего, прецизионными гониометрами с большим числом степеней свободы (до шести), компьютеризированной системой управления прибором и обработки данных и др.
Рис. 3.2. Принципиальная схема
В качестве примера на рис. 3.3 показан просвечивающий микроскоп «LIВRA 200РЕ» германской фирмы Carl Zeiss. Основные технические характеристики микроскопа «LIBRA 200FE» Ускоряющее напряжение, кв 120...200 Предельное пространственное разрешение, нм < 0,14 Энергетическое разрешение спектрометра, эВ < 0,7 Вакуумная система Безмасляная Управление и графический интерфейс Под Windows ХР В конце 2005 г. эта фирма сообщила о разработке и окончании испытаний ультравысокоразрешающего трансмиссионного электронного микроскопа (UHRTEM). В нем достигается субангстремное разрешение – 0,08 нм при U = 200 кВ (и даже 0,07 нм в некоторых специфических направлениях на изображении структуры).
Рис. 3.3. Общий вид просвечивающего электронного
Образцы для ПЭМ должны быть тщательно подготовлены. Поскольку длина свободного пробега электронов в конденсированном веществе при рабочем ускоряющем напряжении в сотни киловольт составляет доли микрометра (максимум – единицы микрометров), для исследования этим методом доступны только очень тонкие фольги или срезы. Первые получают полировкой, электрохимическим или ионным травлением, вторые – срезанием тонких слоев на специальной машине – микротоме (главным образом, для полимерных и биологических материалов). Другая возможность – приготовление реплик с поверхности исследуемого образца. Они могут изготавливаться методом осаждения, напыления и др. Лучшие результаты ПЭМ дает для пленок, имеющих толщину, сравнимую с длиной свободного пробега электронов. Обычно используют два основных режима работы ПЭМ, которые позволяют получить: а) изображение образца или б) дифракционную картину рефлексов. Изображение формируется вследствие того, что разные атомы рассеивают и поглощают быстрые электроны с различной эффективностью. Пример изображения карбоновых наноструктур в ПЭМ высокого разрешения показан на рис. 3.4.
Как известно, в дифракционной картине от периодических структур имеются максимумы (рефлексы) различного порядка: нулевого, первого, второго и т. д. В зависимости от угла, отсчитанного от не рассеявшегося пучка, и периодичности структуры. Электронные микрофотографии получают в условиях, когда апертурная диафрагма вырезает из общего потока только центральный пучок(дифракционный максимум нулевого порядка). Они могут дать сведения о размерах и форме отдельных зерен, фаз и других структурных единиц. Информация другого рода содержится в электронограмме – дифракционной картине, получаемой при пропускании максимумов более высокого порядка (при большей апертуре диафрагмы). После соответствующей обработки по ней можно судить о типе кристаллической решетки, межплоскостных расстояниях, ориентации кристаллитов и др. Более подробно о дифракционном анализе см. § 3.2. Небольшие изменения в оптической системе ПЭМ позволяют наблюдать объект как в светлом, так и в темном поле (подобно оптической микроскопии). Значительно увеличить объем информации, извлекаемый из снимков и изучения деталей, интенсивность которых близка к шуму, можно после использования специальных методов обработки изображения, например быстрого преобразования Фурье. Растровая (сканирующая) электронная микроскопия (РЭМ), или Scanning Electronic Microscopy (SEM) в английском переводе. В отличие от обычного просвечивающего микроскопа в растровом изображение строится не одновременно во всех точках, а последовательно, путем сканирования образца сфокусированным пучком по определенной траектории от точки к точке. Синхронно на мониторе по экрану движется луч, формирующий изображение, как это делается в обычном телевизоре. Более подробно принципы сканирования и построения двух- или трехмерных изображений по этим данным будут описаны в гл. 4. Обобщенная принципиальная схема РЭМ представлена на рис. 3.5. Одновременно все изображенные (и не изображенные) на рис. 3.5 приспособления, конечно, не используют. Их устанавливают по мере необходимости и обычно поставляют опционно. Впервые растровые электронные микроскопы были построены, так же как и просвечивающие, в 30-е годы прошлого века. Ввиду своей многофункциональности и универсальности они получили большее распространение, чем ПЭМ. Зондом в РЭМ является тонкий пучок электронов (обычно диаметром порядка 1 мкм, а в лучших образцах ~ 1 нм), который сканирует образец в результате работы магнитной отклоняющей системы. Разрешение в РЭМ определяется диаметром пучка, ускоряющим напряжением (как правило, в диапазоне 0,1... 30 кВ) и рядом других обстоятельств. Обычно оно составляет около 1 мкм, но путем различных усовершенствований его можно довести до 1...5 нм, а в отдельных случаях (просвечивающая РЭМ) – до 0,2...0,3 нм. Наряду с прошедшими через образец электронами в РЭМ можно регистрировать множество других эффектов и сигналов из облучаемой зоны: эмиссию света (катодолюминесценцию), тормозное и характеристическое рентгеновское излучение, отраженные, вторичные и Оже-электроны, разность потенциалов на противоположных сторонах образца и др. В каждом из этих сигналов содержится независимая информация об облучаемой зоне, что делает РЭМ намного более информативной и универсальной, чем ПЭМ. Так, растровая микроскопия позволяет исследовать микрорельеф, определять локально химический состав, распределение отдельных элементов по образцу, проводить рентгеновский спектральный анализ в заданных точках и др. РЭМ дает возможность получать снимки с большой глубиной резкости, что делает его незаменимым инструментом в исследованиях шероховатых поверхностей, биообъектов и структур со сложной топологией, трехмерных наноэлектромеханических систем и т.п. Все эти дополнительные возможности появляются благодаря неупругим столкновениям зондирующих электронов с атомами образца. Очень важны одноэлектронные возбуждения атомов. Если падающий электрон возбуждает электрон из верхней оболочки или валентной зоны, то такое возбуждение может релаксировать путем излучения фотона (катодолюминесценция), эмиссии вторичных электронов или Оже-электронов. Если происходит выбивание электрона из нижних оболочек (например,
Рис. 3.5. Обобщенная принципиальная схема РЭМ: Параметры всех этих видов эмиссии сильно зависят от природы атома, претерпевшего возбуждение. Следовательно, соответствующие сигналы содержат информацию о химическом составе области облучения. Падающие электроны могут вызвать и коллективные виды возбуждения (фононы, плазмоны и др.), которые также могут служить источником информации о материале образца. В качестве примера современного растрового электронного микроскопа на рис. 3.6 показан прибор «SUPRA 60 VР» фирмы Carl Zeiss. В вакууме он обеспечивает разрешение 1 нм (при ускоряющем напряжении 15 кВ) и позволяет достигать разрешения 2 нм (при U = 30 кВ) в условиях остаточного давления до133 Па. Последнее полезно для исследования биообъектов. Высокое разрешение сочетается с большим набором аналитических возможностей (спектроскопия энергетических потерь, дисперсионных характеристик, дифракционные методы в обратном рассеянии и др.).
Рис. 3.6. Общий вид растрового электронного
Основные технические характеристики микроскопа «SUPRA 60VP» Пространственное разрешение (в режиме контролируемой атмосферы), нм: при напряжении 15 кВ............................................... 1 »» 1 кв......................................................... 1,7 »» 0,1 кВ...................................................... 4 »» 30 кВ....................................................... 2 Увеличение, крат........................................................ 12…900000 Операционный столик, число степеней свободы 6 Система обработки изображения: число мод.................................................................. 7 разрешение, пиксели............................................. 3072х2304 подавление шума.................................................... Предусмотрено Система управления.................................................. Специальный пакет Smart SEM
Существуют и «комбайны», объединяющие функции хорошего просвечивающего микроскопа с некоторыми опциями растрового (так называемого мода STEM). В частности, упоминавшийся выше микроскоп «LIВRA 200FE» (рис. 3.3) позволяет реализовать моду STEM. Интересный недорогой прибор ТМ-I000 предлагает японская фирма Нitachi. Это простой настольный растровый микроскоп с увеличением 20... 10000´ (при использовании цифрового зума – до 40000´). Он позиционируется как альтернатива оптическим микроскопам, но отличается на порядок более высоким разрешением. Кроме того, он обладает гораздо большей глубиной резкости, чем обычный микроскоп, и способен различать участки, представленные атомами с разными номерами, т.е. позволяет проводить фазовый анализ. Высокоскоростная микроскопия. Помимо статических изображений электронная микроскопия может исследовать и быстропротекающие явления в режиме однократной вспышки или стробирования (при наличии в процессе высокой степени периодичности). Формируя модулятором короткие волновые пакеты электронов и варьируя время задержки, можно последовательно получать снимки объекта через малые доли секунды (до 10-8...10-9 с, а в рекордных случаях – и до 10-12 c). В частности, в одном из вариантов такой высокоскоростной микроскопии вместо обычного термоэмиссионного использовали специальный фотоэмиссионный катод. Он представлял собой пленку золота толщиной 20 нм, нанесенную на кварцевую подложку и освещаемую периодически (с частотой до 80 МГц) короткими лазерными вспышками длительностью 0,2 пс. Это позволило проводить спектроскопические исследования катодолюминесценции с пространственным разрешением 50 нм И временным 10 пс. Резюме. Электронная микроскопия – мощнейшее средство изучения наноструктур, в ряде случаев не заменимое другими методами. Вместе с тем наряду с большими достоинствами ей присущи и серьезные родовые недостатки: необходимость сложной и трудоемкой подготовки образцов, в результате которой их свойства могут сильно измениться; существенные радиационные повреждения под действием высокоэнергетических электронов пучка, вследствие чего структура и свойства материала могут претерпеть значительные изменения в процесс е исследования; необходимость вакуумирования рабочего объема прибора; высокая стоимость микроскопа (~ 1 млн дол. США); сложность эксплуатации; жесткие квалификационные требования к персоналу и др.
|


 , (3.1)
, (3.1)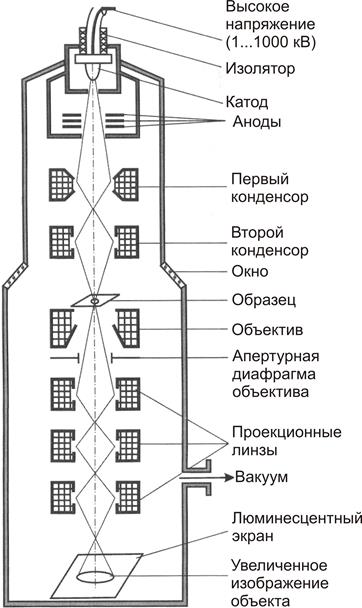

 Как уже упоминалось выше, рассеяние может быть упругим и неупругим. В первом случае энергия и длина волны падающего излучения не меняются. Упругое рассеяние приводит к дифракции и интерференции волн, создающих дифракционную картину от объекта, неупругое вызывает различные возбуждения в атомах исследуемого вещества и переизлучение, что используется в разнообразных методах микроанализа химического состава.
Как уже упоминалось выше, рассеяние может быть упругим и неупругим. В первом случае энергия и длина волны падающего излучения не меняются. Упругое рассеяние приводит к дифракции и интерференции волн, создающих дифракционную картину от объекта, неупругое вызывает различные возбуждения в атомах исследуемого вещества и переизлучение, что используется в разнообразных методах микроанализа химического состава.




