I. ЦЕЛЬ РАБОТЫ
Исследование параметров полупроводникового материала и границы раздела полупроводник-диэлектрик с помощью волът-фарадных характеристик МДП-структуры диода. II. ВВЕДЕНИЕ Структура МДП представляет собой полупроводник с нанесенным на него тонким слоем диэлектрика, на поверхности которого находится металлический электрод. Свойства и параметры такой структуры определяются процессами в полупроводнике, точнее на границе раздела между полупроводником и диэлектриком. В свою очередь, физические свойства приповерхностной полупроводниковой области зависят от свойств диэлектрика, в частности, от его толщины dд, диэлектрической проницаемости εд и электрического заряда в нем Qд. Например, если в слое диэлектрика имеются положительные заряды, то приповерхностный слой полупроводника р-типа содержит электроны у поверхности, слой ионизованных акцепторов свободные дырки. Свободные электроны при этом вытягиваются из объема полупроводника и концентрируются на границе. За счет этого происходит изгиб энергетических зон. Эффект изгиба зон можно наблюдать и за счет разности работ выхода между диэлектриком и полупроводником. Например, в системе кремний-диоксид кремния у кремния величина термодинамической работы выхода ФSi = 4,8 эВ, а у диоксида кремния ФSiО2 = 4,4 эВ, приповерхностный слой полупроводника обогащается электронами. На рис.1 изображена зонная диаграмма кремния р-типа с изгибом энергетических зон на границе раздела между полупроводником и диэлектриком.
Ef - энергия уровня Ферми, одинаковая в равновесном случае для полупроводника и диэлектрика. EC, ЕV - энергии, соответственно, дна зоны проводимости и потолка валентной зоны; Ei – энергия, соответствующая середине запрещенной зоны. Для расчета концентрации подвижных носителей заряда в глубине ина поверхности полупроводника вводится понятие потенциала qy, который отсчитывается от середины запрещенной зоны до уровня Ферми. Для объема полупроводника этот потенциал равен yВ
и концентрация электронов и дырок выражается через собственную концентрацию:
а концентрация дырок в объеме полупроводника:
Величина потенциала yВ определяется уровнем легирования полупроводника. Обозначим потенциал у поверхности через yS, тогда концентрации электронов и дырок у поверхности
Концентрации электронов у поверхности и в объеме полупроводника связаны между собой через разность потенциалов
Поскольку в случае представленном на рис. 1 потенциал yS находится на энергетической диаграмме ниже yВ, он больше по абсолютной величине и концентрация nS > nB, а рS < рB, то есть, приповерхностный слой обогащен электронами. Обозначим разность потенциалов US = yS - yB. Toгда в зависимости от соотношения между yS и yВ могут реализоваться следующие случаи. а). Если для полупроводника р-типа уровень yS на энергетической диаграмме лежат выше, чем yВ, то yS < yВ,US < 0,pS > pB. Это случай аккумуляции носителей заряда вблизи поверхности. Для полупроводника n-типа этот случай реализуется при US > 0, т.е. yS > yВ. б). Если yS = yВ, то энергетические зоны на поверхности не имеют изгиба и поэтому nS = nB, pS = pB, это случай "плоских зон". в). Если для полупроводника р-типа yS > yВ, то реализуется случай обеднения, когда основные носители заряда покидают приповерхностную область. г). Дальнейшее увеличение потенциала на поверхности ведет к появлению слоя неосновных носителей заряда. В случае, если ½yS½примерно в два раза больше,чем потенциал в объеме полупроводника ½yВ½, на поверхности происходит инверсия типа проводимости исходного полупроводника и образуется инверсионный слой проводимости n-типа. Подадим на МДП-структуру внешнее смещение. Так как сизменениемпотенциала в приповерхностной области изменяется пространственный заряд полупроводника, то можно ввестипонятие дифференциальной емкости полупроводника:
QS - заряд на единицу площади в приповерхностном слое полупроводника. Эта дифференциальная емкость измеряется на переменном сигнале при наличии смещения задающего режим работы. Величина емкости МДП-структуры будет представляет собой последовательно соединенные емкости слоя диэлектрика и полупроводника. Суммарная емкость
зависит от заданного режима работы и в некоторых случаях от частоты. Если рассматривать режим обеднения или аккумуляции, то заряд в приповерхностной области полупроводника создается благодаря изменению концентрации основных носителей заряда, которые следуют за изменением переменного сигнала при условии, если w - частота переменного сигнала; sП - удельная электропроводность полупроводника; τМ - максвелловское время релаксации полупроводника. Например, для кремния с sП = 0,1 (Ом.см)-1 время релаксации τМ»10-11 с и практически до частот w = 2pf = τМ-1, емкость не зависит от частоты. На этих участках от частоты не зависит и зависимость С=f(UВН), т.е. вольт-фарадная характеристика (ВФХ). В процессе образования инверсного слоя принимают участие неосновные носители заряда, поэтому изменение заряда, связанное с изменением концентрации неосновных носителей будет ограничено временем генерационно-рекомбинационного процесса, которое много больше, чем время диэлектрической релаксации. Поэтому, вид вольт-фарадной характеристики на участке, соответствующем условию инверсии будет определяться частотой измерения. При достаточно низкой частоте неосновные и основные носителя заряда будут находиться в равновесном состоянии. В этом случае на вольт-фарадной зависимости будет наблюдаться несколько участков, соответствующих различным условиям на поверхности полупроводника. В соответствии с выражением для общей емкости структуры, емкость в режимах обеднения и инверсии равна примерно емкости диэлектрического слоя. Низкочастотную зависимость емкости от приложенного смещения можно рассчитать так. Для полупроводника с определенным значением концентрации примеси значение QS в зависимости от величины потенциала на поверхности yS рассчитывается, используя уравнение Пуассона
и теорему Гаусса. В уравнении Пуассона объемный заряд определяется всеми носителями заряда присутствующими в объеме и на поверхности полупроводника
а затем и заряд на поверхности QS = - eПe0ES. (11) В уравнении (10) LDi – дебаевская длина экранирования для собственного полупроводника, Учитывая, что внешнее напряжение на затворе UЗ складывается из потенциала на поверхности yS и падения напряжения на диэлектрике QS/CД запишем
где CД - удельная емкость диэлектрика, равная Таким образом, решив уравнения (9 - 12) находим зависимость QS от внешнего смещения UЗ. Емкость полупроводника рассчитывается из уравнения (7), а общая емкость МДП-структуры из уравнения (8). Таким образом, получаем теоретическую вольт -емкостную зависимость для низкочастотного сигнала без учета разности работ выхода из полупроводника и металла и заряда поверхностных состояний QПС. Обычно теоретическая зависимость общей емкости структуры от напряжения на затворе строится в приведенных значениях СМДП/СД. Полученная характеристика представлена на рис.2. Слева от UЗ=0 (при UЗ<0) емкость области пространственного заряда полупроводника p-типа увеличивается, так как увеличивается число основных носителей заряда вблизи поверхности, то есть, полупроводник переходит в режим аккумуляции заряда на поверхности. При обеднении основными носителями заряда ем-
кость полупроводника падает. Когда прикладывается внешнее смещение, достаточное для того, чтобы произошла инверсия yS³2yВ, вблизи поверхности скапливаются неосновные носители. Такой вид характеристики имеет место только в случае, если частота сигнала достаточно мала и неосновные носители будут успевать следовать за изменением сигнала и обеспечивать вклад в общую емкость. С увеличением положительного смещения на затворе емкость растет из-за увеличения концентрации электронов и достигает значения емкости диэлектрического слоя. При увеличении частоты сигнала только основные носители будут успевать следовать за изменением смещения. Поэтому на участке обогащения (1) и обеднения (2), ВФХ для всех частот совпадают. На участке инверсии вид ВФХ зависит от соотношения между периодом сигнала Т и временем жизни неосновных носителей заряда t. На низкой частоте Т>t в режиме инверсии, при больших положительных смещениях емкость полупроводника определяется выражением (7), где QS=QП – заряд неосновных носителей, следующий за изменением переменного сигнала на затворе. На высокой частоте реализуется ситуация когда заряд QП – остается постоянным и QS = QП + QОПЗ, (13) где QОПЗ – заряд области пространственного заряда. В полупроводнике p-типа QОПЗ = qNAWОПЗ, WОПЗ – максимальная ширина ОПЗ, рассчитанная при yS=2yВ
Таким образом
Используя модель с идеальным распределением зарядов, получим
емкость полупроводника не зависит от напряжения на затворе и, поэтому, емкость структуры также постоянная. При импульсном питании, когда время импульса короче времени жизни инверсная область вообще не образуется, QП=0 и QS=qNAWОПЗ. Из рис.2 видно, что емкость уменьшается при увеличении положительного смещения за счет того, что неосновные носители не могут накапливаться вблизи поверхности и не экранируют WОПЗ. Поэтому при увеличении смещения на затворе область пространственного заряда увеличивается, а емкость области пространственного заряда уменьшается. Теоретические вольт-емкостные зависимости должны учитывать наличие разности работ выхода между металлом и полупроводником, заряд в диэлектрике и наличие поверхностных состояний на границе раздела полупроводник-диэлектрик. Разность работ выхода и заряд в диэлектрике и на поверхностных состояниях меняют заряд в приповерхностном слое полупроводника QS, поэтому при тех же напряжениях на затворе состояния приповерхностной зоны полупроводника отличаются. Эту ситуацию используют для определения заряда поверхностных состояний QПС. Дифференцируя заряд на затворе по напряжению, можно получить общую емкость структуры МДП
СS - емкость полупроводника на единицу площади; СПС – емкость, появившаяся за счет поверхностных состояний. Если заряд поверхностных состояний постоянный, общая емкость структуры Теоретическая ВФХ, рассчитана для идеальной МДП-структуры (QПС = 0, ФMS=0), при нулевом смещении в такой структуре реализуется режим плоских зон с емкостью СFB. Экспериментальная ВФХ смещена относительно идеальной на величину DUЗ. Этот сдвиг определяется отрицательной разностью работ выхода ФMS<0 и положительном суммарном зарядом в диэлектрике и на границе раздела QПС. По этим причинам в приповерхностном слое полупроводника появляются избыточные электроны, и этот слой обедняется дырками. Для реализации режима плоских зон на затвор следует подать отрицательное смещение DUЗ. Обе зависимости параллельны во всем интервале изменения емкости. Разности работ выхода между металлом и полупроводником можно найти, используя известные значения работы выходаиз металла ФМ и полупроводника ФS.
Принимая типичное значение ФAl = 4,2 эВ и сродство к электрону cSi = 4,02 эВ для кремния с концентрацией ~1016 см-3, разности работ выхода для р- типа Фmsp = -0,78, а для n-типа Фmsn = 0 В. Тогда для МДП-структуры ВФХ изображена на рис.3 при разности напряжений DUЗ = 2,5 В, QПС/СД = 1,8 В, откуда: QПС/q = 2.1011 cм-2. Аналогично для полупроводника n-типа (рис.4) параллельный сдвиг идеальной и реальной ВФХ происходит за счет положительного суммарного заряда в диэлектрике и на границе раздела QПС>0. При UЗ =0 в приповерхностной области реальной структуры скапливаются электроны и реализуется режим аккумуляции. Чтобы обеспечить режим плоских зон, на затвор подается отрицательное смещение DUЗ. При сдвиге смещения на затворе DUЗ = 1,9 В Таким образом, с помощью анализа реальных вольт-фарадных характеристик МДП-структур и сравнения их с идеальными можно определить: а) Тип проводимости полупроводника, на котором нанесен слой окисла и изготовлена МДП-структура.
б) Диэлектрическую проницаемость окисла по известной площади металлического электрода МДП-структуры и известной толщине диэлектрика. в) Концентрацию легирующей примеси в полупроводнике. г) Эффективную концентрацию поверхностных состояний на границе раздела между диэлектриком и полупроводником. д) Энергетический спектр поверхностных состояний на границе раздела. III. МЕТОДИКА ИЗМЕРЕНИЯ И ИЗМЕРИТЕЛЬНАЯ УСТАНОВКА Существуют различные методы измерения вольт-фарадных характеристик МДП-структур. Наиболее простой метод - измерение на малом высокочастотном синусоидальном тестовом сигнале. В качестве измерителя емкости применяются мостовые или резонансные измерители. В качестве измерителя в данной работе используется мост для измерения полной проводимости Л2-7. С помощью этого измерителя можно разделить активную и емкостную составляющие проводимости МДП-структуры. В приборе Л2-7 используются мостовые схемы измерения, когда в одно плечо моста включается измеряемая емкость, параллельно емкости и проводимости для установки начального баланса. Емкость и сопротивление устанавливают начальный баланс со вторым плечом моста, в который включены переменное сопротивление и емкость. В диагонали моста включен индикатор, служащий для регистрации баланса. После установления начального баланса включается измеряемая емкость, происходит нарушение баланса, который вновь устанавливается переменное емкостью и сопротивлением. Измерения проводятся на частоте тестового сигнала, который вместе с постоянным смещением подается от генератора ГКЗ-40. Емкость МДП-структуры можно измерять методом емкостно-омического делителя и подавать смещение от генератора пилообразных напряжений. Схема такой установки приведена на рис. 5. Токосъемное сопротивление в RС - делителе выбирается много меньше полного сопротивления исследуемой МДП-структуры. Если считать, что активная проводимость МДП-структуры много меньше реактивной, то напряжение сигнала, поданного на усилитель: UВХ = UГС rМ w С, UГС - напряжение тестового сигнала; w - угловая частота подаваемого тестового сигнала.
Таким образом, сигнал, подающийся на вертикальный вход регистрирующего прибора (осциллографа или самописца) пропорционален измеряемой емкости. Тестовый сигнал подается от высокочастотного генератора с амплитудой 10-25 мВ и частотой 1 МГц. Источник смещения служит для подачи смещения на испытуемую структуру и одновременно на горизонтальный вход регистрирующего прибора. Напряжение подается через резистор Rб, служащий для предотвращения попадания переменного напряжения на вход источника. Конденсатор Сб служит для предотвращения попадания постоянного сигнала на вход усилительного каскада. Полезный сигнал, пропорциональный измеряемой емкости усиливается, детектируется и через схему установки нуля подается на вертикальный вход самописца. Высокочастотный метод определения вольт-фарадных характеристик МДП-структур можно применять только для исследования режима обеднения или слабого обогащения. Режим инверсии не может быть реализован, так как неосновные носители не успевают следовать за частотой тестового сигнала. Если уменьшить частоту тестового сигнала ниже критической, то поверхностные состояния под этим воздействием успевают перезаряжаться, а это приводит к увеличению емкости всей МДП-структуры. При таких частотах МДП-структура находится в термодинамическом равновесии при изменении напряжения смещения и тестового сигнала. Этот метод называется квазистатическим методом. Принципиальная схема установки показана на рис.6. Напряжение треугольной формы подается с генератора периодических колебаний (например, Г6-15) низкой частоты (10-3 Гц ¸ 10-1 Гц) на исследуемую МДП-структуру и одновременно на вход «Х» двухкоординатного самописца. На вход «Y» этого же самописца подается сигнал от электрометра ВК-2-16. Скорость изменения сигнала от генератора настолько мала, что МДП-структура все время находится при условии теплового равновесия. Электрометром BK-2-16 измеряется ток смещения через емкость МДП-структуры, пропорциональной емкости
Условие, которое должно соблюдаться при измерении квазистатических характеристик заключается в том, что ток смещения через окисел должен быть меньше, чем ток генерации неосновных носителей при образовании инверсного слоя Ток генератора определяется шириной области пространственного заряда и временем жизни носителей, поэтому ток генерации может быть рассчитан. Исходя из его величины и емкости окисла, определяется скорость развертки самописца по оси Х. IV. ЗАДАНИЕ 1. На лазерном эллипсометре ЛЭМ-1 измерить оптические константы диэлектрической пленки y и D, по ним, согласно номограмме, определить толщину пленки диэлектрика. 2. Измерить высокочастотные вольт-фарадные характеристики тестовой МДП-структуры. 3. Построить экспериментальные вольт-фарадные характеристики в нормированных единицах СЭКС/С0 и найти величину диэлектрической проницаемости пленки eД, или его толщину. 4. Рассчитать теоретическую вольт-фарадную характеристику СТЕОР/СД и построить в тех же координатах, что и СЭКС/СД. 5. По виду экспериментальных ВФХ и сдвигу между экспериментальной к теоретической кривыми определить тип проводимости исходного полупроводника и полный заряд поверхностных состояний, рассчитав ФMS. 6. Определить минимальную емкость полупроводника СS, а из нее уровень легирования. 7. Измерить низкочастотные вольт-фарадные характеристики и найти отношение (СНЧ/СД) мин., по которым определить концентрацию поверхностных состояний NПС. 8. Все полученные экспериментальные данные заносятся в таблицы, по которым затем строятся графики. V. ПОРЯДОК ВЫПОЛНЕНИЯ РАБОТЫ И УКАЗАНИЯ ПО ТЕХНИКЕ
|


 (1)
(1) , (2)
, (2) . (3)
. (3) (4)
(4) (5)
(5) (6)
(6) (7)
(7) ,
, (8)
(8) ;
; (9)
(9) . Решив уравнение (9) относительно поверхностного потенциала, можно найти поле в приповерхностной области
. Решив уравнение (9) относительно поверхностного потенциала, можно найти поле в приповерхностной области , (10)
, (10) - табулированнная функция, определяемая потенциалом yS и x - отношением концентраций основных и неосновных носителей заряда в объеме полупроводника. Уравнение (11) используется для расчета заряда в поверхностном слое полупроводника в зависимрсти от yS.
- табулированнная функция, определяемая потенциалом yS и x - отношением концентраций основных и неосновных носителей заряда в объеме полупроводника. Уравнение (11) используется для расчета заряда в поверхностном слое полупроводника в зависимрсти от yS. (12)
(12) , eД – относительная диэлектрическая проницаемость диэлектрика, dД – его толщина.
, eД – относительная диэлектрическая проницаемость диэлектрика, dД – его толщина.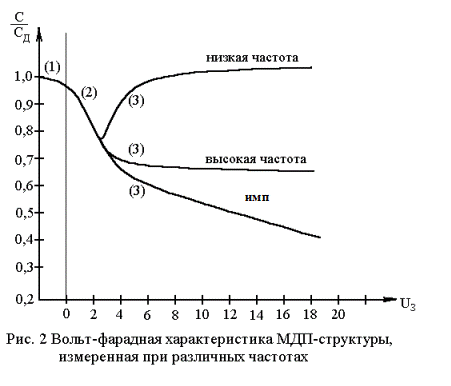
 .
. . (14)
. (14) , (15)
, (15) ,
, . На рис.3 и 4 изображены экспериментальные и теоретические зависимости для МДП структур, на основе р и n-кремния.
. На рис.3 и 4 изображены экспериментальные и теоретические зависимости для МДП структур, на основе р и n-кремния.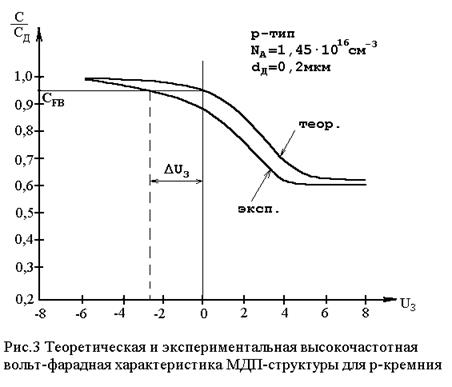
 и
и  .
.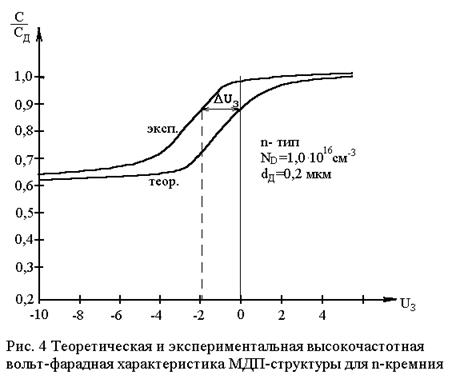

 при условии, что
при условии, что  остается постоянной. Поданные на разные входы «Х» и «Y» двухкоординатного самописца сигналы обеспечивают запись квазистатической вольт-фарадной характеристики.
остается постоянной. Поданные на разные входы «Х» и «Y» двухкоординатного самописца сигналы обеспечивают запись квазистатической вольт-фарадной характеристики.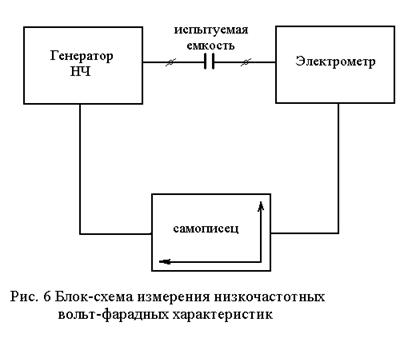
 .
.


