Межкомпонентная изоляция
В настоящее время известны несколько методов изоляции элементов ИИС: 1) обратно смещенным р-n переходом; 2) изолирующей (сапфировой) подложкой; 3) тонким диэлектрическим слоем (например, из двуокиси Si); 4) комбинацией обратно смещенного р-n перехода и диэлектрического слоя. Наиболее распространенным методом является изоляция обратно смещенным р-n переходом. Он относительно прост и дешев. Но он имеет ряд недостатков: а) барьерная емкость. Наличие паразитной емкости между элементами ИМС и подложкой уменьшает быстродействие логических элементов; б) значительные обратные токи. Чем выше температура, тем больше величина обратного тока через р-n переход. Это снижает верхний предел температурной эксплуатации ИМС. Пример: для кремниевых ИМС предел +125°С.
Вывод: для повышения быстродействия и устойчивости к воздействию температуры и -облучению применение метода обратно смещенного р-n перехода ограничено. Использование при изоляции ИМС изолирующей сапфировой подложки позволяет отказаться от изолирующих р-n переходов. В данном случае роль изоляции между отдельными элементами ИМС будет выполнять подложка. Сапфир - нелегированный Al2О3 является идеальным для подложки, так как: 1) позволяет наносить на свою поверхность эпитаксиальную пленку кремния 2) химически инертен при всех технологических процессах при изготовлении ИМС 3) При изготовлении ИМС слой эпитаксиального кремния на сапфире (d=1-2 мкм) подвергается селективному травлению и на изолирующей подложке образуется ряд изолированных друг от друга островков кремния. На полученных островках кремния обычными методами планарной технологии формируются элементы ИМС. Можно при этом формировать как транзисторы р-n-p типа, так и n-p-n типа. Недостатками метола изоляции сапфировой подложкой являются: а) большие трудности при создании обычных транзисторных структур (получение малодефектного эпитаксиального кремния на сапфире) б) процент выхода малодефектного кремния на сапфире более низок. Широкое развитие в последнее время получил метод диэлектрической изоляции, свободный от недостатков, присущих как методу изоляции с обратно смещенным р-n переходом, так и методу использующему изолирующую подложку из сапфира (рис. 4.1). Сапфир имеет такую же структуру кристаллической решетки, как и кремний. Поэтому на сапфировой пластине (подложке) можно нарастить эпитаксиальный слой кремния (рис. 4.1 а), а затем протравить этот слой насквозь до сапфира, так чтобы образовались кремниевые «островки карманы» для будущих элементов ИС (рис. 4.1 б). Эти карманы с нижней стороны изолированы друг от друга сапфиром - диэлектриком, а (с боковых сторон – воздухом). Поэтому технологию КНС часто относят к классу воздушной изоляции. Недостатком этого метода является рельефность поверхности, которая затрудняет осуществление металлической разводки.
Рисунок 4.1 Технология «кремний на сапфире» (КНС, англ. SOS - Silicon On Sapphire): а – исходная структура; б – рельефные карманы. Одним из прогрессивных направлений в методе диэлектрической изоляции является использование в качестве диэлектрика двуокиси кремния, обладающей следующими физико-химическими свойствами: e=4, эл.прочность=107В/см
Паразитная емкость=10-5 пкФ/мкм2 Все это позволяет создать ИМС с малыми токами утечки и паразитными емкостями. Процесс создания изоляции диэлектрическим (эпик-процесс) слоем осуществляется следующим образом (см. рис. 4.2): Если на 2-ом этапе (рис. 4.2 б) напылять не полупроводниковый слой (поликристаллический кремний), а диэлектрический - керамику, получается вариант керамической изоляции. Этот вариант обеспечивает лучшую гальваническую и емкостную «развязку» элементов, но он сложнее и дороже.
Рисунок 4.2 Метод диэлектрической изоляции (эпик-процесс): а - исходная структура; б - травление канавок и окисление; в - напыление поликристаллического кремния; г - конечная структура (карманы со скрытым n+ -слоем) 1) В качестве исходной подложки используется пластина кремния диаметром d=76-100 мм, вырезанная из монокристаллического слитка заданного типа проводимости и удельного сопротивления перпендикулярно направлению [111], подвергшаяся шлифовке по стандартному методу. Основным требованием к пластинам является их высокая плоскопараллельность (±1, 25 мкм) при толщине 480-560 мкм. В противном случае, на готовой матрице из-за разной толщины монокристалла пригодным к использованию окажется небольшое число участков монокристаллического кремния. 2) Для создания разделительных каналов на кремниевых пластинах выращивают пленку термического окисла толщиной d=0, 5-0, 6 мкм, которую методом обычной фотолитографии удаляют с нужных участков. Затем пластину подвергают травлению, обычно в жидком химическом травителе на основе азотной, плавиковой и уксусной кислот. Основным требованием к созданию разделительных каналов (1б) является воспроизводимость их по глубине не хуже 10% как по площади пластины, так и между пластинами. Однако применение изотропного травления для изготовления разделительных каналов на кремнии в плоскости [111] приводит к увеличению площади ИМС по сравнению с ИМС, в которой для изоляции используется обратно смещенный р-n переход, что является основным недостатком метода изоляции диэлектриком. Решение этой проблемы осуществляется использованием анизотропного травления кремния в плоскости [100], Так, при анизотропном травлении, кремния в плоскости [100] ширина изолирующей канавки составляет 10 мкм, в то время как при изотропном травлении кремния в плоскости [111] ширина изолирующей канавки составляет 50 мкм. Благодаря этому площадь ИМС уменьшается в 1, 5-3 раза. 3) Изолирующую пленку окисла на пластинах с вытравленными разделительными каналами получают либо термическим окислением, либо химическим осаждением из газовой фазы. Как выращиваемые термически, так и полученные осаждением окислы являются хорошим диэлектриком и выдерживают напряжения пробоя больше 200 В/мкм. Толщина окисной пленки обычно составляет 1, 5-2 мкм. 4) Локальные участки монокристалла в зависимости от назначения могут быть как с низкоомным скрытым слоем, так и без него. Причем скрытый слой может выполняться как путем эпитаксии, так и диффузии на исходной пластине. Толщина слоя составляет 1, 5-3 мкм для БИС. 5) Ответственной операцией является осаждение толстого слоя поликремния толщиной 200-250 мкм на слой двуокиси кремния. Для полного заполнения разделительных канавок поликристаллическим кремнием соотношение между шириной и глубиной канавки должно быть не меньше 2-2, 5 (аспектное отношение). Последней операцией является планаризация: подшлифовка опорного слоя (поликристаллический кремний) для обеспечения параллельности противолежащих сторон пластины и сошлифовка исходного монокристаллического кремния до дна, вытравленных канавок. Далее методами обычной планарной технологии на данных структурах изготовляют ИМС, Преимущества метода диэлектрической изоляции: 1) возможность работы при повышенных температурах. При комнатной температуре токи утечки в изоляции из SiO2 на 8 порядков ниже, чем токи утечки в изоляции с обратно смещенным р-n переходом, а при температуре равной 125°С - на 7 порядков ниже. Это позволяет испытывать схемы с диэлектрической изоляцией в условиях с повышенной температурой; 2) резкое снижение паразитной емкости (примерно на порядок); 3) независимость паразитных емкостей от приложенных напряжений; в приборах с обратно смещенным р-n переходом емкость является функцией напряжения. Это приводит к тому, что быстродействие логических элементов зависит от приложенного напряжения; 4) в случае воздействия g, a-излучения на ИМС с изоляцией SiO2 (двуокись) утечки обратного тока не возрастают; 5) данный метод позволяет проводить селективную диффузию золота, что дает возможность создать элементы ИМС с различным временем жизни не основных носителей заряда; 6) данный метод позволяет создать элементы со скрытым n+ слоем в области коллектора, что уменьшает толщину коллекторного слоя, а следовательно, снижает паразитные емкости. Полезным является и то, что из-за соединения коллекторного контакта с скрытым n+ слоем, уменьшается активная площадь элемента, что повышает процент выхода годных элементов в связи с уменьшением вероятности попадания р-n перехода на дислокацию; 7) данный метод изоляции позволяет получать в одном кристалле области с различными типами проводимости и различными удельными сопротивлениями; 8) применение диэлектрической изоляции приводит к значительному улучшению. Это объясняется тем, что между областью и подложкой отсутствует р-n переход, имеющий определенную паразитную емкость. На рис. 4.3 представлено сечение простейшей изопланарной транзисторной структуры. В структуре имеются скрытые n+ и р+ слои; р+ скрытый слой предотвращает образование инверсного проводящего канала на границе окисла с р-подложкой. Перед селективным окислением производится травление эпитаксиальной пленки в области изоляции на половину ее толщины. Выращенный изолирующий окисел поглощает 44% слоя кремния от толщины слоя изоляции. Маской при селективном окислении служит пленка нитрида кремния на участках поверхности, предназначенных для формирования активных и пассивных элементов ИМС. В результате локального прокисления эпитаксиальный n-слой оказывается разделенным на отдельные карманы n-типа – так же, как при методе разделительной диффузии. Однако в данном случае боковые изолирующие слои не полупроводниковые, а диэлектрические (окисные). Что касается донных частей карманов, то они по-прежнему разделены встречно-включеннымй p–n-переходами. Именно поэтому изопланар относится к комбинированным методам. Каждый карман в свою очередь разделен окислом на две части (1 и 2 на рис. 4.3 a). В главной части (1) осуществляются база и эмиттер транзистора, а во второй (2) – омический контакт коллектора (рис. 4.3 б). Обе части связаны через скрытый n+-слой. Таким образом, устраняются все четыре боковые (вертикальные) стенки коллекторного перехода, что способствует уменьшению коллекторной емкости.
Рисунок 4.3 Изопланарная технология: а - структура до базовой диффузии; б - конечная структура транзистора Локальное прокисление эпитаксиального слоя нельзя проводить через окисную маску, так как при высокой температуре и при наличии кислорода ее толщина будет расти за счет толщины n-слоя. Поэтому в изопланаре для локального прокисления используют маски из нитрида кремния. В результате селективного окисления (СО) образуется изолирующая мезообласть, в которой и формируются необходимые элементы. Окисленная структура имеет ряд недостатков: 1) изолирующий окисел на границе с мезообластью образует рельеф типа «птичий клюв»; 2) шаг размещения транзисторов значительно больше размеров мезообласти, так как он определяется величиной боковой диффузии скрытых слоев, причем емкость изолирующего перехода сильно зависит от расстояния между скрытыми n+ и р+ слоями. Рельеф изолирующего окисла типа «птичий клюв» заметно осложняет самосовмещение окон в окисле кремния над активной областью транзистора с боковой изоляцией, так как «птичий клюв» травится одновременно с легирующим окислом. Причиной образования рельефа служит тонкий слой окисла, расположенный под маской из нитрида кремния (рис. 4.4).
Рисунок 4.4 Этапы создания LOCOS-изоляции при использовании прослойки из поликристаллического кремния на боковых стенках нитридной маски: а - выращивание буферного слоя SiO2, формирование нитридной маски, анизотропное травление, кремниевой подложки (операция ионного легирования не показана); б - выращивание второго буферного слоя SiO2, осаждение пленки полукристаллического кремния; в - сквозное анизотропное травление поликристаллического кремния; г – выращивание локальных изолирующих областей SiO2; д - осаждение и оплавление слоя стекла; е - сквозное травление слоя стекла Промежуточный слой служит для снижения термомеханических напряжений между нитридной пленкой и кремниевой пластиной. В процессе селективного окисления, поэтому промежуточному слою идет диффузия кислорода, приводящая к окислению кремния под нитридной маской. Уменьшения рельефа структуры достигается специальными методами планаризации. При нанесении на поверхность пластины жидкого органического полимера силы поверхностного натяжения выравнивают поверхность пленки, уменьшая ее площадь. После затвердевания поверхность травят в ионноплазменной установке, причем скорость травления полимерной пленки выбирается равной скорости травления окисла. В процессе травления удаляется вся органическая пленка и выступающие части окисла. Планаризация поверхности не устраняет полностью «птичий клюв», поэтому разработаны методы позволяющие предотвратить его образование. На рисунке 4.5 показаны основные этапы формирования изоляции с использованием двойного слоя нитрида кремния и окисления только на изолирующей канавке. Один из недостатков рассмотренного метода состоит в появлении дефектов типа «птичья голова», что требует для их устранения проведения ряда дополнительных операций.
Рисунок 4.5 Этапы создания LOCOS-изоляции при использовании прослойки из нитрида кремнии на боковых стенках нитридной маски [196]: а - выращивание буферного слоя SiO2, осаждение из газовой фазы слоя Si3N4, осаждение из газовой фазы (Т=653 К) слоя SiO2, формирование многослойной маски (ее стенки служат вертикальными опорами дли нитридной прослойки), осаждение из газовой фазы второго слоя Si3N4; б - анизотропное травление второго слоя Si3N4 и слоя SiO2 (создание боковых прослоек из Si3N4, операция ионного легирования не показана); в - выращивание локальных изолирующих областей SiO2; г - удаление нитридной маски и буферного слоя SiO2. После вскрытия области изоляции в первом слое нитрида и плазмохимического травления эпитаксиальной пленки на поверхность накосят второй слой нитрида кремния, плазмохимическое травление которого приводит к его удалению со всей поверхности, кроме вертикальный стенок изолирующих канавок, причем кремний вскрывается только на дне канавки. Последующее селективное окисление позволяет получить практически планарную структуру. Этот метод дает возможность значительно уменьшить ширину области изоляции и шаг размещения транзисторных структур, так как мезообласти сужаются к низу. Уменьшение площади транзистора связано с ослаблением боковой диффузии скрытых слоев. Предложена структура, в которой селективное окисление кремния использовано и для ограничения диффузии скрытого n+ слоя, и для изоляции транзисторной области. Дополнительные трудности в такой технологии возникают при выращивании качественного эпитаксиального слоя над областью монокристалла и поликремния. Уменьшение площади скрытых слоев возможно при использовании внедрения ионов фосфора с большой энергией (больше 1 МэВ). В этом случае происходит самосовмещение скрытого слоя и области изоляции. Практически отсутствует боковая диффузия. Маской при ионном внедрении служит либо сам изолирующий окисный слой либо фоторезист. Наряду с вариациями селективного окисления кремния развиваются способы боковой диэлектрической изоляции элементов с заполнением вытравленных канавок различными материалами. Метод заполнения канавок имеет то преимущество, что канавки могут вытравливаться на значительную глубину, прорезая материал. При этом сокращается общее время термических операций, уменьшается площадь транзистора и емкость скрытого слоя на подложку. Основные недостатки метода: 1) трудности по обеспечению планарности структуры, 2) термическая стойкость изолирующего диэлектрика Варианты заполнения канавок отличаются материалами изоляции и способом планаризации поверхности. На рисунке 4.6 представлены этапы формирования диэлектрической изоляции с использованием окисла или ПК для заполнения канавок (осаждения SiО2). Метод изоляции V-канавками показан на рис. 4.6 а. В данном случае вместо сквозного прокисления эпитаксиального слоя используется его сквозное протравливание методом анизотропного травления. При этом поверхность кристалла должна иметь ориентацию (100), а травление идет по плоскостям (111), см. рис. 4.6 б. Размеры окна в маске делают такими, что грани (111) «сходятся» чуть ниже границы эпитаксиального слоя и образуют, канавки V-образной формы, откуда и название метода. Зависимость между шириной и глубиной канавки строго определенная:
Рисунок 4.6 Метод изоляций V-канавками (а) и U-канавками (б) Рельеф, полученный в результате травления, окисляется, как и при эпик-процессе. Однако, в отличие от эпик-процесса, последующее напыление поликристаллического кремния имеет целью лишь выровнять рельеф поверхности для облегчения металлической разводки: Для этого достаточно заполнить поликремнием только канавки. При использовании метода реактивного ионного травления можно дополнительно уменьшить ширину канавки. Такой метод изоляции получил название изоляции U-образными канавками (рис. 4.6 б). Планарность структуры достигается нанесением слоя легкоплавкого стекла (например, фосфоросиликатного), оплавлением его и плазмохимическим стравливанием стекла и окисла до нитридной маски. Известен способ заполнения изолирующих канавок поликристаллическим кремнием с последующим его окислением. С транзисторных областей поликремний удаляется обычными методами планаризации с ионным травлением.
|

 Концентрация () неосновных носителей тока может сильно измениться при воздействии g-квантов, a-излучения на полупроводник из-за смещения уровня Ферми, что снижает устойчивость изоляции обратно смещенным р-n переходом к g, a-излучению.
Концентрация () неосновных носителей тока может сильно измениться при воздействии g-квантов, a-излучения на полупроводник из-за смещения уровня Ферми, что снижает устойчивость изоляции обратно смещенным р-n переходом к g, a-излучению. имеет высокое удельное сопротивлением (=1011 Ом/см) и хорошую теплопроводность.
имеет высокое удельное сопротивлением (=1011 Ом/см) и хорошую теплопроводность.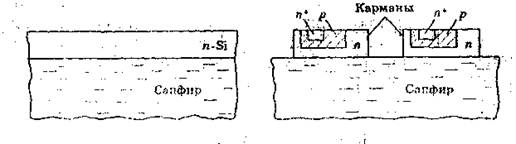
 =2, 2 г/см3, ток утечки через окисел=10-9 Ом/см2
=2, 2 г/см3, ток утечки через окисел=10-9 Ом/см2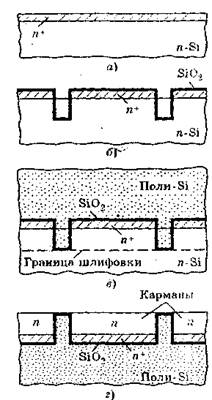

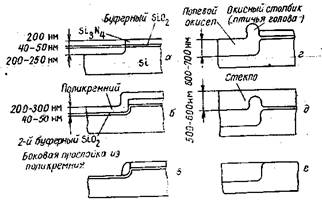
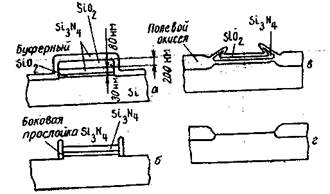
 . При глубине 4-5 мкм ширина канавки составит всего 6-7 мкм, т.е. потери площади под изоляцию получаются весьма незначительными. Недостатком метода является необходимость использования плоскости (100), которой свойственна повышенная плотность поверхностных дефектов.
. При глубине 4-5 мкм ширина канавки составит всего 6-7 мкм, т.е. потери площади под изоляцию получаются весьма незначительными. Недостатком метода является необходимость использования плоскости (100), которой свойственна повышенная плотность поверхностных дефектов.