Достижения в микроэлектроники – От Микроразмерных к Наноразмерным Устройствамраспашные
Ворота распашные. Размеры проемов ворот в наружных стенах приняты из условия пропуска средств напольного транспорта, обслуживающих технологический процесс. Размеры ворот приняты 3,6x4,2 м. Полотна ворот металлодеревянные, утепленные. Обвязка выполнена из металлических профилей. В полотнах ворот устроены калитки для пропуска людей. Снаружи здания перед воротами предусмотрен пандус с уклоном 1:10. раздвижные
Ворота раздвижные. Размеры проемов ворот в наружных стенах приняты из условия пропуска средств напольного транспорта, обслуживающих технологический процесс. Размеры ворот приняты 4,2x4,2 м. Снаружи здания перед воротами предусмотрен пандус с уклоном 1:10. Полотна ворот металлические, утепленные. В полотнах ворот устроены калитки для пропуска людей. Открывание ворот автоматическое. В зимнее время у ворот предусмотрена воздушная завеса. Створки ворот имеют каркас из стальных труб прямоугольного сечения. Каркас заполняется филенками из оргстекла, которые крепятся с помощью резиновых прокладок. Рама ворот изготовляется из стальных сварочных труб сечением 200х140х4 мм. Стойки рамы выполняются из одиночных труб, а ригель – из двух труб с наружной обшивкой из стального листа и утеплением из цементного фибролита изнутри. При установке рамы в панельные стены пространство между рамой и соседними панелями заполняется кирпичной кладкой. Снаружи здания перед воротами предусмотрен пандус с уклоном 1:10.
Достижения в микроэлектроники – От Микроразмерных к Наноразмерным Устройствам Ян Ван дер Спигэл Департамент электротехники и системотехники Университет Пенсильвании Филадельфия, Пенсильвания 9.1. ВВЕДЕНИЕ Микроэлектронные устройства быстро развиваются с точки зрения размера, стоимости и производительности. Пропорциональная миниатюризация габаритов устройства является двигателем полупроводниковой промышленности 1, позволяющим производителям последовательно выпускать поколения интегральных схем все меньших размеров и увеличивать плотность размещения транзисторов. Эта тенденция привела к характерным размерам порядка нанометра. На сегодняшний день физические длины затворов транзисторов, используемых в высокопроизводительных интегральных схемах, составляют около 50 нм, а к 2010 году и 2016 году уменьшатся до 18 и 9 нм соответственно, согласно прогнозам, сделанным в 2003 году в Международной Технологической Дорожной Карте Полупроводников (ITRS).2 Прототипы транзисторов с длиной затвора около 15 нм уже изготавливаются в научно-исследовательских лабораториях по всему миру.3,4 Очевидно, что микроэлектронная промышленность вступила в эпоху нанотехнологий и теперь производит миллионы наноразмерных транзисторов феноменально малого масштаба. Полупроводниковая промышленность дала начало одному из самых сложных производственных процессов, известных человечеству. Основными факторами повышения производительности являлись пропорциональная миниатюризация (масштабирование) транзисторов, увеличение скорости переключения устройства, и снижение стоимости функции. Чтобы оценить эту величину, необходимо отметить, что количество транзисторов, изготовленных лишь в DRAM в 2002 году, превышает количество произведённых за год зерен риса. Кроме того, за одно такое зерно риса можно купить 100 транзисторов.5 Микроэлектронные устройства будут играть ключевую роль в будущем наноэлектроники. Традиционные микроэлектронные устройства (транзисторы CMOS) переходят в наноразмерный режим и приводят к появлению очень недорогих, но чрезвычайно мощных схем и систем. Любая новая (нано) технология вынуждена будет считаться с этой мощной силой, чтобы стать её жизнеспособной альтернативой. Кроме того, схемы CMOS и микроэлектронные технологии будут использоваться в качестве основы, на которой будут строиться наноэлектронные структуры. Не является невозможным факт того, что гибрид микроэлектронных устройств/технологий и нанотехнологий даст начало мощным структурам и системам. Некоторые новые наноустройства, такие как, например, транзистор на углеродных нанотрубках, имеют ту же структуру, что и традиционные CMOS-транзисторы. Понимание функционирования и ограничений CMOS-транзисторов важно для того, чтобы понимать структуру этих новых устройств. Целью этой главы является рассмотрение основных принципов микроэлектронных устройств (CMOS). Мы обсудим структуру и функционирование CMOS-транзисторов, понятия масштабирования и его ограничений. Будут рассмотрены проблемы, связанные с наноразмерными CMOS-транзисторами. Наконец, мы рассмотрим неклассические наноразмерные CMOS-устройства и структуры.
9.2. КРАТКАЯ ИСТОРИЯ МИКРОЭЛЕКТРОННЫХ УСТРОЙСТВ И ТЕХНОЛОГИЙ Изобретение биполярного транзистора в 1947 году Дж. Бардином, В. Брэттеном, и У. Шокли в Bell Labs, было одним из основных этапов, которые сделали возможной революцию микроэлектроники. Хотя первый транзистор был сделан из германия, кремний быстро стал предпочтительным материалом, поскольку он может быть легко выращен как монокристаллический материал. Кроме того, кремний имеет слой оксида кремния высокого качества, который может быть использован как изолирующий слой (например, подзатворный слой оксида) и для целей пассивирования и маскирования, которые являются ключевыми шагами в изготовлении современной интегральной схемы. Другим прорывом стало введение планарной технологии в Fairchild Semiconductor. Эта технология все ещё является основой изготовления современных интегральных схем. Она использует маскирующие свойства SiO2 , чтобы определить области, через которые, в ходе газофазной диффузии, могут проникать примеси, как показано на рисунке 9.1. Кроме того, кремний имеет превосходство над германием благодаря своей способности образовывать стабильный оксидный слой. Следующее крупное изобретение было совершено в 1959 году, когда Дж Килби из Texas Instruments и Р. Нойс из Fairchild Semiconductor независимо друг от друга представили концепцию интегральной схемы.
Это сделало возможным изготовление множества устройств и их связь на одной пластине. Последующие усовершенствования материалов, приборов и планарной технологии позволили массовое производство миллионов транзисторов на одной микросхеме. Рисунок 9.2 изображает эволюцию технологии интегральной схемы, начиная с изобретения транзистора. Другой рубеж был достигнут после успешного изготовления полевых транзисторов со структурой металл-оксид-полупроводник (MOS). Появление идеи MOS-транзистора датируется 1927 годом, когда Лилиенфельд запатентовал полевой транзистор, но это произошло не раньше начала 60-х, поэтому не представлялось возможным преодолеть технические трудности, связанные с изготовлением MOS-транзистора.6 Одной из основных проблем было качество взаимодействия кремний-оксид и связи граничных состояний и зарядов оксида. Преимуществом MOS-транзистора над биполярным транзистором является более простая структура его устройства, меньшее количество шагов в изготовлении, отсутствие постоянного входного тока и пригодность для использования в схемах смешанного режима. Первые MOS-транзисторы были р -канальными устройствами (PMOS), в которых ток состоит из положительных носителей заряда. Введение n -канального MOS -транзистора (NMOS) было еще одним шагом вперед, так как электроны в NMOS-транзисторе двигаются быстрее, чем дырки в PMOS-транзисторе. Сочетание обоих NMOS и PMOS транзисторов на одной подложке привело к появлению комплементарной MOS или CMOS. Основным преимуществом CMOS над NMOS является то, что затворы CMOS не потребляют мощность в режиме ожидания, за исключением небольшого тока утечки (который может стать значительным в субмикронных и наноразмерных транзисторах). Передовая CMOS обеспечивает высокую производительность (скорость) при относительно малой мощности, что сделало его доминирующей технологией для изготовления больших интегральных схем с начала 80-х годов. Биполярные транзисторы в основном используются для высокоскоростных аналоговых и СВЧ приложений с низким уровнем шума. Плотность интеграции биполярных IC значительно ниже, чем у CMOS IC. Многие последующие улучшения в производстве позволили реализацию сверхмалых характерных размеров транзистора. Сокращение размеров транзисторов (масштабирование) в сочетании с увеличением размеров чипов привело к появлению еще более сложных интегральных схем.
За последние 40 лет, число транзисторов на чипе удваивалось примерно каждые 18 месяцев, как это показано на рисунке 9.3. Эта тенденция была первоначально увидена Г. Муром из Intel Corp и была названа законом Мура.7,8 Это привело нас от SSI (малой), к MSI (средней), к VLSI (большой) и ULSI (сверхбольшой) итегральным схемам. Сегодня интегральные схемы содержат до нескольких десятков миллионов транзисторов, что даёт возможность появлению сложных систем на чипе. Иной взгляд на закон Мура состоит в построении зависимости минимальных характерных размеров, используемых при изготовлении интегральных схем. Рисунок 9.4 иллюстрирует эту тенденцию в течение последних 40 лет.
Размеры сокращались на 12-14% в год. Как можно видеть, продолжение пропорционального уменьшения в этом темпе, в конечном счете, приведёт к устройствам на молекулярном и атомном уровне, которые работают на принципах, очень отличающихся от тех, что мы используем сегодня. Уменьшение размеров транзисторов, увеличение чипа и пластины, и улучшение технологического процесса позволили стоимости функции опускаться на 25-32% в год. Рисунок 9.5 иллюстрирует эту тенденцию для средней цены реализации бита памяти DRAM, которая убывала по совокупной годовой ставке 32%. Эта замечательная тенденция является важной движущей силой в полупроводниковой промышленности. На рисунке 9.6 схематически показана разбивка факторов, способствующих снижению затрат. Около 12-14% от снижения затрат стало возможным из-за уменьшения минимальных размеров, 4% из-за увеличения размера пластин, 2% является результатом увеличения объёмов производства, а остальные 7-19% из-за других инноваций в технологии и эффективности конструкции. На уменьшение характерных размеров приходится почти 50% от снижения затрат.
В то время как стоимость функции снижалась, производительность устройств экспоненциально возросла. Это можно пронаблюдать через зависимость тактовой частоты микропроцессоров, которая возрастала в среднем на 29% в год, как показано на рис. 7.
9.1. ОСНОВЫ ФИЗИКИ ПОЛУПРОВОДНИКОВ 9.3.1. Модель полупроводника и зонная структура энергетических уровней Большинство микроэлектронных устройств и схем изготовлены из кремния (Si). Приборы для специализированных применений иногда изготавливаются из германия (Ge), арсенида галлия (GaAs) и других III-V или II-VI соединений. Как видно из таблицы Менделеева на рисунке 9.8, эти атомы принадлежат либо к IV группе (элементарные полупроводники Si и Ge), или к группам III и IV (полупроводниковые соединения из Ga и As). Для атомов IV группы общим свойством является то, что они имеют 4 электрона в их внешней оболочке, в то время как атомы в колонках III и V имеют 3 и 5 электронов, соответственно. Электроны на наружной орбите являются валентными электронами и в значительной степени определяют химические и электрические свойства материала. Мы будем использовать кремний в качестве примера для рассмотрения свойств полупроводников. Кремний имеет в общей сложности 14 электронов, как схематически показано на рисунке 9.9.10,11,12 Эти электроны вращаются вокруг ядра атома. Чем ближе электроны к ядру атома, тем больше сила притяжения, и тем крепче они связаны с ядром.
Это можно удобно выразить через величину энергии каждого электрона. В противоположность макроскопическому миру, здесь разрешены только определенные уровни энергии. В 1913 году Нильс Бор предсказал, что электроны распределены по определённым орбитам или что энергия электронов квантуется. Это является результатом квантово-механических свойств, которые действуют в системах атомарных масштабов. Заметим, что на рисунке 9.9 только два электрона занимают один энергетический уровень. Это является следствием из принципа Паули, который гласит, что каждый уровень энергии может вместить только два электрона, соответствующих двум энергетическим состояниям. Внешняя оболочка (валентная оболочка) имеет 4 уровня энергии, из которых самые низкие оккупированы двумя валентными электронами каждый. Аналогичная картина справедлива и для других атомов IV группы периодической системы, так как все эти атомы имеют 4 валентных электрона. Вскоре мы выясним, что квантование энергии и принцип Паули имеют важные последствия для электронной структуры материалов.
Рассмотрим теперь кремниевый кристалл, состоящий из множества атомов кремния. Кремний может быть в форме монокристалла, поликристалла или в аморфной форме. Для изготовления полупроводниковых приборов используются монокристаллические полупроводники высокой степени чистоты, в которой каждый атом имеет точное месторасположение. Кремниевый кристалл имеет алмазную решетку, в которой каждый атом кремния имеет четырех соседей, как показано на рисунке 9.10. В этой конфигурации каждый атом кремния делит валентный электрон со своими четырьмя соседями. В результате электронного обмена, восемь разрешенных энергетических состояний в наружной оболочке атома кремния оказываются заполненными электронами. Соседние атомы образуют ковалентные связи путем обмена своих валентных электронов, что приводит к образованию стабильной структуры. При повторении конструкции, показанной на 9.10a, можно создать кристалл кремния. Это схематически проиллюстрировано на двумерной модели связей на рисунке 9.10b. В результате непосредственной близости атомов кремния, энергетические состояния атомов в кристалле будет немного отличаться от энергетических состояний одного атома. Предположим, что существуют N атомов кремния, которые дают 4N валентных электронов, так как каждый атом в кристалле даёт четыре валентных электрона. В соответствии с принципом Паули, только два электрона могут занимать один и тот же уровень энергии. Для того, чтобы разместить 4N электронов, энергетические уровни одного атома должны немного измениться так, что будет в общей сложности 4N энергетических уровней разделённых на две энергетические зоны, показанные на рисунке 9.11. Нижняя энергетическая зона содержит 2N близко расположенных энергетических уровней, и верхняя зона содержит оставшиеся 2N энергетических уровней. Поскольку существуют 4N валентных электронов, нижняя энергетическая зона сможет вместить все электроны. В результате, при температуре от 0 K, нижняя зона будет полностью заполнена, а верхняя будет пустой. Мы называем нижнюю зону валентной, а верхнюю - зоной проводимости. Разница в энергии между двумя зонами называется запрещенной зоной EG. В кремнии ширина запрещённой зоны составляет 1,12 эВ при комнатной температуре. 9.3.2. Носители заряда в полупроводниках Модель на рисунке 9.10b показывает, что все валентные электроны, используются для того, чтобы сформировать ковалентные связи между соседними атомами и в результате оказывается, что нет свободных электронов, доступных для обеспечения проводимости.
Это подтверждается диаграммой энергетических уровней на рисунке 9.11b, в которой валентная зона полностью заполнена электронами, не оставляя места для передвижения электронов. Можно сравнить случай заполненной валентной зоны с бутылкой, полностью заполненной крупинками соли. Крупинкам будет очень сложно передвигаться, даже после встряхивания, так как для движения крупинок нет пространства. Для движения электронов должны существовать некие пустые энергетические уровни, к которым они могут прыгать. Ситуация описанная выше справедлива только при температуре абсолютного нуля. При комнатной температуре некоторые электроны будут иметь достаточное количество тепловой энергии, чтобы оторваться от атома кремния. Это происходит, когда электрон перескакивает через запрещенную зону, как показано на рисунке 9.12. После того, как эти электроны оказываются в зоне проводимости, они встречают большое количество пустых энергетических состояний, которые позволяют им легко передвигаться. Чем выше температура, тем больше электронов будет пересекать запрещенную зону. Мы называем их подвижными электронами, так как они приводят к проводимости в полупроводнике. Интересно, что для каждого электрона, который переходит из валентной зоны в зону проводимости, появится пустое состояние в валентной зоне. Таким образом, электроны в валентной зоне также будут в состоянии передвигаться.
Поскольку проводимость в валентной зоне является результатом удаления электрона, который оставляет после себя положительный заряд, мы удобно называем эти носители дырками. Таким образом, проводимость в чистом полупроводнике создаётся и электронами и дырками. Так как каждый электрон, что переходит через запрещенную зону, создает дырку, концентрации подвижных электронов, n, и дырок, называемая р, равны. Мы называем эту концентрацию концентрацией собственных носителей ni. Очевидно, что ширина запрещенной зоны является важной характеристикой полупроводника и материалов в целом. Например, это позволяет нам объяснить разницу между диэлектриками, проводниками и полупроводниками. Диэлектрик представляет собой материал, валентная зона которого полностью заполнена и запрещённая зона которого настолько велика, что электроны не могут перепрыгнуть через неё. Примером является SiO2 широкая запрещённая зона которого в 8-9 эВ делает его отличным изолятором. С другой стороны, проводник представляет собой материал, чья валентная зона заполнена только частично, так что электроны могут легко переходить на пустые состояния в валентной зоне и свободно передвигаться. Полупроводник действует как изолятор при нулевой температуре и становится плохим проводником при более высокой температуре, так как запрещённая зона достаточно мала для некоторых электронов и они могут освободиться, прыгнув через запрещённую зону при комнатной температуре.
Последнее выражение будет доказано позже.
9.3.3. Собственные и примесные полупроводники Полупроводниковый материал, который мы обсуждали в предыдущем разделе, называется собственным, так как он состоит из чистого полупроводникового материала без добавления легирующих примесей. Одним из ключевых свойств полупроводников является то, что можно изменять их свойства, добавляя легирующие добавки или примеси. Добавление относительно небольшого количества легирующих примесей имеет очень сильное влияние на электрические свойства полупроводников. Эти примеси имеют на один электрон больше или меньше, чем кремнии в их внешней оболочке. Глядя на периодическую таблицу на рисунке 9,8 можно заметить, что фосфор Р находится рядом с кремнием и находится в группе V, указывая, что он имеет пять валентных электронов. Теперь можно легировать кремниевый кристалл атомами фосфора с помощью процесса, называемого ионной имплантацией или диффузии. Так как Р имеет такой же размер атома, как кремний, то относительно легко заменить некоторые из атомов кремния атомами фосфора, как показано на рисунке 9.13. Поскольку только четыре из пяти валентных электронов валентной зоны нужны для заполнения внешней оболочки вокруг атома кремния, пятый электрон атома фосфора очень слабо связан со своим ядром. На самом деле, при комнатной температуре он имеет достаточно энергии, чтобы оторваться и свободно перемещаться внутри кристалла кремния, что приводит к появлению проводимости.
В зонной модели энергии на рисунке 9.13a, уровень энергии валентного электрона, связанного с атомом фосфора, очень близок к энергии дна зоны проводимости EC. В результате, электрон перейдет в зону проводимости оставляя за собой фиксированный положительный ион фосфора.

Обычно концентрация легирующей примеси ND составляет 1015 cm-3 или выше, поэтому при комнатной температуре n При легировании кремния атомами элементов из колонки III периодической таблицы, такими как бор, можно получить кремний р-типа. Поскольку бор имеет только три валентных электрона, он будет пытаться захватить один электрон, так что атомы кремния имеют 8 электронов для заполнения его внешней оболочки. Это приводит к образованию свободной дырки, как схематически показано на рисунке 9.14.
Для типичных концентраций акцепторов используемых в полупроводниках NA > ni при комнатной температуре p

 0, и при E намного меньше, чем EF, функция F (E) 0, и при E намного меньше, чем EF, функция F (E)  1. Если предположить, что мы знаем плотность состояний N (E) в зоне проводимости и валентной зоне, мы можем использовать функцию Ферми для расчета концентрации электронов и дырок в полупроводнике. 13 Когда энергия E состояний является в несколько раз кТ больше энергии Ферми EF, функция F (E) может быть приближена, как, 1. Если предположить, что мы знаем плотность состояний N (E) в зоне проводимости и валентной зоне, мы можем использовать функцию Ферми для расчета концентрации электронов и дырок в полупроводнике. 13 Когда энергия E состояний является в несколько раз кТ больше энергии Ферми EF, функция F (E) может быть приближена, как,

где
 полупроводника может быть выражена в виде функции концентраций электронов и дырок и подвижности носителей. полупроводника может быть выражена в виде функции концентраций электронов и дырок и подвижности носителей.
где ρ – удельное сопротивление, q – заряд электрона, а Интересным аспектом является влияние упругой деформации на подвижность свободных зарядов.14 Это явление в последнее время используется для повышения производительности полевых транзисторов. Путем имплантации германия в кремний, решетка сплава
9.4. СТРУКТУРА И ФУНКЦИОНИРОВАНИЕ MOS-ТРАНЗИСТОРА Полевой транзистор металл-окисел-полупроводник (MOSFET) является основным устройством в полупроводниковой промышленности. Базовая структура концептуально проста, что и является причиной того, что подавляющее большинство интегральных схем изготовлено из MOS-транзисторов. Активным элементом MOS-транзистора является MOS-конденсатор, работа которого кратко описана в следующем разделе. 9.4.1. MOS-конденсатор Поперечное сечение MOS-конденсаторa схематично показано на рисунке 9.15a. Верхний электрод состоит из проводника, который может быть из металла, такого как алюминий или может быть легирован поликремнием или силицидом. Изолятором традиционно является SiO2, но им также может быть оксинитрид Si3N4, или материал с более высокой диэлектрической проницаемостью. Нижний электрод состоит из полупроводника. Это полупроводник, который делает MOS-конденсатор отличным от традиционного плоского конденсатора. Соответствующая диаграмма энергетических зон по всей структуре металл-оксид-кремний показана на рисунке 9.15b. На этой диаграмме энергия электрона увеличивается снизу вверх, а потенциал – сверху вниз. Обратите внимание на то, что уровень Ферми E F лежит в нижней половине запрещенной зоны для кремния р -типа.
Символ
 , ,
где
 можно найти из рисунка 9.15b и записать как, можно найти из рисунка 9.15b и записать как,
где величина Чтобы объяснить поведение MOS-конденсатора, мы будем изменять напряжение на конденсаторе

где Когда продолжает расти потенциал затвора, энергетическая диаграмма изгибается ниже. В определенный момент поверхностный потенциал

Используется знак минус в случае материала p -типа и знак плюс для n -типа, так как ионизированные акцепторы и доноры являются отрицательными и положительными соответственно. Одним из важнейших технологических параметров MOS-конденсаторов и транзисторов является пороговое напряжение

Напряжение на диэлектрике

где

9.4.2. MOS-транзистор Полевой транзистор металл-окисел-полупроводник состоит из MOS-конденсатора, как описано выше, и двух смежных диодов, так называемых стока и истока. Его структура схематично показана на рисунке 9.17. Он содержит четыре электрода: затвор, исток, сток и электрод подложки. Область под затвором называется каналом MOS-транзистора. 9.4.2.1 Длинный канал транзистора и I-V характеристики в режиме сильной инверсии. Как мы обсуждали в предыдущей главе, напряжение, приложенное к затвору MOS-конденсатора определяет количество подвижных зарядов в инверсном слое.
При использовании подложки p -типа, инверсный заряд, иначе называемый зарядом канала, будет состоять из электронов. Мы называем такой транзистор NMOS-транзистором. Аналогично, транзистор p -типа (PMOS) построен из подложки n -типа с дырками как зарядами в инверсном слое. Работу транзистора можно объяснить следующим образом. Предположим, что мы подключаем и подложку и исток к заземляющему электроду, как показано на рисунке 9.17. Когда прикладываемое напряжение затвора

Если мы теперь приложим положительный потенциал

в котором
Если мы закончим наши эксперименты и продолжим увеличивать напряжение стока, концентрация электронов в области канала больше не будет постоянной. Это можно легко понять следующим образом. Количество зарядов вблизи области истока обуславливается напряжением

Параметр m называется коэффициентом эффекта тела и может быть найден как

 . m пытаются сохранять настолько близким к 1, насколько это возможно. Характерный диапазон значений – между 1.1 и 1.5. Если мы продолжим увеличивать напряжение стока, мы достигнем точки, где заряд в канале сводится к нулю вблизи стока Заряд вдоль канала может быть найден как . m пытаются сохранять настолько близким к 1, насколько это возможно. Характерный диапазон значений – между 1.1 и 1.5. Если мы продолжим увеличивать напряжение стока, мы достигнем точки, где заряд в канале сводится к нулю вблизи стока Заряд вдоль канала может быть найден как
где напряжение

Когда длина затвора
На выражениях тока-напряжения основаны модели первого порядка, которые действуют только для длинноканальных транзисторов. Для транзисторов небольших размеров во внимание должны быть приняты другие эффекты. Модель получается немного усложнённой параметрами, которые во многих случаях основаны на подгонке измеренных характеристик транзистора. Когда мы обсуждали пороговое напряжение MOS-конденсатора мы предположили, что подложка заземлена. В случае MOS-транзистора, подложка и исток могут иметь разные потенциалы. В итоге напряжение

Пороговое напряжение

где верхний знак для NMOS, а нижний – для PMOS-транзисторов. Этот эффект называется эффектом тела или эффектом влияния подлоки. Коэффициент 9.4.2.2. Подпороговые характеристики. В приведенном выше обсуждении мы предположили, что ток стока будет током отсечки, когда напряжение на затворе меньше
При напряжении сток-исток в несколько раз большем, чем
Подпороговый наклон, как правило, принимает значение от 60 до 100 мВ/декада, в зависимости от величины
9.5. МАСШТАБИРОВАНИЕ РАЗМЕРОВ ТРАНЗИСТОРОВ С годами, размеры транзисторов сократились приблизительно от 50 мкм в начале 1960-х годов до наноразмерных размеров в современных технологиях. Основными движущими силами для уменьшения размеров были увеличение плотности микросхем на единицу площади чипа, увеличение скорости работы, а также более уменьшнеие стоимости функции. В результате, системы на чипе (SOC) стали реальностью при помощи современных технологий.17 При уменьшении размеров транзисторов нужно убедиться, что характеристики не изменяются и что надежность не станет проблемой. Это было достигнуто с помощью ряда принципов, называемых масштабированием. Масштабирование означает уменьшение горизонтальных и вертикальных размеров на одну и ту же величину. Будем считать, что коэффициент масштабирования называется α. Помимо масштабирования длины и ширины затвора, мы также должны масштабировать вертикальные размеры, такие как толщина окисла
Предположим, что напряжение масштабируется с тем же коэффициентом, что и размеры. Назовём этот процесс масштабированием с постоянным полем Согласно выражению (9.13) уровень легирования должен увеличиться в α; раз, для того, чтобы держать ширину зоны истощения постоянной, предполагая, что напряжения изменяются с тем же коэффициентом. Теперь мы можем найти, как действует масштабирование на ток, задержку распространения и потребление энергии. Ток уменьшится в α; раз по формуле (9.24). Емкость также уменьшается в α; раз. Это означает, что задержка, которая пропорциональна CV / I, будет уменьшена в α2 раз. Общая потребляемая мощность, которая пропорциональна произведению тока и напряжения, снизится с коэффициентом α2. С другой стороны, мощность на единицу площади будет оставаться постоянным. Результат масштабирования устройства приведен в таблице 9.1. Другим методом масштабирования является масштабирование с постоянным напряжением, при котором напряжение сохраняется постоянным. Преимуществом масштабирования с постоянным напряжением является уменьшение задержки, которая масштабируется квадратом коэффициента масштабирования. Основным недостатком являются большие электрические поля, которые могут привести к проблемам с надежностью устройств. На самом деле, часто применяется подход между масштабированием с постоянным напряженем и постоянным полем, называемый обобщенным масштабированием. Это делается для оптимизации скорости, рассеивания мощности и надежности устройства. Правила масштабирования для различных подходов масштабирования приведены в таблице 9.1, при условии, что транзистор не страдает от насыщения скорости и работает в режиме сильной инверсии. Тенденция масштабирования номинального размера элемента и физической длины затвора транзисторов в высокопроизводительных схемах показано на рисунке 9.4. Как видно из рисунка, масштабирование длины затвора транзистора стало более интенсивным с середины 1990-х годов, чем масштабирование функций, используемых в DRAM, указывая на то, что микропроцессоры были движущей силой технологии. Рисунок 9.19a иллюстрирует тенденции масштабирования задержки, удельной мощности и управляющего тока на единицу ширины затвора, как найденные в промышленности, так и предсказанные масштабированием с постоянным полем (пунктирными линиями).18 Задержка приблизительно подчиняется закону масштабирования с постоянным полем, но удельная мощность увеличилась значительно быстрее, в основном потому что источник питания не масштабируются с тем же коэффициентом, что и длина затвора. Кроме того, управляющий ток увеличился на большую величину, чем предсказывалось масштабированием с постоянным полем, в то время как емкость затвора снизилась более, чем прогнозировалось. Отчасти это произошло из-за того, что длина затвора масштабировалась более интенсивно, чем толщина оксида, а также в связи с субмасштабированием источника питания.
|











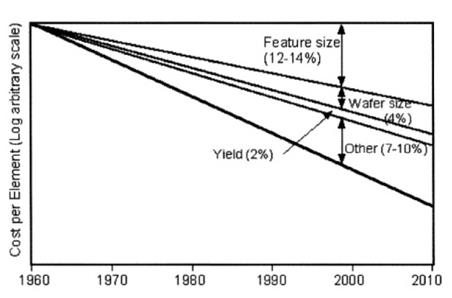


















 Каждый атом бора имеет уровень энергии EA, близкий к потолку валентной зоны EV. Это позволяет электрону легко перейти из валентной зоны на уровень акцептора, оставив после себя свободную дырку и создавая отрицательный ион B. Так как бор принимает электроны, мы называем его акцептором. При комнатной температуре, все акцепторные уровни энергии будут заполнены электронами из валентной зоны, что способствует появлению некоторого количества дырок, равного числу перешедших электронов. В результате, при комнатной температуре концентрация дырок р будет равна
Каждый атом бора имеет уровень энергии EA, близкий к потолку валентной зоны EV. Это позволяет электрону легко перейти из валентной зоны на уровень акцептора, оставив после себя свободную дырку и создавая отрицательный ион B. Так как бор принимает электроны, мы называем его акцептором. При комнатной температуре, все акцепторные уровни энергии будут заполнены электронами из валентной зоны, что способствует появлению некоторого количества дырок, равного числу перешедших электронов. В результате, при комнатной температуре концентрация дырок р будет равна





 и
и  – это эффективные плотности состояний в зоне проводимости и в валентной зоне соответственно, и
– это эффективные плотности состояний в зоне проводимости и в валентной зоне соответственно, и  – внутренний энергетический уровень, соответствующий уровню Ферми в собственном полупроводнике. Из уравнений. (9.8) и (9.9) легко доказать, что
– внутренний энергетический уровень, соответствующий уровню Ферми в собственном полупроводнике. Из уравнений. (9.8) и (9.9) легко доказать, что  будет лежать в нижней половине запрещенной зоны.
будет лежать в нижней половине запрещенной зоны.
 и
и  – подвижность электронов и дырок, соответственно. Добавляя легирующие примеси можно изменять проводимость в большом диапазоне. Это является ключевым свойством полупроводников, важным для работы полупроводниковых приборов, что будет описано в дальнейшем. Подвижность электронов, как правило, в 2-2,5 раза выше, чем подвижность дырок. Это означает, что устройства, в которых ток вызывают электроны, будут быстрее, чем устройства, в которых за протекание тока отвечают дырки. Подвижность является функцией как легирующих уровней так и температуры. Чем выше температура и концентрация легирующей примеси, тем ниже будет подвижность из-за увеличения рассеяния носителей заряда на атомах.
– подвижность электронов и дырок, соответственно. Добавляя легирующие примеси можно изменять проводимость в большом диапазоне. Это является ключевым свойством полупроводников, важным для работы полупроводниковых приборов, что будет описано в дальнейшем. Подвижность электронов, как правило, в 2-2,5 раза выше, чем подвижность дырок. Это означает, что устройства, в которых ток вызывают электроны, будут быстрее, чем устройства, в которых за протекание тока отвечают дырки. Подвижность является функцией как легирующих уровней так и температуры. Чем выше температура и концентрация легирующей примеси, тем ниже будет подвижность из-за увеличения рассеяния носителей заряда на атомах. будет расширяться в плоскости поверхности, по сравнению с решёткой чистого кристалла кремния. При выращивании тонкой монокристаллической пленки (эпитаксиального слоя) на верхней части сплава
будет расширяться в плоскости поверхности, по сравнению с решёткой чистого кристалла кремния. При выращивании тонкой монокристаллической пленки (эпитаксиального слоя) на верхней части сплава 

 иногда называют потенциалом Ферми и определяют как разность
иногда называют потенциалом Ферми и определяют как разность 
 – концентрация примеси в подложке. Для материалов p -типа,
– концентрация примеси в подложке. Для материалов p -типа,  , а для материалов n- типа,
, а для материалов n- типа,  . Потенциал ферми принимает положительное значение для кремния p -типа и отрицательное для n- типа. Для уровня легирования подложки
. Потенциал ферми принимает положительное значение для кремния p -типа и отрицательное для n- типа. Для уровня легирования подложки  , потенциал Ферми будет равен +0.41 В при комнатной температуре.
, потенциал Ферми будет равен +0.41 В при комнатной температуре.
 называется электронным сродством, которое соответствует энергии которую должны приобрести электроны на дне зоны проводимости, чтобы вырваться из кристалла. Работа выхода из металлического затвора называется
называется электронным сродством, которое соответствует энергии которую должны приобрести электроны на дне зоны проводимости, чтобы вырваться из кристалла. Работа выхода из металлического затвора называется  Для алюминиевого затвора значение работы выхода 4,1 эВ.
Для алюминиевого затвора значение работы выхода 4,1 эВ. от отрицательного значения к положительному. Отрицательное напряжение на затворе будет вызывать электрическое поле через изолятор, которое будет привлекать положительные заряды к границе раздела полупроводник – изолятор. Эти основные носители - дырки, которые будут накапливаться на поверхности. Когда создаётся небольшое положительное напряжение
от отрицательного значения к положительному. Отрицательное напряжение на затворе будет вызывать электрическое поле через изолятор, которое будет привлекать положительные заряды к границе раздела полупроводник – изолятор. Эти основные носители - дырки, которые будут накапливаться на поверхности. Когда создаётся небольшое положительное напряжение 

 это диэлектрическая константа кремния (
это диэлектрическая константа кремния ( ,
,  - это поверхностный потенциал, который определяется как изгиб энергетических зон, как показано на рисунке 9.16b, и
- это поверхностный потенциал, который определяется как изгиб энергетических зон, как показано на рисунке 9.16b, и  . Из уравнений (9.8) и (9.9) видно, что в этот момент концентрация электронов на поверхности будет равна концентрации дырок в подложке. Мы называем этот момент моментом возникновения инверсии. Соответствующее напряжение на затворе называется пороговым напряжением
. Из уравнений (9.8) и (9.9) видно, что в этот момент концентрация электронов на поверхности будет равна концентрации дырок в подложке. Мы называем этот момент моментом возникновения инверсии. Соответствующее напряжение на затворе называется пороговым напряжением  . Увеличение напряжения на затворе выше порогового напряжения приведет к быстрому увеличению концентрации электронов в инверсном слое без значительного увеличения поверхностного потенциала из-за экспоненциальной зависимости концентрации электронов от поверхностного потенциала в соответствии с формулой. (9.8). Можно предположить, что, как только инверсия была достигнута, величина поверхностного потенциала
. Увеличение напряжения на затворе выше порогового напряжения приведет к быстрому увеличению концентрации электронов в инверсном слое без значительного увеличения поверхностного потенциала из-за экспоненциальной зависимости концентрации электронов от поверхностного потенциала в соответствии с формулой. (9.8). Можно предположить, что, как только инверсия была достигнута, величина поверхностного потенциала  будет оставаться равной
будет оставаться равной 
 . Пороговое напряжение равно напряжению на затворе в момент достижения сильной инверсии. Мы можем записать напряжение на затворе
. Пороговое напряжение равно напряжению на затворе в момент достижения сильной инверсии. Мы можем записать напряжение на затворе  , используя диаграмму на рисунке 9.16b
, используя диаграмму на рисунке 9.16b является функцией заряда
является функцией заряда  в обедненном слое и заряда оксида
в обедненном слое и заряда оксида  . Причиной заряда оксида являются примеси и дефекты в диэлектрике. Будем считать, что
. Причиной заряда оксида являются примеси и дефекты в диэлектрике. Будем считать, что  равен
равен  следующим образом,
следующим образом,

 это контактная разность потенциалов между затвором и материалом подложки,
это контактная разность потенциалов между затвором и материалом подложки,  называется напряжением плоских зон. Контроль порогового напряжения будет очень важным для обеспечения правильной работы. Следует отметить, что пороговое напряжение является функцией уровня легирования через заряд в инверсном слое
называется напряжением плоских зон. Контроль порогового напряжения будет очень важным для обеспечения правильной работы. Следует отметить, что пороговое напряжение является функцией уровня легирования через заряд в инверсном слое  и, в меньшей степени, через потенциал Ферми
и, в меньшей степени, через потенциал Ферми  . Наиболее часто используемым материалом является высоколегированный поликремний n-типа и p-типа в NMOS И PMOS устройствах соответственно. Пороговое напряжение может регулироваться ионной имплантацией вблизи границы раздела кремний-оксид. Это можно смоделировать добавлением термина
. Наиболее часто используемым материалом является высоколегированный поликремний n-типа и p-типа в NMOS И PMOS устройствах соответственно. Пороговое напряжение может регулироваться ионной имплантацией вблизи границы раздела кремний-оксид. Это можно смоделировать добавлением термина  в выражение для порогового напряжение. Применение напряжения затвора
в выражение для порогового напряжение. Применение напряжения затвора 

 между затвором и электродами подложки больше, чем пороговое напряжение
между затвором и электродами подложки больше, чем пороговое напряжение  на исток, электроны под затвором будут течь в направлении положительного истока. Вместо каждого электрона, отведённого из подзатворной области, истоком будет поставляться другой. Это вызывает протекание тока от стока к истоку (электроны протекают из источника к стоку), как показано на рисунке 9.18. При малых напряжениях
на исток, электроны под затвором будут течь в направлении положительного истока. Вместо каждого электрона, отведённого из подзатворной области, истоком будет поставляться другой. Это вызывает протекание тока от стока к истоку (электроны протекают из источника к стоку), как показано на рисунке 9.18. При малых напряжениях  - это эффективная подвижность электронов на поверхности,
- это эффективная подвижность электронов на поверхности,  – ёмкость оксида на единицу площади, и
– ёмкость оксида на единицу площади, и  это отношение ширины области канала к его длине (рисунок 9.17).
это отношение ширины области канала к его длине (рисунок 9.17).

 . Так как
. Так как  , количество зарядов в канале вблизи стока, будет уменьшена по сравнению с количеством зарядов вблизи истока. Это приведет к стабилизации тока в зависимости от напряжения стока, как показано на рисунке 9.18. Предполагая последовательное приближение, мы можем получить модель протекающего тока первого порядка.13, 16 Ток в триодной области триода может быть выражен как
, количество зарядов в канале вблизи стока, будет уменьшена по сравнению с количеством зарядов вблизи истока. Это приведет к стабилизации тока в зависимости от напряжения стока, как показано на рисунке 9.18. Предполагая последовательное приближение, мы можем получить модель протекающего тока первого порядка.13, 16 Ток в триодной области триода может быть выражен как
 изменяется от
изменяется от  V на конце канала вблизи источника и
V на конце канала вблизи источника и  вблизи стока. Увеличением напряжения на стоке, инверсионный заряд вблизи стока станет равным нулю при
вблизи стока. Увеличением напряжения на стоке, инверсионный заряд вблизи стока станет равным нулю при  . Мы говорим, что канал отсечён и транзистор переходит в режим насыщения. Ток в основном становится независимым от напряжения стока в этой области, как показано на рисунке 9.18. Подставляя
. Мы говорим, что канал отсечён и транзистор переходит в режим насыщения. Ток в основном становится независимым от напряжения стока в этой области, как показано на рисунке 9.18. Подставляя  вместо
вместо  в выражение (9.21), мы находим, что ток насыщения равен
в выражение (9.21), мы находим, что ток насыщения равен сделана небольшой, влияние напряжения стока больше не будет незначительным. С увеличением напряжения стока будет увеличиваться обеднённый слой стока и это приведёт к уменьшению эффективной длины затвора. Так как ток пропорционален
сделана небольшой, влияние напряжения стока больше не будет незначительным. С увеличением напряжения стока будет увеличиваться обеднённый слой стока и это приведёт к уменьшению эффективной длины затвора. Так как ток пропорционален  , ток будет увеличиваться с
, ток будет увеличиваться с  . Выражение тока стока может быть записано как
. Выражение тока стока может быть записано как 
 между источником и подложкой, напряжение в инверсном слое во время инверсии увеличится от
между источником и подложкой, напряжение в инверсном слое во время инверсии увеличится от  . Это будет влиять на пороговое напряжение через величину заряда в инверсном слое
. Это будет влиять на пороговое напряжение через величину заряда в инверсном слое 

 связан с параметром m, определенным в формуле. (9.22). Обратите внимание, что для NMOS пороговое напряжение станет более положительным с
связан с параметром m, определенным в формуле. (9.22). Обратите внимание, что для NMOS пороговое напряжение станет более положительным с  и для PMOS, пороговое напряжение становится более отрицательным для более отрицательного
и для PMOS, пороговое напряжение становится более отрицательным для более отрицательного 
 , транзистор переходит в режим насыщения и соотношение между током и напряжением принимает вид
, транзистор переходит в режим насыщения и соотношение между током и напряжением принимает вид

 . Это важный параметр транзистора, так как он является мерой того, насколько легко закрывать транзистор. Фактор
. Это важный параметр транзистора, так как он является мерой того, насколько легко закрывать транзистор. Фактор  указывает на то, какая часть напряжения
указывает на то, какая часть напряжения  , подключенного параллельно истощённому конденсатору
, подключенного параллельно истощённому конденсатору  .
. . Для масштабирования
. Для масштабирования  можно увеличить уровень легирования подложки
можно увеличить уровень легирования подложки  и/или уменьшить напряжение.
и/или уменьшить напряжение.




