Конструктивные особенности субмикронных транзисторов LDD структуры и их влияние на эффекты короткого канала.
Наиболее распространённой конструкцией МДП-транзистора, используемой более 10 лет в полупроводниковой промышленности, является структура со слаболегированными областями стока и истока –LDD (Lightly Doped Drain) структура (рис. 21.1).
Её особенностью является наличие мелких слаболегированных областей, которые удлиняют области истока и стока в сторону канала. Концентрацию легирующей примеси в этих областях (фосфор и бор) и режим её разгонки выбирают таким образом, чтобы получить плавный n-р переход. Контакты выполняют с помощью промежуточных слоёв силицида титана или силицида кобальта. Изоляцию между электродами выполняют с помощь т.н. спейсера из нитрида кремния. В результате происходит снижение напряжённости электрического поля в канале на границе со стоком. Это уменьшает энергию горячих электронов, которые вызывают долговременную деградацию параметров транзистора. Слаболегированные LDD-области также повышают напряжение смыкания, инжекционного и лавинного пробоя транзистора, уменьшают эффект модуляции длины канала. Переход металл-полупроводник. Энергетическая диаграмма перехода при различных соотношениях работы выхода электронов. Основные отличия перехода Шоттки от н-п-перехода. Использование выпрямляющего контакта металл-полупроводник для увеличения быстродействия биполярных транзисторов ИМС. При идеальном контакте металла с полупроводником (т. е. при отсутствии каких-либо промежуточных слоев, отличающихся химическим составом, и без учета поверхностных состояний на границе раздела) происходит диффузия электронов преимущественно из материала с меньшей работой выхода электронов в материал с большей работой выхода. Под работой выхода электронов будем понимать энергию, необходимую для перевода электрона с уровня Ферми на потолок верхней свободной зоны (без удаления электрона в вакуум на бесконечное расстояние от поверхности полупроводника). В результате диффузии электронов и перераспределения зарядов нарушается электрическая нейтральность прилегающих к границе раздела областей, возникает контактное электрическое поле и контактная разность потенциалов
где Ам и Ап — соответственно работа выхода электронов из металла и из полупроводника. Переходный слой, в котором существует контактное (или диффузионное) электрическое поле и который образован в результате контакта между металлом и полупроводником, называют переходом Шотки, по имени немецкого ученого В. Шотки, который первым получил основные математические соотношения для электрических характеристик переходов. Контактное электрическое поле на переходе Шотки сосредоточено практически только в полупроводнике, так как концентрация носителей заряда в металле значительно больше концентрации носителей заряда в полупроводнике. Перераспределение электронов в металле происходит в очень тонком слое, сравнимом с межатомным расстоянием. В зависимости от типа электропроводности полупроводника и от соотношения работ выхода в полупроводнике может возникать обедненный, инверсный или обогащенный слой (рис. 2.15). Если работа выхода в металле меньше работы выхода в полупроводнике (АМ<АП), то электроны с большей вероятностью будут переходить из металла в полупроводник. Это приводит к образованию в полупроводнике обедненного слоя, если полупроводник р-типа (рис. 2.15, а), или даже инверсного слоя, если АМ<<.АП (рис. 2.15, б). Если полупроводник n-типа, то образуется обогащенный слой (рис. 2.15, в). При противоположном соотношении работ выхода (АМ>АП) в полупроводнике n-типа получается обедненный или инверсный слой, а в дырочном — обогащенный.
В обедненных слоях пространственный заряд формируется в результате нарушения компенсации заряда ионизированных примесей основными носителями, а в обогащенных — из-за накопления основных носителей заряда. Обогащенный слой обусловливает малое сопротивление приконтактной области полупроводника по сравнению с сопротивлением объема полупроводника. Поэтому такой переход не обладает выпрямляющими свойствами. При наличии обедненного или инверсного слоя переход Шотки обладает выпрямляющими свойствами, так как внешнее напряжение, падая в основном на высокоомном переходе, будет изменять высоту его потенциального барьера, изменяя условия прохождения носителей заряда через переход.
При другой полярности внешнего напряжения (при обратном напряжении) потенциальный барьер для дырок повышается (рис. 2.16, в) и их движение через переход прекращается. Для неосновных носителей заряда (для электронов в данном примере) поле в переходе оказывается ускоряющим. Поэтому, проходя через переход, неосновные носители заряда образуют обратный ток, который будет мал из-за малой концентрации неосновных носителей в полупроводнике. Если разница в работах выхода велика, то в приконтактной области полупроводника образуется инверсный слой (см. рис. 2.15, б). В этом случае при малых прямых напряжениях через такой переход будет происходить инжекция неосновных носителей заряда из инверсного слоя в прилегающий объем полупроводника. При больших прямых напряжениях инверсный слой может исчезнуть. В омических переходах, образованных в результате контакта между металлом и полупроводником, может происходить накопление неосновных носителей заряда из-за образования потенциальной ямы для неосновных носителей в приконтакной области полупроводника (рис. 2.17).
Диод Шоттки шунтирует коллекторный переход транзистора. В отличие от обычного транзистора здесь базовое контактное отверстие расширено в сторону коллекторной области n-типа. В результате алюминиевая металлизация обеспечивает контакт с p-областью базы и n-областью коллекторного слоя. Слой алюминия, расположенный на базовом слое p-типа, образует с ним омический контакт. Слой алюминия на границе с относительно высокоомной коллекторной областью обеспечивает выпрямляющий контакт – переход Шотки. Диод Шотки оказывается включенным параллельно коллекторному переходу транзистора. Известно, что скорость переключения транзисторов ИМС, работающих в ключевом режиме, ограничена временем рассасывания избыточного объемного заряда, накапливающегося в областях базы и коллектора. В обычном интегральном транзисторе в режиме насыщения при достаточно большом токе базы прямое напряжение на коллекторном n-p переходе почти равно (чуть меньше) прямому напряжению на эмиттерном n-p переходе. Поэтому, наряду с инжекцией электронов из эмиттера в базу, происходит инжекция электронов в базу из коллектора и, что особенно важно, инжекция дырок из базы в коллектор, т. е. в относительно высокоомный эпитаксиальный слой n-типа. В результате в коллекторной области накапливается избыточный заряд дырок, составляющий большую часть всего избыточного заряда. На границе со скрытым слоем n+-типа концентрация инжектированных дырок резко уменьшается из-за влияния тормозящего поля n-n+ перехода и меньшего времени жизни дырок в скрытом слое. Накопление избыточного заряда в относительно слаболегированной области коллектора приводит к появлению времени рассасывания, в течение которого при отсутствии импульса на входе транзистора на его выходе сохраняется низкий уровень сигнала. При выключении транзистора без ДШ время рассасывания в основном определяется эффективным временем жизни дырок в коллекторе. В этом случае время рассасывания составляет десятки наносекунд (для структуры, не легированной золотом). Для уменьшения этого времени в интегральных транзисторах используют транзисторы с диодом Шотки. Сравнение временных диаграмм, отражающих работу транзисторов в ключевом режиме показывает, что время рассасывания ключа на транзисторе с ДШ практически равно нулю. Уменьшение времени рассасывания в транзисторе с диодом Шотки обусловлено снижением прямого напряжения на коллекторном переходе. В результате в режиме насыщения избыточный заряд появляется практически только вследствие инжекции электронов из эмиттера в активную область базы. Время рассасывания этого заряда определяется временем пролета электронов через базу и для транзисторов с достаточно тонкой базой (менее 1 мкм) составляет не более 1 нс.
|

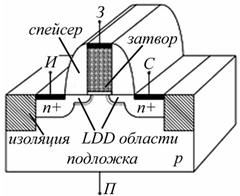

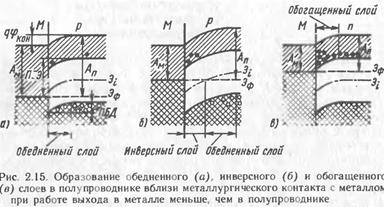

 Характерной особенностью выпрямляющего перехода Шотки в отличие от р-я-перехода является разная высота потенциальных барьеров для электронов и дырок. В результате через переход Шотки может не происходить инжекции неосновных носителей заряда в полупроводник. Рассмотрим рис. 2.16. При включении такого перехода в прямом направлении (рис. 2.16, б) высота потенциального барьера для дырок (ПБД) в приконтактной области полупроводника понижается, дырки будут переходить из полупроводника в металл. Чем больше прямое напряжение, тем больше вероятность такого перехода дырок. Однако при этом высота потенциального барьера для электронов (ПБЭ), которые могут двигаться из металла в полупроводник, остается еще относительно большой. Поэтому поток электронов из металла в полупроводник будет относительно малым, т. е. практически не будет инжекции неосновных носителей заряда в полупроводник.
Характерной особенностью выпрямляющего перехода Шотки в отличие от р-я-перехода является разная высота потенциальных барьеров для электронов и дырок. В результате через переход Шотки может не происходить инжекции неосновных носителей заряда в полупроводник. Рассмотрим рис. 2.16. При включении такого перехода в прямом направлении (рис. 2.16, б) высота потенциального барьера для дырок (ПБД) в приконтактной области полупроводника понижается, дырки будут переходить из полупроводника в металл. Чем больше прямое напряжение, тем больше вероятность такого перехода дырок. Однако при этом высота потенциального барьера для электронов (ПБЭ), которые могут двигаться из металла в полупроводник, остается еще относительно большой. Поэтому поток электронов из металла в полупроводник будет относительно малым, т. е. практически не будет инжекции неосновных носителей заряда в полупроводник.



