Травление.
Обычно травление ассоциируется с использованием специальных растворов — травителей для общего или локального удаления поверхностного слоя твердого тела на ту или иную глубину. Действительно, жидкие травители остаются главным средством для достижения указанной цели. Однако в технологии микроэлектроники появились и другие средства, выполняющие ту же задачу. Поэтому в общем случае травление можно рассматривать как не механические способы изменения рельефа поверхности твердого тела. Классический процесс химического травления состоит в химической реакции жидкого травителя с твердым телом с образованием растворимого соединения; последнее смешивается с травителем и в дальнейшем удаляется вместе с ним. Переход поверхностного слоя твердого тела в раствор означает удаление этого слоя. Однако, в отличие от механического удаления, травление обеспечивает гораздо большую прецизионность процесса: стравливание происходит плавно — один мономолекулярный слой за другим. Подбирая травитель, его концентрацию, температуру и время травления, можно весьма точно регулировать толщину удаляемого слоя. Например, при химической полировке пластины кремния), используя соответствующий травитель, можно обеспечить скорость травления 0,1 мкм/мин, т.е. за 20-30 с снять слой толщиной всего 40-50 нм. Для большей равномерности травления и удаления продуктов реакции с поверхности ванночку с раствором вращают в наклонном положении (динамическое травление) или вводят в раствор ультразвуковой вибратор (ультразвуковое травление). Конечно, травление подчиняется законам физической химии, но в реальных условиях имеется столько привходящих обстоятельств, что рецептура травителей для каждого материала подбирается не расчетным путем, а экспериментально. Характерной особенностью локального травления (через защитную маску) является так называемое подтравливание (рис.8, а) — эффект, в какой-то мере аналогичный боковой диффузии (рис.6, б). Он выражается в том, что травление идет не только вглубь пластины, но и в стороны — под маску. В результате стенки вытравленного рельефа оказываются не совсем вертикальными, а площадь углубления — несколько больше площади окна в маске. Электролитическое травление отличается тем, что химическая реакция жидкости с твердым телом и образование растворимого соединения происходят в условиях протекания тока через жидкость, причем твердое тело играет роль одного из электродов — анода. Значит, твердое тело в данном случае должно обладать достаточной электропроводностью, что, конечно, ограничивает круг используемых материалов. Преимуществом электролитического травления является возможность регулировать скорость травления путем изменения тока в цепи и прекращать процесс путем его отключения.
Так называемое ионное травление (один из специфических процессов в микроэлектронике) не связано с использованием жидкостей. Пластина кремния помещается в разреженное пространство, в котором, невдалеке от пластины, создается тлеющий разряд. Пространство тлеющего разряда заполнено квази-нейтралъной электронно-ионной плазмой. На пластину относительно плазмы подается достаточно большой отрицательный потенциал. В результате положительные ионы плазмы бомбардируют поверхность пластины, и слой за слоем выбивают атомы с поверхности, т.е. травят ее. Аналогичным способом достигается очистка поверхности от загрязнений — ионная очистка. Ионное травление, как и химическое, может быть общим и локальным. Несомненным преимуществом локального ионного травления является отсутствие «подтравливания» под маску: стенки вытравленного рельефа практически вертикальны, а площади углублений равны площади окон в маске. Общее преимущество ионного травления заключается в его универсальности (не требуется индивидуального кропотливого подбора травителей для каждого материала), а общий недостаток — в необходимости дорогостоящих установок и значительных затрат времени на создание в них нужного вакуума. За последние годы разработаны и широко используются методы так называемого анизотропного травления. Эти методы основаны на том, что скорость химической реакции, лежащей в основе классического травления, зависит от кристаллографического направления. Наименьшая скорость свойственна направлению, в котором плотность атомов на единицу площади максимальна, а наибольшая — направлению, в котором плотность атомов минимальна. Поэтому при использовании специальных анизотропных травителей скорость травления оказывается разной в разных направлениях и боковые стенки лунок приобретают определенный рельеф — огранку. Пример огранки при травлении показан на рис. 8 б. Соответственно при анизотропном травлении наружные размеры лунок могут практически совпадать с размерами окон в маске.
7. Техника масок. В технологии полупроводниковых приборов важное место занимают маски: они обеспечивают локальный характер напыления, легирования, травления, а в некоторых случаях и эпитаксии. Всякая маска содержит совокупность заранее спроектированных отверстий — окон. Изготовление таких окон есть задача литографии (гравировки). Ведущее место в технологии изготовления масок сохраняет фотолитография, которой мы уделим главное внимание. Фотолитография. В основе фотолитографии лежит использование материалов, которые называют фоторезистами. Это разновидность фотоэмульсий, известных в обычной фотографии. Фоторезисты чувствительны к ультрафиолетовому свету, поэтому их можно обрабатывать в не очень затемненном помещении. Фоторезисты бывают негативные и позитивные. Негативные фоторезисты под действием света полимеризуются и становятся устойчивыми к травителям (кислотным или щелочным).
Размеры этих отверстий (элементов рисунка) в масштабе 1:1 соответствуют размерам будущих элементов ИС, т.е. могут составлять как десятки и единицы микронов, так и доли микрона (в случае т. н. субмикронной технологии). Поскольку ИС изготавливаются групповым методом, на фотошаблоне по «строкам» и «столбцам» размещается множество однотипных рисунков. Размер каждого рисунка соответствует размеру будущего кристалла ИС. Процесс фотолитографии для получения окон в окисной маске SiO2, покрывающей поверхность кремниевой пластины, состоит в следующем (рис. 10). На окисленную поверхность пластины наносится капля фоторезиста (ФР). С помощью центрифуги каплю распределяют тонким слоем (около 1 мкм) по всей поверхности. Полученную пленку фоторезиста высушивают до затвердевания. На пластину, покрытую фоторезистом, накладывают фотошаблон ФШ (рисунком к фоторезисту) и экспонируют его в лучах кварцевой лампы (рис. 10, а). После этого фотошаблон снимают. Если используется позитивный фоторезист (см. выше), то после проявления и закрепления (которое состоит в задубливании и термообработке фоторезиста) в нем получаются окна на тех местах, которые соответствуют прозрачным участкам на фотошаблоне. Как говорят, мы перенесли рисунок с фотошаблона на фоторезист. Теперь слой фоторезиста представляет собой маску, плотно прилегающую к окисному слою (рис. 10, б). Через фоторезистную маску производится травление окисного слоя вплоть до кремния (на кремний данный травитель не действует). В результате рисунок с фторезиста переносится на окисел.
После удаления (стравливания) фоторезистной маски конечным итогом фотолитографии оказывается кремниевая пластина, покрытая окисной маской (рис. 10, в).Через окна в этой маске можно осуществлять диффузию, ионную имплантацию, травление и т.п.
Пусть с помощью предыдущей фотолитографии и диффузии в пластине выполнен р -слой шириной 30 мкм, а с помощью следующей фотолитографии и диффузии нужно внутри p -слоя получить n -слой шириною 10 мкм (показан штрихами), смещенный на 7 мкм относительно центра р -слоя. Для этого рисунок 2-го фотошаблона необходимо совместить с уже существующим рельефом (т.е. с границами p -слоя) с точностью не менее 0,1 от минимального размера изображения. При многократном использовании фотолитографии (в технологии ИС до 15—20 раз) допуск на совмещение доходит до сотых долей микрона. Техника совмещения состоит в том, что на фотошаблонах делают специальные «отметки» (например, крестики или квадраты), которые переходят в рисунок на окисле и просвечивают сквозь тонкую пленку фоторезиста. Накладывая очередной фотошаблон, аккуратнейшим образом (под микроскопом) совмещают отметки на окисле с аналогичными отметками на фотошаблоне. Рассмотренный процесс фотолитографии характерен для получения окисных масок на кремниевых пластинах с целью последующей локальной диффузии. В этом случае фоторезистная маска (рис. 11, б) является промежуточной, вспомогательной, так как она не выдерживает высокой температуры, при которой проводится диффузия. Однако в некоторых случаях, когда процесс идет при низкой температуре, фоторезистные маски могут быть основными — рабочими. Примером может служить процесс создания металлической разводки в полупроводниковых ИС. Фотошаблоны.Первым этапом процесса изготовления фотошаблонов является конструирование и вычерчивание послойной топологии фотошаблонов. Ранее, когда размеры элементов топологии составляли единицы микрон, а количество элементов на кристалле не превышало десятков тысяч, фотошаблоны вычерчивались на специальных координатографах в масштабе 100:1и 300:1. В настоящее время при субмикронных размерах элементов и их количестве на кристалле до десятков миллионов, фотошаблоны изготавливаются только с помощью компьютерных комплексов, использующих методы электронно-лучевой литографии в масштабах 1:1 и 4:1. При этом объем данных при проектировании уже в настоящее время достигает 0,5-1 Гбайт, а в перспективе 10—100Гбайт. Следующим этапом является так называемый промежуточный отсъем оригинала, т.е. его фотографирование на стеклянную фотопластинку с необходимым уменьшением размеров и, если необходимо, — мультиплицированием). Редуцирование размеров при финальном отсъеме зависит от масштаба при промежуточном отсъеме. Мультиплицирование осуществляется на специальных фотоштампах, «размножающих» изображение кристалла на всю подложку фотошаблона размером до 150x150 мм2. Фотошаблоны изготавливаются комплектами по числу операций фотолитографии в технологическом цикле. В пределах каждого комплекта фотошаблоны согласованы, т.е. обеспечивают взаимную ориентацию и совмещение с заданной точностью. Одним из слабых мест классической фотолитографии является механический контакт фотошаблона с пластиной, покрытой фоторезистом. Такой контакт никогда не может быть совершенным и сопровождается разного рода искажениями рисунка. Конкурирующим методом является проекционная фотолитография, при которой рисунок фотошаблона проектируется на пластину с помощью специальной оптической системы. Новые решения и тенденции. Описанные выше процессы до сих пор не потеряли своего значения в качестве одной из основ микроэлектронной технологии. Однако по мере повышения степени интеграции и уменьшения размеров элементов ИС возник ряд проблем, которые частично уже решены, а частично находятся в стадии изучения. Одно из принципиальных ограничений фотолитографии касается разрешающей способности, т.е. минимальных размеров в создаваемом рисунке маски. Из-за дифракции света минимальный размер изображения на кристалле (при длине волны ультрафиолетового источника засветки фотошаблона 0,5-0,2 мкм) не может быть с допустимой точностью +10% менее 1,0-0,4 мкм. Между тем уже в настоящее время при создании больших и сверхбольших ИС такие размеры элементов оказываются недостаточно малыми. Наиболее очевидный путь для повышения разрешающей способности литографии — использование при экспозиции более коротковолновых излучений, например, мягкого рентгеновского (с длинами волн 1-2 нм). Одной из наиболее трудноразрешимых проблем рентгенолитографии является создание рентгеношаблонов с масштабом М1:1 и рентгенорезистов. Другой тяжелой задачей является поиск адекватных методов совмещения шаблонов. За последние годы разработаны методы электронной литографии. Их сущность состоит в том, что сфокусированный пучок электронов сканируют (т.е. перемещают «построчно») по поверхности пластины, покрытой резистом, и управляют интенсивностью пучка в соответствии с заданной программой. В тех точках, которые должны быть «засвечены», ток пучка максимален, а в тех, которые должны быть «затемнены», — минимален или равен нулю. Диаметр пучка электронов находится в прямой зависимости от тока в пучке: чем меньше диаметр, тем меньше ток. Однако с уменьшением тока растет время экспозиции. Поэтому повышение разрешающей способности (уменьшение диаметра пучка) сопровождается увеличением длительности процесса. Одна из разновидностей электронной литографии основана на отказе от резисторных масок и предусматривает воздействие электронного пучка непосредственно на окисный слой SiO2. Оказывается, что в местах «засветки» этот слой в дальнейшем травится в несколько раз быстрее, чем в «затемненных» участках. Что касается проблемы совмещения рисунков, то ее стараются решать путем самосовмещения. Этот принцип можно охарактеризовать как использование ранее полученных структурных элементов в качестве масок для получения последующих элементов. Примерами могут служить изопланарная технология и технология МОП-транзисторов с самосовмещенным затвором. Реальный прогресс и ближайшие перспективы промышленных методов литографии показаны на рис. 12.
Если считать, что темпы развития микроэлектроники до 2010 г. не изменятся, то каждые три года, по-прежнему, минимальный размер элементов будет уменьшаться с коэффициентом 0,7. Для достижения таких разрешений, естественно, понадобятся и новые маскирующие материалы (резисты), и новые производительные установки экспонирования, и новые, интегрированные технологические процессы, отличающиеся от современных повышенными экологическими требованиями. На рис. 12. показаны наиболее вероятные методы, уже апробированные в научных лабораториях, которые могут обеспечить требуемые разрешения на пластинах кремния диаметром до 300 мм. При этом еще одной сложнейшей проблемой, решение которой предстоит найти, является поиск экономичных методов совмещения и контроля жестких допусков на совмещение. 8. Нанесение тонких пленок. Тонкие пленки не только являются основой тонкопленочных ГИС, но широко используются и в полупроводниковых интегральных схемах. Поэтому методы получения тонких пленок относятся к общим вопросам технологии микроэлектроники.
Термическое (вакуумное) напыление. Схема этого метода показана на рис. 13. Металлический или стеклянный колпак 1расположен на опорной плите 2. Между ними находится прокладка 3, обеспечивающая поддержание вакуума после откачки подколпачного пространства. Подложка 4, на которую проводится напыление, закреплена на держателе 5. К держателю примыкает нагреватель 6(напыление проводится на нагретую подложку). Испаритель 7 включает в себя нагреватель и источник напыляемого вещества. Поворотная заслонка 8 перекрывает поток паров от испарителя к подложке: напыление длится в течение времени, когда заслонка открыта. Нагреватель обычно представляет собой нить или спираль из тугоплавкого металла (вольфрам, молибден и др.), через которую пропускается достаточно большой ток. Прочность связи — сцепления пленки с подложкой или другой пленкой — называется адгезией. Некоторые распространенные материалы (например, золото) имеют плохую адгезию с типичными подложками, в том числе с кремнием. В таких случаях на подложку сначала наносят так называемый подслой, характерный хорошей адгезией, а затем на него напыляют основной материал, у которого адгезия с подслоем тоже хорошая. Например, для золота подслоем могут быть никель или титан. Для того чтобы атомы газа, летящие от испарителя к подложке, испытывали минимальное количество столкновений с атомами остаточного газа и тем самым минимальное рассеяние, в подколпачном пространстве нужно обеспечивать достаточно высокий вакуум. Критерием необходимого вакуума может служить условие, чтобы средняя длина свободного пробега атомов в несколько раз превышала расстояние между испарителем и подложкой. Однако этого условия часто недостаточно, так как любое количество остаточного газа чревато загрязнением напыляемой пленки и изменением ее свойств. Поэтому в принципе вакуум в установках термического напыления должен быть как можно более высоким. В настоящее время вакуум ниже 10-6 мм рт. ст. считается неприемлемым, а в ряде первоклассных напылительных установок он доведен до 10-11 мм рт. ст. Главными достоинствами рассмотренного метода являются его простота и возможность получения исключительно чистых пленок (при высоком вакууме). Однако у него есть и серьезные недостатки: трудность напыления тугоплавких материалов и трудность (а иногда невозможность) воспроизведения на подложке химического состава испаряемого вещества. Последнее объясняется тем, что при высокой температуре химические соединения диссоциируют, а их составляющие конденсируются на подложке раздельно. Естественно, имеется вероятность того, что новая комбинация атомов на подложке не будет соответствовать структуре исходной молекулы. Катодное напыление. Схема этого метода показана на рис. 14. Здесь большинство компонентов те же, что и на рис. 13. Однако отсутствует испаритель: его место по расположению (и по функции) занимает катод 6, который либо состоит из напыляемого вещества, либо электрически контактирует с ним. Роль анода выполняет подложка вместе с держателем.
Специфика аномального тлеющего разряда состоит в том, что в прикатодном пространстве образуется настолько сильное электрическое поле, что положительные ионы газа, ускоряемые этим полем и бомбардирующие катод, выбивают из него не только электроны (необходимые для поддержания разряда), но и нейтральные атомы. Тем самым катод постепенно разрушается. В обычных газоразрядных приборах разрушение катода недопустимо (поэтому в них используется нормальный тлеющий разряд), но в данном случае выбивание атомов из катода является полезным процессом, аналогичным испарению. Важным преимуществом катодного напыления по сравнению с термическим является то, что распыление катода не связано с высокой температурой. Соответственно отпадают трудности при напылении тугоплавких материалов и химических соединений (см. последний абзац предыдущего раздела). Однако в данном методе катод (т.е. напыляемый материал), будучи элементом газоразрядной цепи, должен обладать высокой электропроводностью. Такое требование ограничивает ассортимент напыляемых материалов. В частности, оказывается невозможным напыление диэлектриков, в том числе многих окислов и других химических соединений, распространенных в технологии полупроводниковых приборов. Это ограничение в значительной мере устраняется при использовании так называемого реактивного (или химического) катодного напыления, особенность которого состоит в добавлении к основной массе инертного газа небольшого количества активных газов, способных образовывать необходимые химические соединения с распыляемым материалом катода. Например, примешивая к аргону кислород, можно вырастить на подложке пленку окисла. Примешивая азот или моноокись углерода, можно получить нитриды или карбиды соответствующих металлов. В зависимости от парциального давления активного газа химическая реакция может происходить либо на катоде (и тогда на подложке осаждается уже готовое соединение), либо на подложке-аноде. Недостатками катодного напыления в целом являются некоторая загрязненность пленок (из-за использования сравнительно низкого вакуума), меньшая по сравнению с термическим методом скорость напыления (по той же причине), а также сложность контроля процессов.
Процесс напыления состоит в следующем. На мишень относительно плазмы (практически — относительно заземленного анода 7) подается отрицательный потенциал (2-3 кВ), достаточный для возникновения аномального тлеющего разряда и интенсивной бомбардировки мишени положительными ионами плазмы. Выбиваемые атомы мишени попадают на подложку и осаждаются на ней. Таким образом, принципиальных различий между процессами катодного и ионно-плазменного напыления нет. Различаются лишь конструкции установок: их называют соответственно двух- и трехэлектродными. Начало и конец процесса напыления определяются подачей и отключением напряжения на мишени. Если предусмотреть механическую заслонку (см. рис. 15), то ее наличие позволяет реализовать важную дополнительную возможность: если до начала напыления закрыть заслонку и подать потенциал на мишень, то будет иметь место ионная очистка мишени. При напылении диэлектрических пленок возникает затруднение, связанное с накоплением на мишени положительного заряда, препятствующего дальнейшей ионной бомбардировке. Это затруднение преодолевается путем использования так называемого высокочастотного ионно-плазменного напыления. Такая очистка полезна для повышения качества напыляемой пленки. Аналогичную очистку можно проводить на подложке, подавая на нее (до напыления пленки) отрицательный потенциал. В этом случае на мишень наряду с постоянным отрицательным напряжением подается переменное напряжение высокой частоты (около 15 МГц) с амплитудой, несколько превышающей постоянное напряжение. Тогда во время большей части периода результирующее напряжение отрицательно; при этом происходит обычный процесс распыления мишени и на ней накапливается положительный заряд Однако во время небольшой части периода результирующее напряжение положительно; при этом мишень бомбардируется электронами из плазмы, т.е. распыления не происходит, но зато компенсируется накопленный положительный заряд. Вариант реактивного (химического) ионно-плазменного напыления открывает те же возможности получения окислов, нитридов и других соединений, что и реактивное катодное напыление (см. предыдущий раздел). Преимущества собственно ионно-плазменного метода по сравнению с катодным состоят в большей скорости напыления и большей гибкости процесса (возможность ионной очистки, возможность отключения рабочей цепи без прерывания разряда и др.). Кроме того, на качестве пленок сказывается более высокий вакуум. Анодирование. Один из вариантов химического ионно-плазменного напыления называют анодированием. Этот процесс состоит в окислении поверхности металлической пленки (находящейся под положительным потенциалом) отрицательными ионами кислорода, поступающими из плазмы газового разряда. Для этого к инертному газу (как и при чисто химическом напылении) следует добавить кислород. Таким образом, анодирование осуществляется не нейтральными атомами, а ионами. Химическое напыление и анодирование, вообще говоря, проходят совместно, так как в газоразрядной плазме (если она содержит кислород) сосуществуют нейтральные атомы и ионы кислорода. Для того чтобы анодирование превалировало над чисто химическим напылением, подложку располагают «лицом» (т.е. металлической пленкой) в сторону, противоположную катоду, с тем чтобы на нее не попадали нейтральные атомы. По мере нарастания окисного слоя ток в анодной цепи падает, так как окисел является диэлектриком. Для поддержания тока нужно повышать питающее напряжение. Поскольку часть этого напряжения падает на пленке, процесс анодирования протекает в условиях большой напряженности поля в окисной пленке. В результате и в дальнейшем, при эксплуатации, она обладает повышенной электрической прочностью. К числу других преимуществ анодирования относятся большая скорость окисления (поскольку поле в пленке окисла ускоряет взаимные перемещения атомов металла и кислорода) и возможность управления процессом путем изменения тока в цепи разряда. Качество окисных пленок, получаемых методом анодирования, выше, чем при использовании других методов. Электрохимическое осаждение. Этот метод получения пленок отличается от предыдущих тем, что рабочей средой является жидкость. Однако характер процессов сходен с ионно-плазменным напылением, поскольку и плазма, и электролит представляют собой квазинейтральную смесь ионов и неионизированных молекул или атомов. А главное, осаждение происходит так же постепенно (послойно), как и напыление, т.е. обеспечивает возможность получения тонких пленок. Электрохимическое осаждение исторически развилось значительно раньше всех других рассмотренных методов — еще в XIX веке. Уже десятки лет назад оно широко использовалось в машиностроении для разного рода тонких гальванических покрытий (никелирование, хромирование и т.п.). В микроэлектронике электрохимическое осаждение не является альтернативой термическому и ионно-плазменному напылению; оно дополняет их и сочетается с ними. В основе электрохимического осаждения лежит электролиз раствора, содержащего ионы необходимых примесей. Например, если требуется осадить медь, используется раствор медного купороса, а если золото или никель — растворы соответствующих солей. Ионы металлов имеют в растворе положительный заряд. Поэтому, чтобы осадить металлическую пленку, подложку следует использовать как катод. Если подложка является диэлектриком или имеет низкую проводимость, на нее предварительно наносят тонкий металлический подслой, который и служит катодом. Подслой можно нанести методом термического или ионно-плазменного напыления. Чтобы осуществить электрохимическое анодирование, окисляемую пленку металла следует использовать как анод, а электролит должен содержать ионы кислорода. Большое преимущество электрохимического осаждения перед напылением состоит в гораздо большей скорости процесса, которая к тому же легко регулируется изменением тока. Поэтому основная область применения электролиза в микроэлектронике — это получение сравнительно толстых пленок (10—20 мкм и более). Качество (структура) таких пленок хуже, чем при напылении, но для ряда применений они оказываются вполне приемлемыми. 9. Металлизация. В полупроводниковых ИС процесс металлизации призван обеспечить омические контакты со слоями полупроводника, а также рисунок межсоединений и контактных площадок. Основным материалом для металлизации служит алюминий. Он оказался оптимальным в силу следующих положительных качеств: малое удельное сопротивление (1,7-10-6 Ом-см); хорошая адгезия к окислу SiO2 (металлизация осуществляется по окислу); возможность сварных контактов с алюминиевой и золотой проволокой (при осуществлении внешних выводов); отсутствие коррозии; низкая стоимость и др.
После вытравливания алюминия с незащищенных участков и удаления фоторезиста остается запланированная металлическая разводка (на рис. 16 ее рельеф, прилегающий к контактам 1, 2, 3, заштрихован). Минимальная ширина полосок в современных ИС соответствует предельному разрешению литографии. Естественно, что для достижения необходимых допусков на ширину металлизации ее толщина, как правило, не может быть более 1/10 от минимальной ширины проводника. Расстояние между соседними проводниками — с целью ослабления паразитной емкостной связи между ними — выбирают более 1,5 мкм. Для проводника шириной 1 мкм, его толщина 0,1 мкм, а расстояние между ближайшими проводниками более 1,5 мкм. Погонное сопротивление полоски шириной 10 мкм и толщиной 1 мкм составляет около 2 Ом/мм. Для контактных площадок, к которым в дальнейшем присоединяются внешние выводы, типичны размеры 100x100 мкм. Присоединение внешних выводов непосредственно к полоскам металлизации невозможно из-за малой ширины. Разумеется, рисунок межсоединений предполагает отсутствие пересечений, т.е. коротких замыканий. Однако в ИС с высокой степенью интеграции не удается спроектировать металлическую разводку так, чтобы избежать пересечений. В этих случаях используется многослойная или многоуровневая разводка, т.е. несколько «этажей» металлизации, разделенных изолирующими слоями. Необходимые соединения между разными уровнями осуществляются через специальные окна в изолирующих слоях (рис. 17, а). Изоляцию между слоями обычно обеспечивают путем напыления диэлектрика по завершении очередной металлической разводки. В качестве диэлектрика чаще всего используют моноокись кремния SiO. Количество «этажей» при многоуровневой металлизации для современных БИС лежит в пределах от двух до четырех. Некоторые предприятия для создания многоуровневой разводки используют алюмоксидную технологию. В этой технологии роль изоляции между соседними проводниками выполняют слои «пористого» А12О3, а роль межслойной изоляции толщиной порядка 0,1 мкм играют слои «плотного» окисла, образуемого в результате анодирования первичного слоя Аl (рис. 17, б). Отличительной особенностью этой технологии является планарность многоуровневой разводки.
Проблема омических контактов при использовании алюминия состоит в следующем. Если пленку алюминия просто напылить на поверхность кремния, то образуются барьеры Шоттки, причем барьер на границе с n -слоем является не омическим, а выпрямляющим. Чтобы избежать барьеров Шоттки, алюминий вжигают в кремний при температуре около 600 °С, близкой к температуре эвтектики сплава А1—Si. При такой температуре на границе алюминиевой пленки с кремнием образуется слой, в котором растворен практически весь прилегающий алюминий. После застывания сплав представляет собой кремний, легированный алюминием; концентрация последнего составляет около 5-Ю-18 см-3. Поскольку алюминий является акцептором по отношению к кремнию, возникает новая проблема: предотвращение образования p-n -переходов в n -слоях. Действительно, если концентрация доноров в n -слоев меньше 5*1018 см-3, то атомы алюминия создадут в нем приповерхностный р -слой.Чтобы этого избежать, область n -слоя вблизи контакта специально легируют, превращая ее в n+ -слой с концентрацией доноров 1020 см-3 и более (см. рис. 16). Тогда концентрация алюминия оказывается недостаточной для образования р -слоя, и p-n -переход не образуется. Если n -слой с самого начала сильно легирован (например, эмиттерный слой транзистора), то дополнительного легирования не требуется. Не возникает проблем и при контакте алюминия с р -слоями, так как растворение в них алюминия приводит к образованию приповерхностных p +-слоев, что способствует повышению качества омического контакта. 10. Сборочные операции После того как все основные технологические этапы (включая металлизацию) закончены, пластина кремния, содержащая сотни и тысячи ИС, поступает на операции тестового контроля электрических параметров. На этом этапе отбраковываются и специальным лаком маркируются все ИС, параметры которых не соответствуют требуемым значениям. Трудоемкость всех контрольных операций (на всех этапах производства ИС) достигает до 30% себестоимости работ по созданию схем. После маркировки отбракованных ИС пластина кремния разделяется на отдельные кристаллы. Разделение осуществляется методом скрайбирования, т.е., по сути, процарапыванием вертикальных и горизонтальных рисок в промежутках между соседними чипами. Процарапывание осуществляют либо с помощью алмазного резца (наподобие того, как это делает стекольщик, разрезая стекло), либо с помощью лазерного луча.
Непродолжительного удержания расплющенной проволочки на площадке достаточно для образования их прочного соединения с малым переходным сопротивлением.- Соединения осуществляются с помощью тонких (15-30 мкм) алюминиевых или золотых проволочек, которые одним концом закрепляются на контактных площадках, а другим на торцах штырьков. Надежный электрический контакт между металлическими деталями (в данном случае контакт проволочек со штырьками и контактными площадками) может быть обеспечен разными методами. Наибольшее распространение в настоящее время имеет метод термокомпрессии, т.е. сочетание достаточного давления (прижатия деталей друг к другу) с повышенной температурой (200-300 °С), способствующей взаимной диффузии атомов из одной детали в другую. Термокомпрессия, в свою очередь, реализуется в виде разных конструктивных вариантов. На рис. 19. показан простейший пример. С помощью клинообразного пуансона, изготовленного из твердого материала (например из алмаза), проволочка прижимается к поверхности контактной площадки
По окончании монтажа кристалла на ножке следует корпусирование, т.е. окончательное внешнее оформление транзистора. Ножка корпуса соединяется с крышкой (рис. 9.1) путем горячей или холодной сварки (последняя по существу близка к термокомпресии). Корпусирование предполагает также защиту кристалла от влияния внешней среды, поэтому его проводят либо в вакууме, либо в среде инертного газа (азот, аргон).
11. Технология тонкопленочных гибридных ИС Согласно определению, гибридные ИС представляют собой совокупность пленочных пассивных элементов и навесных активных компонентов. Поэтому технологию тонкопленочных ГИС можно разбить на технологию тонкопленочных пассивных элементов и технологию монтажа активных компонентов. Изготовление пассивных элементов. Тонкопленочные элементы ГИС осуществляются с помощью локального (через маски) термического, катодного или ионно-плазменного напыления того или иного материала на диэлектрическую подложку. В качестве масок длительное время использовались накладные металлические трафареты. Такие трафареты представляли собой тонкую биметаллическую фольгу с отверстиями-окнами. Основу трафарета составлял слой электрохимически нанесенного никеля толщиной 10-20 мкм. Последний определял размеры окон, т.е. рисунок трафарета, а слой бериллиевой бронзы выполнял роль несущей конструкции. Серьезные недостатки металлических накладных трафаретов заключаются в том, что, во-первых, в процессе напыления пленок происходит напыление на сами трафареты, что меняет их толщину и постепенно приводит их в негодность. Во-вторых, металлические трафареты мало пригодны при катодном и ионно-плазменном напылении, так как металл искажает электрическое поле и, следовательно, влияет на скорость напыления. Поэтому в последние годы от металлических накладных трафаретов практически отказались и используют для получения необходимого рисунка фотолитографию — метод, заимствованный из технологии полупроводниковых ИС. Фотолитографию осуществляют следующим образом. На подложку наносят сплошные пленки необходимых материалов, например, резистивный слой и поверх него — проводящий слой. Затем поверхность покрывают фоторезистом и с помощью соответствующего фотошаблона создают в нем рисунок для проводящего слоя (например, для контактных площадок будущего резистора, рис. 21, а).
В результате на пока еще сплошной поверхности резистивного слоя получаются готовые контактные площадки (рис. 21, б). Снова наносят фоторезист и с помощью другого фотошаблона создают рисунок полоски резистора (рис. 21, в). Затем проводят травление, удаляют фоторезист и получают готовую конфигурацию резистора с контактными площадками (рис. 21, г). Конечно, важно, чтобы травитель, действующий на проводящий слой, не действовал на резистивный и наоборот. Имеется и еще ряд ограничений, которых мы не будем касаться. Заметим лишь, что с помощью фотолитографии не удается получать многослойные структуры типа конденсаторов. Однако это ограничение не очень существенно, так как в последнее время предпочитают использовать в ГИС навесные конденсаторы (ради экономии площади). Для резистивных пленок чаще всего используют хром, нихром (Ni — 80%, Сг — 20%) и кермет из смеси хрома и моноокиси кремния (1:1). Метод напыления для этих материалов — термический (вакуумный). Омические контакты к резистивным пленкам (полоскам) осуществляются так, как показано на рис. 21. Для обкладок конденсаторов используют алюминий, причем до напыления нижней обкладки (прилегающей к подложке) приходится предварительно напылять тонкий подслой из сплава CrTi, так как адгезия алюминия непосредственно с подложкой оказывается недостаточной. Для диэлектрических слоев пленочных конденсаторов по совокупности требований (большая диэлектрическая проницаемость s, малый тангенс угла потерь tgδ, большая пробивная напряженность и др.) наибольшее распространение имеют моноокись кремния SiO и моноокись германия GeO. Особое место среди диэлектриков занимают окислы Та2О5 и А12О3, которые получают не методом напыления, а методом анодирования нижних металлических обкладок (Та или А1). Для проводниковых пленок и омических контактов используют, как правило, либо золото с подслоем CrTi, либо медь с подслоем ванадия (назначение подслоев — улучшить адгезию с подложкой). Толщина проводящих пленок и контактных площадок обычно составляет 0,5—1 мкм. Размеры контактных площадок от 100x100 мкм и более. Толщина наносимых пленок контролируется в процессе напыления. Для этого используются несколько методов. Один из них, пригодный только в случае резистивных пленок, состоит в использовании так называемого свидетеля. Свидетель представляет собой вспомогательный (не входящий в структуру ГИС) слой, напыляемый одновременно с рабочими слоями, но расположенный на периферии подложки и снабженный двумя заранее предусмотренными внешними выводами. Через эти выводы осуществляется контроль сопротивления свидетеля в процессе напыления. Геометрия свидетеля известна. Поэтому, когда его сопротивление достигает значения, соответствующего необходимой толщине, напыление прекращают (перекрывают заслонку). Толщина рабочих слоев будет такой же, как у свидетеля, так как они напылялись в одинаковых условиях. Другой способ контроля состоит в использовании в качестве свидетеля тонкой кварцевой пластины, которая через внешние выводы присоединена к колебательному контуру генератора колебаний. Как известно, кварцевая пластина обладает свойствами колебательного контура, причем резонансная частота однозначно связана с толщиной пластины. В процессе напыления толщина пластины меняется и меняется частота генератора. Изменения частоты легко измерить и остановить процесс напыления в нужный момент. Подложки тонкопленочных ГИС должны прежде всего обладать хорошими изолирующими свойствами. Кроме того, желательны малая диэлектрическая проницаемость, высокая теплопроводность, достаточная механическая прочность. Температурный коэффициент расширения должен быть близким к температурным коэффициентам расширения используемых пленок. В настоящее время наибольшее распространение в качестве подложек имеют ситалл и керамика. Ситалл представляет собой кристаллическую разновидность стекла (обычное стекло аморфно), а керамика — смесь окислов в стекловидной и кристаллической фазах (главные составляющие А12О3 и SiO2). Толщина подложек составляет 0,5-1 мм в зависимости от площади. Площадь подложек у ГИС иногда больше площади кристаллов у полупроводниковых ИС. Стандартные размеры подложек лежат в пределах от 12x10 до 96x120 мм. Требования к гладкости поверхности примерно такие же, как и в случае кремния: допустимая шероховатость не превышает 25x50 нм (класс шероховатости 12-14). Обычно ГИС, как и полупроводниковые ИС, изготавливаются групповым методом на ситалловых или иных пластинах большой площади. По завершении основных технологических операций, связанных с получением пленочных пассивных элементов и металлической разводки, проводится выходной тестовый контроль и, если необходимо, подгонка параметров пассивных элементов. Только после контроля пластины скрайбируются и снабжаются навесными компонентами. ГИС могут, как и ИС, помещаться в корпусе или (в бескорпусном исполнении) герметизироваться в составе аппаратуры. Монтаж навесных компонентов. В качестве навесных компонентов используются бескорпусные диоды, транзисторы, резистивные и конденсаторные сборки, а также бескорпусные ИС и БИС. Рассмотрим пример активных компонентов. Главная трудность состоит в совмещении шариков со столбиками. Простейшим вариантом бескорпусного транзистора является кристалл, полученный после скрайбирования, к трем контактным площадкам которого присоединены тонкие прово Имеется два других варианта бескорпусных транзисторов, монтаж которых осуществляется иначе. Первый вариант называется транзистором с шариковыми выводами (рис. 22, а). Шарики диаметром 50-100 мкм связаны с контактными площадками транзистора, а через них — с тем или иным слоем кремния: эмиттерным, базовым или коллекторным. Материалом для шариков служит золото, медь или сплав Sn-Sb. Из того же материала на диэлектрической подложке пленочной ГИС делаются контактные столбики высотой 10-15 мкм и диаметром 150-200 мкм, расположенные в точном соответствии с расположением шариков на кристалле кремния (рис. 22, б). Соединение шариков со столбиками осуществляется методом перевернутого монтажа (англ. термин flip-chip): кристалл транзистора переворачивается «вверх ногами», т.е. шариками вниз, и накладывается шариками на столбики подложки (рис. 22, в). Сочетая давление на кристалл с повышением температуры (т.е. в сущности используя термокомпрессию), обеспечивают прочное соединение шариков со столбиками. Как видим, метод перевернутого монтажа существенно экономит площадь подложки ГИС и время, необходимое на разводку иками, поскольку кристалл при наложении перевернут «вверх ногами» и закрывает от оператора места соединения. Трудность совмещения контактных площадок кристалла и подложки облегчается при использовании второго варианта бескорпусных транзисторов — транзистора с балочными выводами (рис. 23, а). Здесь контактные площадки продлены за пределы кристалла и нависают над его краями на 100-150 мкм, откуда и название — балки. Толщина балок (10-15 мкм) значительно больше толщины металлической разводки на кристалле. Поэтому их получают не напылением, а электрохимическим осаждением золота (с подслоем из титана). Длина балочных выводов 200—250 мкм (включая выступ), а ширина такая же, как у обычных контактных площадок (50-200 мкм).
Чтобы сократить время травления и избежать бокового растравливания пластины, ее (после приклеивания к стеклу) сошлифовывают от обычной толщины 200—300 мкм до 50 мкм. По окончании травления клей растворяют и разделенные кристаллы отпадают от стекла. Монтаж навесных компонентов с балочными выводами может осуществляться так же, как и в случае шариковых выводов — методом перевернутого монтажа. При этом выступающие балки хорошо видны и их совмещение с контактными площадками на подложке не представляет затруднений. Можно монтировать кристалл и «лицом вверх», но тогда в подложке следует предусмотреть углубление для кристалла. Изготовление шариковых и балочных выводов сложнее и дороже, чем проволочных, но они обеспечивают существенное упрощение и удешевление сборочных операций и в 4-10 раз позволяют уменьшить площадь на подложке ГИС, отводимую для размещения навесных компонентов. К сожалению, надежность таких соединений ниже, чем в случае использования гибких выводов.
12. Технология толстопленочных гибридных ИС Пассивные элементы толстопленочных ГИС получаются локальным нанесением на подложку полужидких паст-стекло-эмалей с последующим их высушиванием и вжиганием в подложку. Следовательно, в данном случае пленки приобретают свою толщину сразу, а не постепенно — слой за слоем — как при тонкопленочной технологии. Последовательность технологических операций при нанесении толстых пленок следующая: а) нанесение слоя пасты на подложку через маску — накладной трафарет (отсюда название — метод трафаретной печати); б) выжигание (испарение) растворителя при температуре 300-400 °С и тем самым превращение пасты из полужидкого состояния в твердое; в) вжигание затвердевшего вещества пасты в подложку — спекание — при температуре 500-700 °С (в зависимости от состава пасты). Операция вжигания — самая ответственная в технологическом цикле; она требует высокой стабилизации температуры: с точностью ±1 °С. В основе всех паст-стеклоэмалей лежит так называемая фритта — тончайший порошок стекла, к которому, в зависимости от назначения пасты, примешивается порошок резистивного, проводящего или диэлектрического материала. Дисперсная (т.е. совершенно однородная) смесь фритты и примесного материала приобретает вязкость при добавлении специальных органических веществ и растворителей. На этапе выжигания (см. выше) растворитель испаряется, а органические вещества связывают частицы порошка в единую компактную массу. Для проводящих паст примесью обычно служит серебро или золото, для резистивных — смесь серебра и палладия (1:1), а для диэлектрических — титанат бария с высокой диэлектрической проницаемостью. Варьируя материал и процентное содержание примесей, можно изменять электрические параметры пленок в очень широких пределах.
Рамка с трафаретом заполняется пастой и размещается над подложкой на расстоянии 0,5—1 мм. После этого на сетку опускается специальный нож — ракель, который, перемещаясь вдоль рамки, продавливает пасту через отверстия в сетке (рис. 23, б). Несмотря на простоту идеи продавливания, эта операция — прецизионная; на качество будущей пленки и повторяемость результатов оказывают влияние угол заточки ракеля, его наклон относительно подложки, скорость перемещения и другие факторы. Вообще говоря, сетка на трафарете не обязательна: можно продавливать пасту и через сплошные отверстия. Однако качество пленок при этом хуже, так как сетка обеспечивает более однородные слои в результате слияния отдельных «капель», прошедших через ячейки сетки. Толщина получаемых пленок зависит от диаметра нитей и размеров ячеек. Обычно она составляет 20-40 мкм. К подложкам для толстопленочных ГИС предъявляются в общем те же требования, что и для тонкопленочных. Особое внимание часто уделяется повышенной теплопроводности, так как толстопленочный вариант ГИС характерен для мощных схем. Поэтому распространены высокоглиноземистые керамики (96% А12О3) и бериллиевые керамики (99,5% ВеО); последние в 7-10 Раз превышают глиноземистые по теплопроводности, но уступают им по прочности. Важная отличительная особенность подложек для толстопленочных ГИС состоит в том, что их поверхность должна быть достаточно шероховатой, чтобы обеспечить Необходимую адгезию с веществом пасты. Степень шероховатости характеризуется неровностями до 1-2 мкм.
13. Дополнительная литература
|

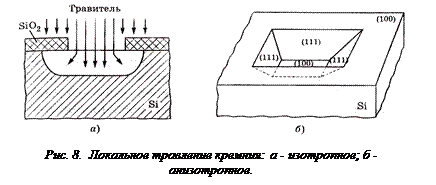
 Значит, после локальной засветки будут вытравливаться незасвеченные участки (как в обычном фотонегативе). В позитивных фоторезистах свет, наоборот, разрушает полимерные цепочки и, значит, будут вытравливаться засвеченные участки. Рисунок будущей маски изготавливается в виде так называемого фотошаблона (рис. 9). Фотошаблон представляет собой толстую стеклянную пластину, на одной из сторон которой нанесена тонкая непрозрачная пленка с необходимым рисунком в виде прозрачных отверстий.
Значит, после локальной засветки будут вытравливаться незасвеченные участки (как в обычном фотонегативе). В позитивных фоторезистах свет, наоборот, разрушает полимерные цепочки и, значит, будут вытравливаться засвеченные участки. Рисунок будущей маски изготавливается в виде так называемого фотошаблона (рис. 9). Фотошаблон представляет собой толстую стеклянную пластину, на одной из сторон которой нанесена тонкая непрозрачная пленка с необходимым рисунком в виде прозрачных отверстий.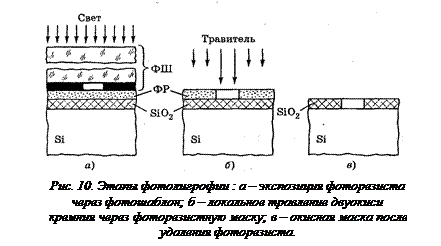
 В технологических циклах изготовления диодов, транзисторов и тем более ИС процесс фотолитографии используется многократно (отдельно для получения базовых слоев, эмиттеров, омических контактов и т.д.). При этом возникает так называемая проблема совмещения фотошаблонов. Суть этой проблемы иллюстрируется на рис. 11.
В технологических циклах изготовления диодов, транзисторов и тем более ИС процесс фотолитографии используется многократно (отдельно для получения базовых слоев, эмиттеров, омических контактов и т.д.). При этом возникает так называемая проблема совмещения фотошаблонов. Суть этой проблемы иллюстрируется на рис. 11.
 Существуют три основных метода нанесения тонких пленок на подложку и друг на друга: термическое (вакуумное) напыление, ионно-плазменное напыление и электрохимическое осаждение. Ионно-плазменное напыление имеет две разновидности: катодное напыление и собственно ионно-плазменное.
Существуют три основных метода нанесения тонких пленок на подложку и друг на друга: термическое (вакуумное) напыление, ионно-плазменное напыление и электрохимическое осаждение. Ионно-плазменное напыление имеет две разновидности: катодное напыление и собственно ионно-плазменное.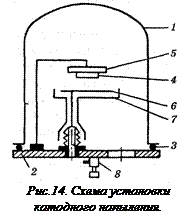 Подколпачное пространство сначала откачивают до 10-5-10-6 мм рт. ст., а затем в него через штуцер 8 вводят некоторое количество очищенного нейтрального газа (чаще всего аргона), так что создается давление 10-1-10-2 мм рт. ст. При подаче высокого (2-3 кВ) напряжения на катод (анод заземлен из соображений электробезопасности) в пространстве анод-катод возникает аномальный тлеющий разряд, сопровождающийся образованием квазинейтральной электронно-ионной плазмы.
Подколпачное пространство сначала откачивают до 10-5-10-6 мм рт. ст., а затем в него через штуцер 8 вводят некоторое количество очищенного нейтрального газа (чаще всего аргона), так что создается давление 10-1-10-2 мм рт. ст. При подаче высокого (2-3 кВ) напряжения на катод (анод заземлен из соображений электробезопасности) в пространстве анод-катод возникает аномальный тлеющий разряд, сопровождающийся образованием квазинейтральной электронно-ионной плазмы. Ионно-плазменное напыление. Схема этого метода показана на рис. 15. Главная его особенность по сравнению с методом катодного напыления состоит в том, что в промежутке между электродом 9 — мишенью (с нанесенным не нее напыляемым материалом) и подложкой 4 действует независимый, «дежурный» газовый разряд. Разряд имеет место между электродами 6 и 7, причем тип разряда — несамостоятельный дуговой. Для этого типа разряда характерны: наличие специального источника электронов в виде накаливаемого катода (6), низкие рабочие напряжения (десятки вольт) и большая плотность электонно-ионной плазмы. Подколпачное пространство, как и при катодном напылении, заполнено нейтральным газом, но при более низком давлении (10-3-10-4 мм рт. ст.).
Ионно-плазменное напыление. Схема этого метода показана на рис. 15. Главная его особенность по сравнению с методом катодного напыления состоит в том, что в промежутке между электродом 9 — мишенью (с нанесенным не нее напыляемым материалом) и подложкой 4 действует независимый, «дежурный» газовый разряд. Разряд имеет место между электродами 6 и 7, причем тип разряда — несамостоятельный дуговой. Для этого типа разряда характерны: наличие специального источника электронов в виде накаливаемого катода (6), низкие рабочие напряжения (десятки вольт) и большая плотность электонно-ионной плазмы. Подколпачное пространство, как и при катодном напылении, заполнено нейтральным газом, но при более низком давлении (10-3-10-4 мм рт. ст.). При создании металлической разводки сначала на всю поверхность ИС напыляют сплошную пленку алюминия толщиной 0,1-1 мкм (рис. 16). Эта пленка контактирует со слоями кремния в специально сделанных (с помощью предыдущей фотолитографии) окнах в окисле (1, 2 и 3 на рис. 16). Основная же часть алюминиевой пленки лежит на поверхности окисла. Покрывая пленку алюминия фоторезистом, экспонируя его через соответствующий фотошаблон и проявляя, получают фоторезистную маску, которая защищает будущие полоски металлизации и контактные площадки (КП) от травителя.
При создании металлической разводки сначала на всю поверхность ИС напыляют сплошную пленку алюминия толщиной 0,1-1 мкм (рис. 16). Эта пленка контактирует со слоями кремния в специально сделанных (с помощью предыдущей фотолитографии) окнах в окисле (1, 2 и 3 на рис. 16). Основная же часть алюминиевой пленки лежит на поверхности окисла. Покрывая пленку алюминия фоторезистом, экспонируя его через соответствующий фотошаблон и проявляя, получают фоторезистную маску, которая защищает будущие полоски металлизации и контактные площадки (КП) от травителя.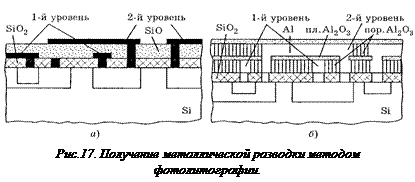
 После скрайбирования пластину ломают на отдельные кристаллы, и годные чипы монтируются в корпусах. Сборка кристалла в корпусе начинается с операции, которую называют посадкой на ножку (под ножкой имеют в виду дно корпуса). При этом кристалл приклеивается или припаивается (легкоплавким припоем) в средней части ножки (на рис. 18. показан простой транзистор). Затем контактные площадки на кристалле соединяются со штырьками — выводами корпуса. При этом проволочка деформируется (несколько расплющивается).
После скрайбирования пластину ломают на отдельные кристаллы, и годные чипы монтируются в корпусах. Сборка кристалла в корпусе начинается с операции, которую называют посадкой на ножку (под ножкой имеют в виду дно корпуса). При этом кристалл приклеивается или припаивается (легкоплавким припоем) в средней части ножки (на рис. 18. показан простой транзистор). Затем контактные площадки на кристалле соединяются со штырьками — выводами корпуса. При этом проволочка деформируется (несколько расплющивается). При значительном количестве внешних контактов операция разводки кристалла на ножке осуществляется только в автоматизированном процессе.
При значительном количестве внешних контактов операция разводки кристалла на ножке осуществляется только в автоматизированном процессе. Главная специфика сборочных операций применительно к интегральным схемам состоит в том, что корпуса ИС многовыводные: у простых ИС количество выводов составляет 8—14, а у больших доходит до сотен и более. Номенклатура корпусов для ИС довольно разнообразна: наряду с круглым корпусом, похожим на транзисторный (см. рис. 18), используются прямоугольные корпуса: металлические или пластмассовые, с выводами, лежащими в плоскости корпуса или перпендикулярными ей (рис. 20). Выбор корпуса в значительной степени зависит от назначения аппаратуры и способов ее конструирования.
Главная специфика сборочных операций применительно к интегральным схемам состоит в том, что корпуса ИС многовыводные: у простых ИС количество выводов составляет 8—14, а у больших доходит до сотен и более. Номенклатура корпусов для ИС довольно разнообразна: наряду с круглым корпусом, похожим на транзисторный (см. рис. 18), используются прямоугольные корпуса: металлические или пластмассовые, с выводами, лежащими в плоскости корпуса или перпендикулярными ей (рис. 20). Выбор корпуса в значительной степени зависит от назначения аппаратуры и способов ее конструирования. Через окна в фоторезистной маске проводят травление проводящего слоя, после чего фоторезист удаляют.
Через окна в фоторезистной маске проводят травление проводящего слоя, после чего фоторезист удаляют.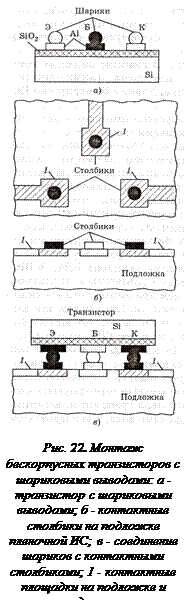 лочные выводы и который защищен от внешней среды каплей эпоксидной. Такой транзистор приклеивается к подложке вблизи тех пленочных элементов, с которыми он должен быть соединен, после чего проволочные выводы транзистора методом термокомпрессии присоединяются к соответствующим контактным площадкам на подложке.смолы, обволакивающей кристалл со всех сторон.
лочные выводы и который защищен от внешней среды каплей эпоксидной. Такой транзистор приклеивается к подложке вблизи тех пленочных элементов, с которыми он должен быть соединен, после чего проволочные выводы транзистора методом термокомпрессии присоединяются к соответствующим контактным площадкам на подложке.смолы, обволакивающей кристалл со всех сторон. Получение балок основано на сквозном травлении кремния через фоторезистную маску, нанесенную на нижнюю поверхность пластины (рис. 23, б). При сквозном травлении одновременно с получением балок достигается разделение пластины на отдельные кристаллы без механического скраибирования. До начала травления пластина приклеивается верхней (лицевой) поверхностью к стеклу.
Получение балок основано на сквозном травлении кремния через фоторезистную маску, нанесенную на нижнюю поверхность пластины (рис. 23, б). При сквозном травлении одновременно с получением балок достигается разделение пластины на отдельные кристаллы без механического скраибирования. До начала травления пластина приклеивается верхней (лицевой) поверхностью к стеклу. Масками для нанесения паст на подложку служат сетчатые трафареты (рис. 23, а). Они представляют собой тонкую сетку из капрона или нержавеющей стали, натянутую на дно рамки. Размер ячеек сетки — около 100 мкм, диаметр нитей — около 50 мкм. Большая часть сетки покрыта пленкой, но в пленке имеются окна. Рисунок окон получают методом фотолитографии, вытравливая отверстия в пленке. Учитывая ячеистую структуру сетки, размеры окон трудно сделать менее 10—200 мкм. Это предопределяет минимальные размеры элементов толстопленочных ГИС и ширину линий.
Масками для нанесения паст на подложку служат сетчатые трафареты (рис. 23, а). Они представляют собой тонкую сетку из капрона или нержавеющей стали, натянутую на дно рамки. Размер ячеек сетки — около 100 мкм, диаметр нитей — около 50 мкм. Большая часть сетки покрыта пленкой, но в пленке имеются окна. Рисунок окон получают методом фотолитографии, вытравливая отверстия в пленке. Учитывая ячеистую структуру сетки, размеры окон трудно сделать менее 10—200 мкм. Это предопределяет минимальные размеры элементов толстопленочных ГИС и ширину линий.