Емкость p-n-перехода.
Диод обладает емкостными свойствами, т.е. способен накапливать и отдавать заряд при увеличении или уменьшении приложенного напряжения. Накопление заряда происходит в p-n -переходе и в базе диода, и в соответствие с этим различают две составляющие емкости – барьерную и диффузионную: CД=C бар +C дф Барьерная емкость. При изменении напряжения меняется толщина (ширина) p-n -перехода и в соответствие с этим меняется некомпенсированный заряд ионов донорных и акцепторных примесей в переходе. Дифференциальную емкость Cбар можно рассматривать как емкость плоского конденсатора с обкладками, расположенными на расстоянии, равном толщине перехода d: C бар = ee 0S/ d, (2.33) где e – диэлектрическая проницаемость, e0 – диэлектрическая постоянная, S – площадь перехода. Подставляя d для резкого одностороннего перехода, получаем
где N – концентрация легирующей примеси в базе, C 0 – емкость при U= 0. В общем случае
где g=1/2 для резкого перехода и g=1/3 – для плавного.
Диффузионная емкость обусловлена накоплением неравновесных носителей в базе. Объем при этом сохраняет электронейтральность – заряд накапливается не в виде электрического заряда, а в виде избыточной концентрации. Для статического режима нетрудно найти заряд, накопленный в базе, проинтегрировав функцию распределения неравновесных носителей (2.17) по x
Выразив затем D p (0) через ток I=eSjp (0) =eSDp D p (0)/ Lp, получаем
где t =Lp2/Dp –время жизни неравновесных носителей в базе (индекс p для общности опущен). Эта формула относится к диодам с толстой базой, когда толщина базы (расстояние до омического контакта) w>>L, где L – диффузионная длина неравновесных носителей. Дифференцируя (2.36) по U получаем C дф = (I+I 0)t/jT(2.37) При обратном соотношении w<<L распределение концентрации в базе является практически линейным, и Q б =I×;tдф, где ×;tдф – среднее время диффузии через базу: tдф =w2/( 2 D) (2.38) В этом случае C дф = (I+I 0)tдф/j T (2.39) C дф и C бар проявляются в разных режимах работы: C дф >> C барпри I>>I0, и C бар >> C дф при U<;0. C дф нельзя считать «чистой» емкостью, так как она зависит от частоты или длительности импульса в импульсном режиме работы.
2.2. КОНТАКТЫ МЕТАЛЛ-ПОЛУПРОВОДНИК
Контакты металл-полупроводник могут быть выпрямляющими, которые называются также контактами Шоттки, и невыпрямляющими, или омическими. Тип контакта зависит от разности термоэлектронных работ выхода электрона из металла AM и из полупроводника AS и от типа проводимости полупроводника. Термоэлектронная работа выхода – это разность между энергией электрона в вакууме и уровнем Ферми: A=Wвак-WF (2.40) Чем больше A, тем меньше энергия электронов, поэтому электроны переходят в область с большей работой выхода: если AM>AS, электроны переходят из полупроводника в металл, если AM<AS, – из металла в полупроводник. В равновесии уровни Ферми выравниваются, между областями возникает контактная разность потенциалов: jк =(AM-AS) ¤ e (2.41) Слой полупроводника, прилегающий к контакту, обогащается или обедняется основными носителями и образуется омический или выпрямляющий контакт. Если AM>AS, то контакт M-n – выпрямляющий, M-p – омический. Если AM<AS, контакт M-n – омический, M-p – выпрямляющий.
В выпрямляющем контакте обедненный слой расположен целиком в полупроводнике. Он обладает высоким сопротивлением и нелинейной ВАХ. Толщина этого слоя определяется так же, как толщина p-n -перехода:
где N – концентрация легирующей примеси в полупроводнике. Потенциальный барьеры для электронов, движущихся из металла в полупроводник и из полупроводника в металл различны и равны, соответственно, j nm и jк1. Высота барьера j nm определяется выражением j nm =(AM- c n)/ e, (2.43) где c n. называется энергией электронного сродства, или сродством к электрону, и определяется как минимальная энергия, необходимая для удаления электрона со дна зоны проводимости полупроводника в вакуум. При приложении внешнего напряжения изменяется потенциальный барьер для электронов, движущихся из полупроводника в металл, а для обратного направления остается неизменным, поскольку все приложенное напряжение падает в обедненном слое полупроводника. На рис.2.9 приведены энергетические диаграммы выпрямляющего контакта при подаче прямого (плюс источника подан на металл, U>;0) (а) и обратного (U<;0) напряжения (б). При обратном включении ток обусловлен электронами, имеющими энергию выше потенциального барьера e j nm.
Теория выпрямляющего контакта базируется на теории термоэлектронной эмиссии электронов. Вольтамперная характеристика описывается такой же функцией, как ВАХ идеализированного p-n -перехода, причем эта зависимость выполняется с большой точностью в широком интервале токов (до восьми порядков величины тока):
Ток I0 определяется током термоэлектронной эмиссии из металла в полупроводник:
где AR – постоянная Ричардсона, для кремния n- типа AR =110 А/(см2 ·К), S – площадь контакта. При равной площади, температуре и степени легирования полупроводника обратный ток контакта Шоттки значительно больше теплового тока кремниевого p-n -перехода. Поэтому напряжение отпирания контакта Шоттки с кремнием ниже, чем кремниевого p-n -перехода. Омический контакт имеет линейную ВАХ и малое сопротивление. Особенностью этого контакта является также высокая скорость генерации и рекомбинации, поэтому концентрация носителей на границе сохраняется практически неизменной и при протекании тока. Следует особо отметить, что контакты металл-полупроводник работают на основных носителях заряда, через эти контакты нет инжекции неосновных носителей, нет накопления неравновесного заряда в полупроводнике. Контакт Шоттки обладает только барьерной емкостью. Поэтому диоды Шоттки обладают высоким быстродействием.
2.3. ГЕТЕРОПЕРЕХОДЫ
Гетеропереходом называется переход, образованный между двумя различными полупроводниками. Если полупроводники имеют одинаковый тип проводимости, то они образуют изотипный гетеропереход. Если тип их проводимости различен получается анизотипный гетеропереход. Принципиальным отличием гетеропереходов от p-n- переходов является различная высота потенциального барьера для электронов и дырок и наличие разрывов краев зон на металлургической границе, обусловленных различием диэлектрических проницаемостей. На рис. 2.10 а приведена зонная диаграмма двух изолированных полупроводников. Они различаются диэлектрическими проницаемостями e, работой выхода A и сродством к электрону c. Сродство к электрону определяется как энергия, необходимая для удаления электрона со дна зоны проводимости в вакуум. Различие в положении дна зоны проводимости обозначено D Wc, а различие в положении потолка валентной зоны D Wv.
Зонная диаграмма p-n- гетероперехода для тех же полупроводников для случая, когда полупроводник с широкой запрещенной имеет электронную проводимость, а с узкой – дырочную, приведена на рис.2.11 а для равновесного состояния и на рис.2.11 б – при приложении прямого напряжения. Как видно из рисунка, в этом случае будет происходить односторонняя инжекция электронов в p- область.
Вольтамперная характеристика идеализированного p-n- гетероперехода описывается формулой вида (2.21). На ВАХ реального гетероперехода сильное влияние оказывают центры генерации-рекомбинации в обедненном слое, концентрация которых может быть велика из-за большого числа дефектов структуры вблизи металлургической границы, возникающих вследствие неполной согласованности кристаллических решеток разных полупроводников. В этом случае при прямом напряжении преобладает ток рекомбинации, при обратном – ток генерации. В изотипных гетеропереходах потенциальный барьер для неосновных носителей значительно выше, чем для основных. Это используется на практике для ограничения области накопления неосновных носителей. Гетеропереходы широко применяются в излучающих и фотоэлектрических приборах (светодиоды, фотодиоды, полупроводниковые лазеры и др.). Использование гетеропереходов в биполярных и полевых транзисторах позволяет значительно увеличить их рабочие частоты.
|

 , (2.34)
, (2.34) , (2.35)
, (2.35) .
. , (2.36)
, (2.36)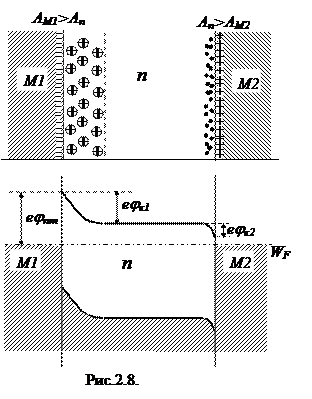 На рис.2.8 показаны оба типа контакта с полупроводником n -типа (эта структура представляет собой диод Шоттки) и приведена энергетическая диаграмма.
На рис.2.8 показаны оба типа контакта с полупроводником n -типа (эта структура представляет собой диод Шоттки) и приведена энергетическая диаграмма. , (2.42)
, (2.42)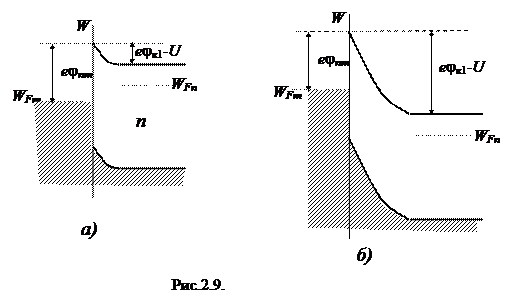
 (2.44)
(2.44) , (2.45)
, (2.45)




